硅通孔3DIC工艺显著减小传感器的外形尺寸
作者/Andreas Wild 艾迈斯半导体&晶圆代工服务和技术营销经理
本文引用地址:https://www.eepw.com.cn/article/201703/344951.htm引言
更小的外形尺寸、卓越的功能、更出色的性能和更低的BOM(物料成本)是系统工程师在开发传感器和传感器接口应用等复杂电子产品时面临的主要挑战。缩小芯片尺寸可以通过使用集成密度更高的小型制程节点实现,而系统的小型化则可以通过使用先进的封装技术来达成。如今,对更高系统集成度的需求与日俱增,这也促使那些传统的封装服务供应商和半导体公司着手开发更具创新性、更为先进的封装技术。其中前景广阔,同时也具有挑战性的当属采用硅通孔(TSV)的3D集成电路(3DIC)。3DIC技术现已被广泛应用于数字集成电路(例如存储器、图像传感器和其它元件的堆叠),其设计和制造方法已在数字领域得到证明。那么如何将3DIC技术成功运用在模拟和混合信号占据主导地位的传感器集成电路中呢?
1 TSV封装技术
模拟和混合信号IC开发领域的领导者已经开始逐渐认识到采用模拟3DIC设计能够带来的巨大优势。智能传感器和传感器接口面向“工业4.0(Industry 4.0)”、“智慧城市”或物联网(IoT)中的多种应用。TSV和背面重布线层(BRDL)技术非常适合用于替代传统的采用金丝键合的各种芯片堆叠技术。3D集成技术,尤其是领先晶圆代工服务供应商提供的特种模拟TSV技术,结合正面或背面RDL技术,可以在缩减电路板面积的同时提供更多功能,得益于较短的互连线,性能也可以得到改进,并实现更高度的集成。其中,小型TSV封装技术(总高度不超过0.32mm)尤其适合于满足智能手表、智能眼镜等可穿戴设备对小外形要求。
TSV技术还可以在结合不同晶圆和技术方面提供更高的灵活性:例如45nm制程生产的数字晶圆层叠式堆叠,模拟晶圆(如180mn)堆叠、MEMS设备、光电传感器和光电二极管阵列堆叠等,数不胜数。
2 模拟3DIC技术
模拟3DIC技术可通过在芯片正面和IC背面建立一个电气连接来满足传感器应用。在光学、化学、气体、压力等多种传感器应用中,传感区域都是位于CMOS面(晶圆顶面)。裸片和引线框之间最常用的连接类型是引线键合(如图1)。但无论是采用塑料封装或是将裸片直接与PCB或FPC键合,对于传感区域需暴露在外的特定应用而言,引线键合并非理想的解决方案。通过采用特种晶圆代工服务供应商的专有TSV技术,可以采用TSV、背面RDL和芯片级封装(WLCSP)来取代传统的引线键合(如图2)。
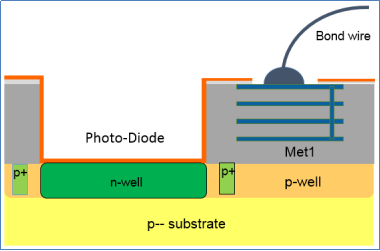
图1 采用标准引线键合的传感器芯片
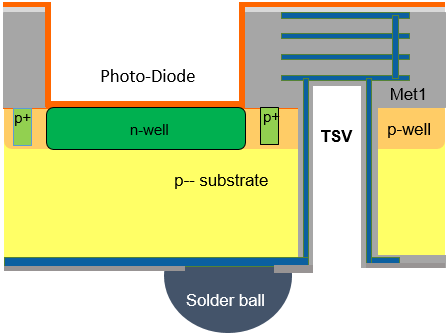
图2 采用TSV进行背面连接的传感器芯片
3 新一代TSV
在半导体技术领域,通过采用更小尺寸的元件和先进的设计规则,使新一代制程技术能够提供更高的性能和集成密度(摩尔定律),对于TSV而言也同样如此,新一代TSV技术的性能将全面超越现有的3DIC技术。一些特种晶圆代工服务供应商已经在开发新一代的TSV技术,在大幅缩减尺寸(约40µm),节约空间,提升集成密度的同时,还能提供同等,甚至更加出色的模拟性能。这种新一代TSV技术为全新的3D应用打下了基础,晶圆代工服务供应商也开始推出所谓的“第三方晶圆焊盘替换”或“有源3D硅基板”等新型服务来满足这些应用的要求。
4 第三方晶圆焊盘替换
具备更小尺寸和节距的新一代硅通孔技术可通过采用TSV结合背面RDL和WLCSP(即所谓的3D-WLCSP)可替换任何已加工完成的晶圆的焊盘。即使在制造流程完成之后,客户也仍然能够自由决定产品是采用正面引线键合或是通过WLCSP技术从背面植球。这一全新的技术理念使厂商能够通过一个后期加工步骤对任何晶圆进行TSV加工,即使第三方的晶圆也不例外。现已开发出具备与第三方所使用制程的接点要求完全相符的尺寸和最小节距的TSV技术(图3)。
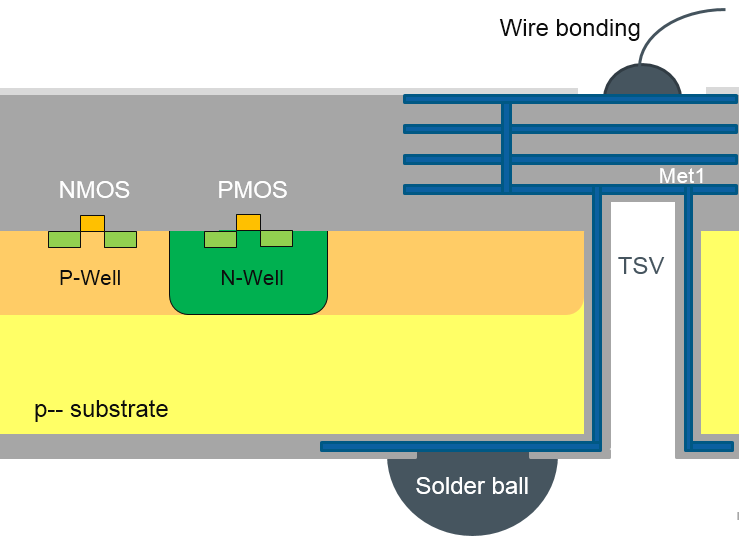
图3 采用TSV结合WLVSP(即3D-WLCSP)来替换引线键合
5 3D硅基板技术
3DIC技术的另一个创新型的变种和创新应用是硅基板结构。所谓的“无源3D硅基板”技术用来在晶圆的顶面和底面间建立一个简单的电气连接。而“有源3D硅基板”技术可满足一个完整CMOS器件所需的无源和有源的器件。
领先的晶圆代工服务供应商通常可提供基于0.18µm 特殊模拟制程的3D基板技术,具备MIM电容、高阻多晶硅电阻器、最多6个金属层、顶层厚金属等制程模块。有源硅基板包含正面和背面焊盘。正面焊盘可用于各类裸片(例如传感器或MEMS设备)的装配/堆叠,背面焊盘则常被用于电路板级的集成(图4)。代工厂还可额外提供具备多种焊锡球尺寸和节距的WLCSP技术。客户也可选择将背面焊盘用于在背面堆叠其他裸片。
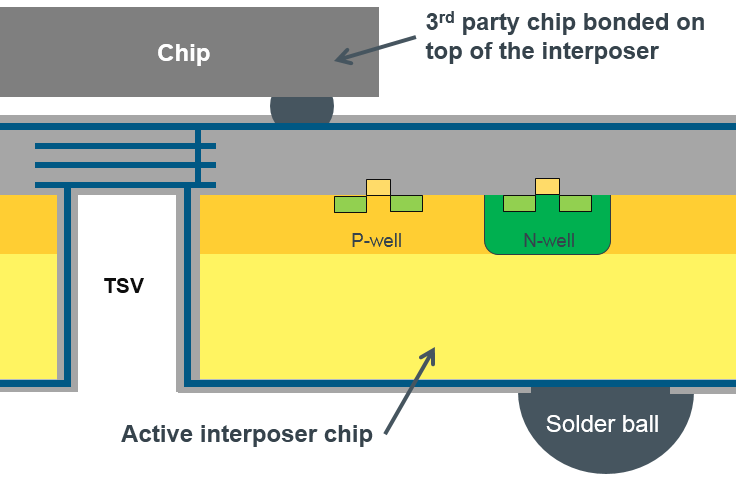
图4 键合在有源3D硅基板顶部的第三方芯片
6 设计套件集成
领先的晶圆代工服务供应商可提供IC开发的设计环境。理想情况下,极少数工业标杆的PDK会以特种代工厂的先进晶圆制程为基础,提供创建复杂混合信号设计所需的所有模块,并可用于所有主流的CAD环境。只需对此稍作修改,就能建立一个3D集成参考设计流程,可让设计者对3D集成IC系统进行完整的功能和实物验证。PDK可帮助厂商进行更加高效的设计,从而改善裸片尺寸、性能、产能,缩短上市时间,并且能够为产品开发者实现“一次成功”的设计提供一个可靠的途径。
7 结论
3DIC技术被广泛用于存储器、图像传感器和其它元件的堆叠,并已在数字领域得到证明。如何向客户提供用于模拟和混合信号占据主导地位的应用的3DIC技术是晶圆代工服务供应商面临的主要挑战。通过缩减TSV的尺寸和节距,并将其与晶圆级芯片技术相结合,使3D系统架构成为了传统2D系统级封装的一种具有切实可行性的替代方案。以焊盘替换、有源硅基板为代表的3DIC理念将显著改善系统的外形尺寸、提升性能,并降低物料成本,这些因素对于物联网领域中的所有移动、可穿戴和智能传感器设备都具有至关重要的意义。














评论