片内相位测量工具模拟光刻机
采用特殊照明方式的高/超高数值孔径(NA)的193nm光刻机和相位移掩膜版(PSM),使得光刻分辨率的极限达到了32nm节点。不利的因素是掩膜的复杂度正在以指数级递增,而业界又迫切需要通过精确的相位控制以达到必需的高成品率。
光刻机成像平面的相位受到其本身的数值孔径、掩膜的斜率和3D掩膜效应极大的影响,特别是当特征尺寸接近分辨率极限的时候。在45nm和32nm节点,为了确保精确的刻写PSM并获得足够的成品率,有必要测量产品特征中与光刻机相关的相位。然而控制需要精准的测量,直到现在相位的测量依然使用基于干涉仪的测量工具。如此产生的问题是,评估相位必须使用比产品特征高数量级的参考特征,这些测量平台将受到局限。高分辨率原子力显微镜(AFM)也被迫面临这样的问题。虽然它们能够测量产品相关特征中的刻蚀深度,但是却无法描述3D掩膜效应。两种方法都无法获得由数值孔径(NA)、掩膜斜率和严格的3D掩膜效应产生的衍射限度。
与Intel一起协作,Carl Zeiss半导体测量系统部门研究了光学相位测量工具的必要条件,它们要能够把工艺控制从大型CD测试特征扩展到芯片内高分辨率相位移特征。因此,这些工具注定了必须为模拟光刻平台的光学设置而设计,并需要获得光波波长中特征尺寸产生的相位信息。
这样的结果产生了一个叫做Phame的光学测量工具。考虑到偏振,在光刻机相关的设置下,它可以测量所有片内的相位移掩膜版的相位。它不但能完成现存工具所作的测量大型参考特征的工作,而且能够通过获得真实的掩膜效应来测量产品特征。该平台的光束路径可与NA为1.6的浸没式光刻机的类比。结合一个低sigma元件,它的193nm激光持续照射一个面朝下的掩膜;根据PSM的类型决定使用同轴还是离轴的入射光。
光刻机的部分相干光照设置用于可调时间间隔的连续测量,它允许在光刻机相关的照射设定下进行相位控制。工具的0.4NA精确图像光(1.6NA光刻机等效)使得系统与193nm浸没式光刻机兼容并延伸至32nm节点。相位信息是通过相位操作和运算获得的,CCD占用原来在一个真正的光刻机中应该属于晶圆的位置。除了芯片中相位值,该工具也测量芯片内的传输。
系统提供三种不同的测量模式:手动,柱状图分析和定义区域。在测量的过程中获得强度和相位影像,通过选择一个伴有显示相应相位数值的相位图薄片,相位的轮廓可以手动生成。然后,柱状图分析法计算出整个测试区域的相位平均值。这一选项被用于PSM刻蚀和清洗后的相位控制。另外,其他区域可能在相位图像内被定义或被软件自动设置,并可对平均相位的差异进行评估。被定义区域间的相互关系可以用作修复验证或是评估光学临近效应。
该平台可以测试所有类型的PSM。实验证明,其相位精确度1°,小产品特征的静态相位再现能力在0.15°和0.3°之间,对大的参考特征该值0.2°。
虽然使用测量系统进行工艺控制、优化工艺窗口以提升成品率,这些主要用于掩膜厂;但在改进掩膜和缩短设计优化时间方面,仍需要在研发领域扩大应用以优化光学邻近修正(OPC)工艺。
干涉仪相关文章:干涉仪原理




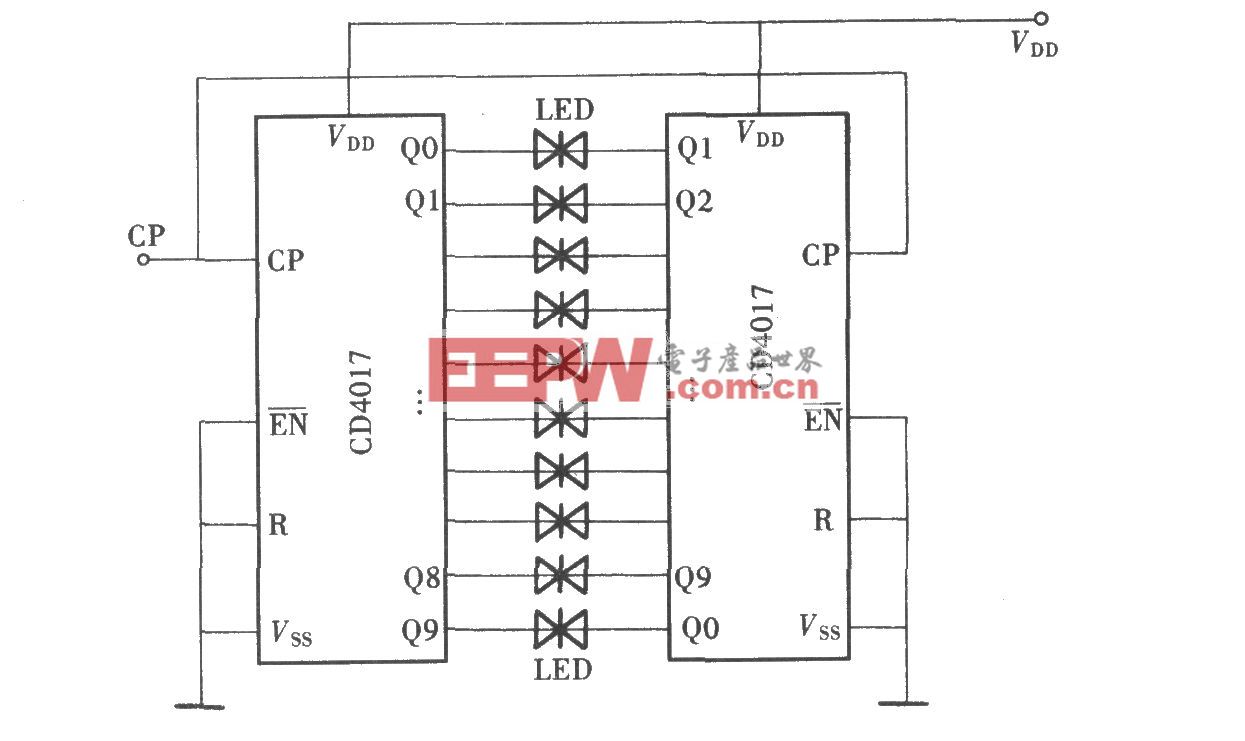



评论