集成电路Cu互连线的XRD研究
随着芯片集成度的不断提高,Cu已经逐渐取代A1成为ULSI互连中的主流互连材料。Cu电沉积层的性质取决于其结构,在电结晶过程中,Cu镀层由于不同晶面的生长速度不同而导致织构化,表现出不同的性能。国内有关Cu镀层织构的研究主要集中在冶金级电镀和PCB布线方面,几乎没有对于集成电路Cu互连线织构的文献报道。PCB中线路的特征尺寸为几十微米,而芯片中Cu互连的特征尺寸是1μm,因此对亚微米级厚度Cu镀层的性能研究显得尤为必要。
不同晶面择优对集成电路Cu互连线性能的影响很大。有研究结果表明,Cu(111)晶面抗电迁移性能是Cu(200)晶面的4倍,这可能是由于其致密结构决定的。Cu镀层晶面的择优情况与电沉积条件、添加剂、镀层厚度以及衬底等因素密切相关。本文针对IC工业中主要使用的硫酸盐电镀Cu体系,使用X射线衍射(XRD)研究Cu镀层织构与电沉积条件等因素之间的关系。
1 实验
本文中使用了两种si片:第一种是p型(100)Si片,首先在Si片上PECVD(IConcept One 200 mmDielectric System,Novellus)淀积800 nm Si02介质层,然后用PVD(Invoa 200,Novellus)溅射25 nm的TaN/Ta扩散阻挡层,再用PVD溅射50 nm的Cu籽晶层,最后在籽晶Cu上电镀Cu;第二种是n型(100)Si片,首先在Si片上用PVD溅射5 nm的TaSiN扩散阻挡层,然后用PVD溅射5 nm的Ru层,在Ru层上再电镀Cu。Ru是一种过渡金属,电阻率7μΩ・cm,熔点2 300℃,是最近国际上无籽晶Cu电镀的一个研究热点。
电镀液为标准VMS(virgin make―up solution)溶液,其成分为,Cu2+17.5 g/L,H2S04175 g/L,Cl一50 mg/L,加速剂2 mL/L,抑制剂8 mL/L和整平剂1.5 mL/L(添加剂均来自美国Enthone公司)。Cl一能提高镀层光亮度和平整性,降低镀层的内应力,增强抑制剂的吸附;加速剂通常是含S或其他官能团的有机物,包括硫脲及其衍生物,它的作用是促进Cu的成核,使各晶面生长速度趋于均匀;抑制剂包括聚乙二醇(PEG)、聚丙烯二醇和聚乙二醇的共聚物等,它的作用是和Cl离子一起在阴极表面形成一层连续膜以阻止Cu的沉积;整平剂通常是杂环化合物,一般含有N原子,它的作用是降低镀层表面粗糙度。
实验中使用方波脉冲。除了不同厚度的织构实验,其余实验均通过设置不同的电镀时间将Cu镀层厚度较严格地控制在l μm。
织构系数以晶面(hkl)的织构系数TC(texture coefficient)来表征晶面择优程度

式中:I(hkl)、I0(hkl)分别表示沉积层试样和标准试样(hkl)晶面的衍射线强度;n为衍射峰个数。当各衍射面的TC值相同时,晶面取向是无序的;如果某个(hk1)面的TC值大于平均值,则该晶面为择优取向,晶面的TC值越大,其择优程度越高。
2 结果和讨论
2.1 直流电镀
图l为直流条件不同织构系数随电流密度的变化曲线,其中(a)图为有添加剂情况,(b)图为无添加剂情况。可见,添加剂对镀层织构的影响很明显。没有添加剂时, (111)晶面为单一择优晶面,且择优程度较高;有添加剂时,(200)晶面在1―4 A/dm2区间内择优程度超过了(111)晶面。
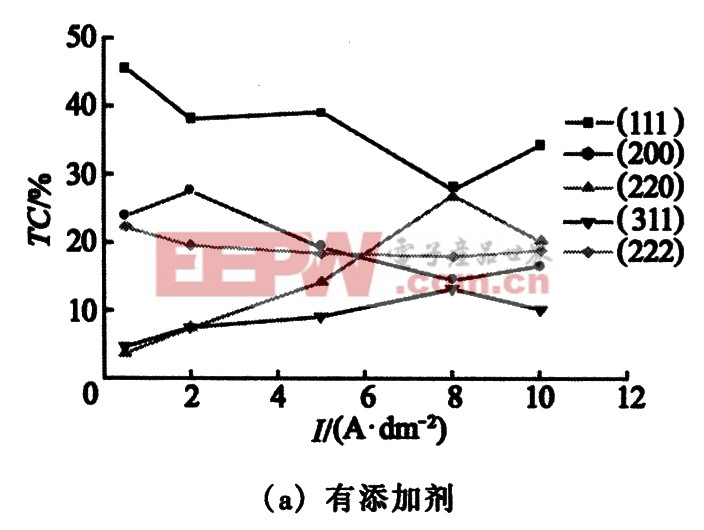
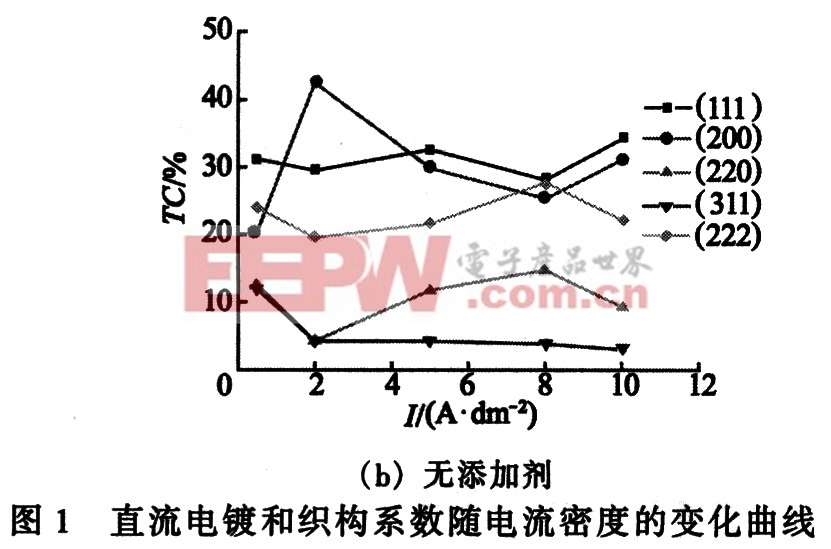
2.2 脉冲电镀
图2为没有添加剂时,不同脉冲条件下织构系数的变化曲线,其中图2(a)为固定脉冲时间和关断时间,改变电流密度;图2(b)为固定脉冲峰值电流和关断时间,改变脉冲时间;图2(c)为固定脉冲峰值电流和脉冲时间,改变关断时间。为方便对比,把图2(b)和图2(c)横坐标用占空比 来表示。
来表示。














评论