EOS失效分析
在芯片失效分析领域,EOS(电过应力)是一种常见的失效模式。传统的EOS失效通常表现为电压或电流输入引脚的明显烧毁痕迹,然而近期我们遇到很多特殊的案例(开盖观察可能的EOS引入引脚在电性测试并未检测出来)。这种非典型的失效模式为我们理解EOS的传播机制和失效路径提供了新的视角。
典型案例:
某DC-DC芯片失效,Vin输入未见明显短路,但芯片输出电压异常。

IV测试:VIN-VCC、VIN-SW、VCC-RTN异常,其中VCC-RTN短路,VIN-VCC开路;VCC-RTN阻抗下降但未见明显短路。

注:红色为失效芯片,蓝色为正常芯片对比。
声扫(SAT):失效芯片VIN管脚处有疑似烧毁点!

开盖检测(Decap):嚯!开盖一看,果然!VIN打线附近有明显的Burn Mark。

但是为什么VIN-RTN未短路,VCC-RTN短路呢?——通过进一步放大观察可知,VIN相关的部分metal走线烧断(详见红箭头处),因此推断VIN击穿短路后产生了大电流,导致金属metal烧毁,同时大电流沿着内部金属连线传播至相对脆弱的区域(详见绿箭头示意),最后在VCC-RTN路径形成热点烧毁,导致短路。

芯片烧毁路径分析:VIN和VCC之间有一个VCC regulator,详见规格书描述,这个regulator直连VIN,因此推断VIN引入EOS后过流致使VIN到这个regulator的metal烧断路(详见下图红X位置),同时过流导致VCC regulator烧毁,最终始VCC-RTN呈现短路的现象,短路路径为VCC-VCC regulator-RTN。









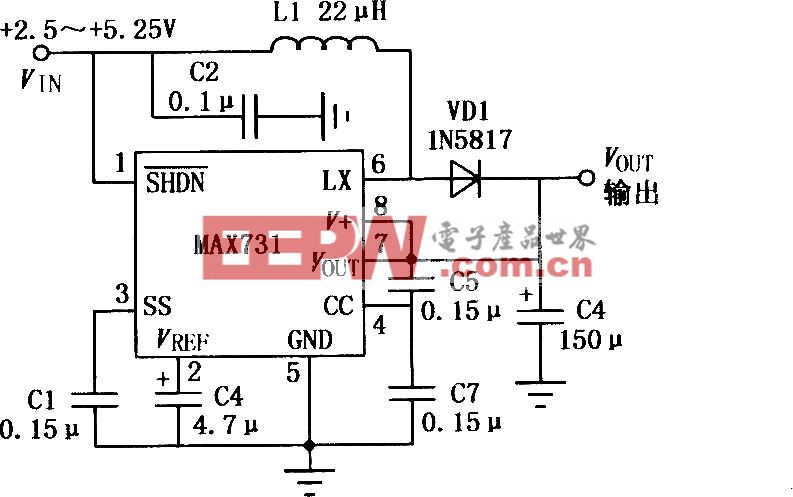



评论