我国封装业正从低端向中高端迈进
我国IC封装业一直是IC产业链中的第一支柱产业。据赛迪顾问统计,2007年国内集成电路封装测试业共实现销售收入627.7亿元,同比增长26.4%,继续保持了快速发展势头。目前国内封装企业如长电科技、南通富士通、天水华天、华润安盛公司近年来封测规模正在迎头赶上,产品档次也由低端向中高端发展。长电科技的封装水平已与国际先进水平接轨。这些发展可以说都离不开创新,贴近市场的创新技术直接带动了企业的快速健康发展。
本文引用地址:https://www.eepw.com.cn/article/79551.htm随着IC器件尺寸不断缩小和运算速度的不断提高,封装技术已成为极为关键的技术。封装形式的优劣已影响到IC器件的频率、功耗、复杂性、可靠性和单位成本。据天水华天科技股份有限公司总工程师郭小伟介绍,目前封装的热点技术为高功率发光器件封装技术、低成本高效率图像芯片封装技术、芯片凸点和倒装技术、高可靠低成本封装技术、BGA等基板封装技术、MCM多芯片组件封装技术、四边无引脚封装技术、CSP封装技术、SIP封装技术等。郭小伟认为,未来集成电路技术,无论是其特征尺寸、芯片面积和芯片包含的晶体管数,还是其发展轨迹和IC封装,发展主流都是:芯片规模越来越大,面积迅速减小;封装体积越来越小,功能越来越强;厚度变薄,引线间距不断缩小,引线也越来越多,并从两侧引脚到四周引脚,再到底面引脚;封装成本越来越低,封装的性能和可靠性越来越高,单位封装体积、面积上的IC密度越来高,线宽越来越细,并由单芯片封装向多芯片封装方向发展。
集成电路封装的发展,一直是伴随着封装芯片的功能和元件数的增加而呈递进式发展。封装技术已经经历了多次变迁,从DIP、SOP、QFP、MLF、MCM、BGA到CSP、SIP,技术指标越来越先进。其中三维叠层封装(3D封装)被业界普遍看好,三维叠层封装的代表产品是系统级封装(SIP),SIP实际上就是一系统级的多芯片封装,它是将多个芯片和可能的无源元件集成在同一封装内,形成具有系统功能的模块,因而可以实现较高的性能密度、更高的集成度、更小的成本和更大的灵活性。晶方半导体科技(苏州)有限公司副总裁兼研发中心总经理俞国庆认为,晶圆级芯片尺寸封装技术(CSP)和三维(3D)封装技术是目前封装业的热点和发展趋势。特别对后者,国内外封装公司基本上站在同一起跑线上。我国半导体封装公司应认清这种趋势,组织力量掌握这些技术,抓住机遇和挑战,在技术上保持不败之地。
从市场的角度来看,近年来半导体产业的繁荣主要得益于3C类电子产品的旺盛需求,便携式电子产品和汽车电子的兴起更为半导体封测业创造了许多新的发展机遇。同时我们的封测业正面临着更多方面的挑战,江苏长电科技股份有限公司基板封装事业部常务副总经理谢洁人表示,这些挑战首先表现在技术上需要进一步的整合和提升,有些整合和提升甚至是跨行业的;其次是环保对产品工艺和材料的要求会越来越高;第三,产品的封装密度要不断提高以配合便携式电子产品体积和重量的进一步缩小;第四,产品在安全和可靠性方面更要不断提高以适应汽车电子等新兴市场的要求。另外劳动力特别是高素质综合型人才是否能适应产业迅速发展的要求是目前半导体产业不得不面对的新挑战。
当前,国外半导体企业通过兴建或扩建其在中国大陆的封测厂,加大了资金与技术的输入,这对我国集成电路封测业来说既是机遇也是挑战。对此,南通富士通微电子股份有限公司董事长兼总经理石明达认为,国际先进封测企业的进入,带来了资金、技术和人才,加快了封测技术的更新与升级,为中国IC封测业整体水平的提高与发展带来了机遇。同时,随之而来的是劳动力成本上升加速,专业人才流动加快,国内封测市场竞争加剧,行业利润下滑,国内企业生存压力增大。石明达强调,国内企业在市场竞争中应找准位置,扬长避短发挥自身特长与优势,借助全球封测代工业务转移及国内汽车电子、通信、电脑和家电等产品对新型封测技术的需求,快速发展,做强做大自己。
目前行业发展总体机遇是良好的,随着终端电子产品特别是消费类电子产品的更新换代,集成电路封测企业的发展将持续增长。另外,随着外资封装企业不断在大陆建厂,市场的竞争将更加激烈,如何提高企业综合竞争力,如何做好新产品新技术的研发,如何降低成本和提高产品质量和服务将成为各封装企业今后主要的课题。







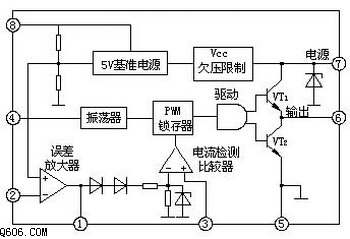

评论