绝缘栅双极晶体管(IGBT)
一、IGBT的工作原理
电力MOSFET器件是单极型(N沟道MOSFET中仅电子导电、P沟道MOSFET中仅空穴导电)、电压控制型开关器件;因此其通、断驱动控制功率很小,开关速度快;但通态降压大,难于制成高压大电流开关器件。电力三极晶体管是双极型(其中,电子、空穴两种多数载流子都参与导电)、电流控制型开关器件;因此其通-断控制驱动功率大,开关速度不够快;但通态压降低,可制成较高电压和较大电流的开关器件。为了兼有这两种器件的优点,弃其缺点,20世纪80年代中期出现了将它们的通、断机制相结合的新一代半导体电力开关器件——绝缘栅极双极型晶体管(insulated gate bipolar transistor,IGBT)。它是一种复合器件,其输入控制部分为MOSFET,输出级为双级结型三极晶体管;因此兼有MOSFET和电力晶体管的优点,即高输入阻抗,电压控制,驱动功率小,开关速度快,工作频率可达到10~40kHz(比电力三极管高),饱和压降低(比MOSFET 小得多,与电力三极管相当),电压、电流容量较大,安全工作区域宽。目前2500~3000V、800~1800A的IGBT器件已有产品,可供几千kVA以下的高频电力电子装置选用。
图1为IGBT的符号、内部结构等值电路及静态特性。IGBT也有3个电极:栅极G、发射极E和集电极C。输入部分是一个MOSFET管,图1中Rdr表示MOSFET的等效调制电阻(即漏极-源极之间的等效电阻RDS)。输出部分为一个PNP三极管T1,此外还有一个内部寄生的三极管T2(NPN管),在NPN晶体管T2的基极与发射极之间有一个体区电阻Rbr。

当栅极G与发射极E之间的外加电压UGE=0时,MOSFET管内无导电沟道,其调制电阻Rdr可视为无穷大,Ic=0,MOSFET处于断态。在栅极G与发射极E之间的外加控制电压UGE,可以改变MOSFET管导电沟道的宽度,从而改变调制电阻Rdr,这就改变了输出晶体管T1(PNP管)的基极电流,控制了IGBT管的集电极电流Ic。当UGE足够大时(例如15V),则T1饱和导电,IGBT进入通态。一旦撤除UGE,即UGE=0,则MOSFET从通态转入断态,T1截止,IGBT器件从通态转入断态。
二、IGBT的基本特性
1、 静态特性
(1) 输出特性:是UGE一定时集电极电流Ic与集电极-发射极电压UCE的函数关系,即Ic=f(UCE)。
图1示出IGBT的输出特性。UGE=0的曲线对应于IGBT处于断态。在线性导电区I,UCE增大,Ic增大。在恒流饱和区Ⅱ,对于一定的UGE,UCE增大,IC不再随UCE而增大。{{分页}}
在UCE为负值的反压下,其特性曲线类似于三极管的反向阻断特性。
为了使IGBT安全运行,它承受的外加压、反向电压应小于图1(c)中的正、反向折转击穿电压。
(2) 转移特性:是图1(d)所示的集电极电流Ic与栅极电压UGE的函数关系,即Ic=f(UGE)。
当UGE小于开启阈值电压UGE th时,等效MOSFET中不能形成导电沟道;因此IGBT处于断态。当UGE>UGE th后,随着UGE的增大,Ic显著上升。实际运行中,外加电压UGE的最大值UGEM一般不超过15V,以限制Ic 不超过IGBT管的允许值ICM。IGBT在额定电流时的通态压降一般为1.5~3V。其通态压降常在其电流较大(接近额定值)时具有正的温度系数(Ic增大时,管压降大);因此在几个IGBT并联使用时IGBT器件具有电流自动调节均流的能力,这就使多个IGBT易于并联使用。
2、 动态特性
 图2示出了IGBT的开通和关断过程。开通过程的特性类似于MOSFET;因为在这个区间,IGBT大部分时间作为MOSFET运行。开通时间由4个部分组成。开通延迟时间td是外施栅极脉冲从负到正跳变开始,到栅-射电压充电到UGE th的时间。这以后集电极电流从0开始上升,到90%稳态值的时间为电流上升时间tri。在这两个时间内,集-射极间电压UCE基本不变。此后,UCE开始下降。下降时间tfu1是MOSFET工作时漏-源电压下降时间tfu2是MOSFET和PNP晶体管同时工作时漏-源电压下降时间;因此,IGBT开通时间为 ton=td+tr+tfu1+tfu2。
图2示出了IGBT的开通和关断过程。开通过程的特性类似于MOSFET;因为在这个区间,IGBT大部分时间作为MOSFET运行。开通时间由4个部分组成。开通延迟时间td是外施栅极脉冲从负到正跳变开始,到栅-射电压充电到UGE th的时间。这以后集电极电流从0开始上升,到90%稳态值的时间为电流上升时间tri。在这两个时间内,集-射极间电压UCE基本不变。此后,UCE开始下降。下降时间tfu1是MOSFET工作时漏-源电压下降时间tfu2是MOSFET和PNP晶体管同时工作时漏-源电压下降时间;因此,IGBT开通时间为 ton=td+tr+tfu1+tfu2。
开通过程中,在td、tr时间内,栅-射极间电容在外施正电压作用下充电,且按指数规律上升,在tfu1、tfu2这一时间段内MOSFET开通,流过对GTR的驱动电流,栅-射极电压基本维持IGBT完全导通后驱动过程结束。栅-射极电压再次按指数规律上升到外施栅极电压值。
IGBT关断时,在外施栅极反向电压作用下,MOSFET输入电容放电,内部PNP晶体管仍然导通,在最初阶段里,关断的延迟时间td和电压UCE的上升时间tr,由IGBT中的MOSFET决定。关断时IGBT和MOSFET的主要差别是电流波形分为tfi1和tfi2两部分,其中,tfi1由MOSFET决定,对应于MOSFET的关断过程;tfi2由PNP晶体管中存储电荷所决定。因为在tfi1末尾MOSFET已关断,IGBT又无反向电压,体内的存储电荷难以被迅速消除;所以漏极电流有较长的下降时间。因为此时漏源电压已建立,过长的下降时间会产生较大的功耗,使结温增高;所以希望下降时间越短越好。
3、 擎住效应
由图1(b)电路可以看到IGBT内部的寄生三极管T2与输出三极管T1等效于一个晶闸管。内部体区电阻Rbr上的电压降为一个正向偏压加在寄生三极管T2的基极和发射极之间。当IGBT处于截止状态和处于正常稳定通态时(ic不超过允许值时),Rbr上的压降都很小,不足以产生T2的基极电流,T2不起作用。但如果ic瞬时过大,Rbr上压降过大,则可能使T2导通,而一旦T2导通,即使撤除门极电压UGE,IGBT仍然会像晶闸管一样处于通态,使门极G失去控制作用,这种现象称为擎住效应。在IGBT的设计制造时已尽可能地降低体区电阻Rbr,使IGBT的集电极电流在最大允许值ICM时,Rbr上的压降仍小于T2管的起始导电所必需的正偏压。但在实际工作中ic一旦过大,则可能出现擎住效应。如果外电路不能限制ic的增长,则可能损坏器件。{{分页}}
除过大的ic可能产生擎住效应外,当IGBT处于截止状态时,如果集电极电源电压过高,使T1管漏电流过大,也可能在Rbr上产生过高的压降,使T2导通而出现擎住效应。
可能出现擎住效应的第三个情况是:在关断过程中,MOSFET的关断十分迅速,MOSFET关断后图1(b)中三极管T2的J2结反偏电压UBA增大,MOSFET关断得越快,集电极电流ic减小得越快,则UCA=Es-R
手机电池相关文章:手机电池修复
晶体管相关文章:晶体管工作原理
电荷放大器相关文章:电荷放大器原理 晶体管相关文章:晶体管原理





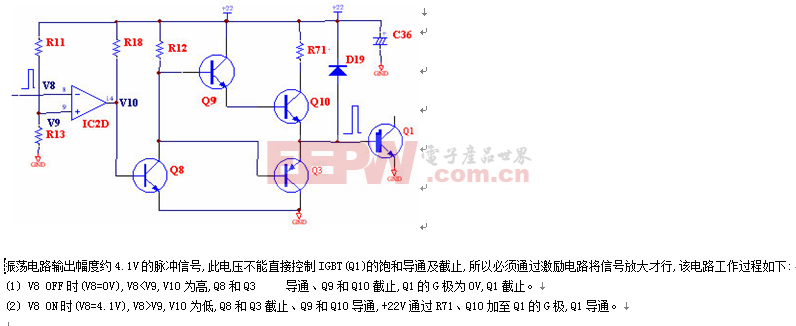

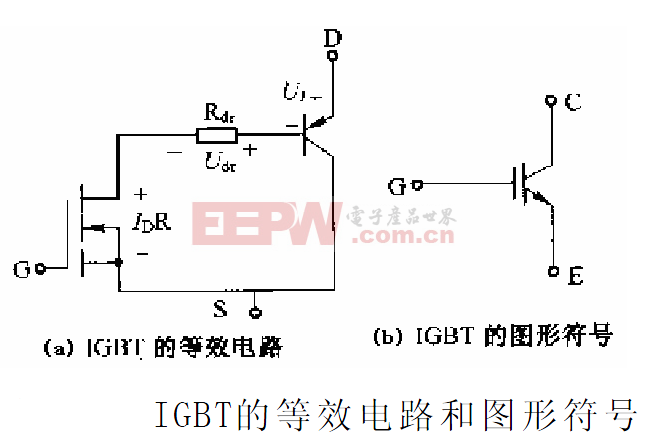
评论