化学机械抛光(CMP)技术、设备及投资概况
作者/李丹 赛迪顾问 集成电路产业研究中心高级分析师 (北京 100048)
本文引用地址:https://www.eepw.com.cn/article/201905/401015.htm1 CMP设备技术概况
1.1 CMP工艺技术发展进程
化学机械抛光(Chemical Mechanical Polishing,CMP)技术的概念是1965年由Monsanto首次提出,该技术最初是用于获取高质量的玻璃表面,如军用望远镜等。CMP工艺由 IBM 于1984年引入集成电路制造工业,它首先用于后道工艺金属间绝缘介质(IMD)层的平坦化,之后用于金属钨(W)的平坦化,随后又用于浅沟槽隔离(ST)和铜(Cu)的平坦化。整个CMP工艺只要短短的30秒就能完成,包括退出CMP系统前的研磨后清洁(对晶圆进行洗涤、冲洗和干燥)。所有这些工序整合到一起,可实现极佳的平坦度。
CMP在二十世纪90年代中期真正开始起飞,当时半导体业希望用导电速度更快的铜电路取代铝电路,来提高芯片的性能。铝互连线的制作是先沉积一层金属层,然后再用反应性气体把不要的部分腐蚀掉,铜金属层无法使用这种方法轻易去除,因此开发出了铜CMP 技术。今天生产的每一块微处理器都使用铜连线,而CMP设备更是任何芯片制造商不可或缺的必备工具。CMP工艺在芯片制造中的应用包括浅沟槽隔离平坦化(STI CMP)、多晶硅平坦化(Poly CMP)、层间介质平坦化(ILD CMP)、金属间介平坦化(IMD CMP)、铜互连平坦化(Cu CMP)。
1.2 CMP抛光工艺技术原理
CMP从概念上很简单,但纳米级CMP其实是一项很复杂的工艺。在晶圆表面堆叠的不同薄膜各自具有不同的硬度,需以不同的速率进行研磨。这可能会导致“凹陷”现象,也就是较软的部分会凹到较硬材料的平面之下。区别于传统的纯机械或纯化学的抛光方法,CMP通过化学的和机械的综合作用,最大程度减少较硬材料与较软材料在材料去除速率上的差异,也有效避免了由单纯机械抛光造成的表面损伤和由单纯化学抛光易造成的抛光速度慢、表面平整度和抛光一致性差等缺点。
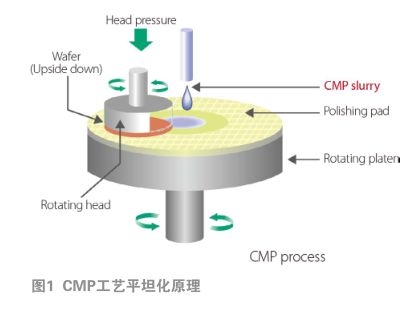
CMP工艺平坦化原理是,利用机械力作用于圆片表面,同时由研磨液中的化学物质与圆片表面材料发生化学反应来增加其研磨速率(如图1)。CMP技术所采用的设备及消耗品包括:抛光机、抛光浆料、抛光垫、后CMP清洗设备、抛光终点检测及工艺控制设备、废物处理和检测设备等。CMP技术难点是干和湿混合、要在化学和机械之间找好平衡。
CMP工艺中最重要的两大组成部分是研磨液和研磨垫,抛光液和抛光垫均为消耗品,抛光垫的使用寿命通常为45~75小时。抛光液分为酸性抛光液和碱性抛光液,是均匀分散胶粒的乳白色胶体,主要起到抛光、润滑、冷却的作用。以碱性SiO 2 抛光液为例,其成分主要包含研磨剂(SiO 2 胶粒)、碱、去离子水、表面活性剂、氧化剂、稳定剂等。抛光垫是一种具有一定弹性疏松多孔的材料,一般是聚亚氨酯类,主要作用是存储和传输抛光液,对硅片提供一定的压力并对其表面进行机械摩擦。
在CMP工艺中,首先让研磨液填充在研磨垫的空隙中,圆片在研磨头带动下高速旋转,与研磨垫和研磨液中的研磨颗粒发生作用,同时需要控制研磨头下压力等其他参数。CMP 设备主要分为两部分,即抛光部分和清洗部分,抛光部分由4部分组成,即3个抛光转盘和一个圆片装卸载模块。清洗部分负责圆片的清洗和甩干,实现圆片的“干进干出”(如图2)。
1.3 CMP抛光工艺技术指标

CMP的主要检测参数包括研磨速率、研磨均匀性和缺陷量(如表1)。研磨速率是指单位时间内圆片表面材料被研磨的总量。研磨均匀性又分为圆片内研磨均匀性和圆片间研磨均匀性。圆片内研磨均匀性是指某个圆片研磨速率的标准方差与研磨速率的比值;圆片间研磨均匀性用于表示不同圆片在同一条件下研磨速率的一致性。对于CMP而言,主要的缺陷包括表面颗粒、表面刮伤、研磨剂残留等,它将直接影响产品的成品率。半导体业界对于CMP工艺也有相应的“潜规则”,即CMP工艺后的器件材料损耗要小于整个器件厚度的10%。也就是说不仅要使材料被有效去除,还要能够精准地控制去除速率和最终效果。随着器件特征尺寸的不断缩小,缺陷对于工艺控制和最终良率的影响愈发的明显,降低缺陷是CMP工艺的核心技术要求。
1.4 CMP抛光设备市场价格
CMP是一种集机械学、流体力学、材料化学、精细加工、控制软件等多领城最先进技术于一体的设备,是各种集成电路生产设备中较为复杂和研制难度较大的设备之一。随着圆片直径的增大和工艺复杂性的不断提高,CMP的设备价格也在逐渐增长。一般来说,用于200 mm圆片的CMP设备价格约为300 万美元,用于300 mm圆片的CMP设备价格约为400 万美元。
2 CMP设备供应商概况
目前,美国和日本在CMP设备制造领域处于领先地位,主要的生产商有美国的应用材料(AppliedMaterials,AMAT)公司和日本的荏原机械(Ebara)公司。国内CMP设备的主要研发单位有天津华海清科和中国电子科技集团公司第四十五研究所,其中华海清科的抛光机已在中芯国际生产线上试用,2018年1月,华海清科的Cu &Si CMP设备进入上海华力。
2.1 美国应用材料
CMP设备依然是美国应用材料一家独大,拥有全球71%的市场份额。美国应用材料2003年停止8英寸设备的生产,主攻12 英寸CMP设备,应用材料公司的 Mirra CMP 为硅、浅沟槽隔离 (STI)、氧化物、多晶硅、金属钨和铜镶嵌应用提供了经生产验证的高性能150 mm 和 200 mm 平坦化解决方案。它的高速平坦化转盘和多区研磨头具有低下压力,可实现极佳的均匀度和效率。集成的 CMP(化学机械平坦化)后Mesa 清洗器(同样适用于 150 mm 和 200 mm 应用)能有效去除浆料、防止残渣形成,最大限度减少微粒和水痕。对于铜镶嵌应用,也可以选择 200 mmDesica 清洁和冲洗技术,利用 Marangoni 蒸气干燥器,可实现快速、有效的无水印干燥。应用材料公司的 Mirra CMP 系统采用全套端点方法,提供同线度量和先进的工艺控制能力,确保出色的晶圆内和晶圆间工艺控制和可重复性,适合所有平坦化应用。先进的抛光技术(如应用材料公司的 Titan Profiler(150 mm)和Titan Contour (200 mm) 抛光头产品)和多转盘配置,通过调整跨晶圆表面和距晶圆边缘3 mm内的去除率,可满足关键均匀性指标。这些先进的功能和其他已发布的升级,为实现更高的产能和良率提供了更多加工能力保障。
2.2 日本荏原
荏原制作所总公司位于日本东京都大田区,设计并制造社会基础设施和工业用机械设备,于东京证券交易所一部上市。亦是美国生产压缩机和汽轮机Elliott公司的母公司,主营事业有风水力机械事业、环境事业和精密电子事业。日本东京荏原的200 mm和300 mm CMP抛光设备均具有高可靠性和高生产率,荏原拥有的12英寸晶圆10~20 nm级CMP设备,能在一定程度上实现对美国产品的替代。
荏原在欧洲、日本等全球的研发团队继续推动最先进的应用程序定位于行业生产和新技术要求的前沿。除了MEMS / SOI /磁介质行业的挑战外,荏原的高通量F-REX系列CMP系统正在运行当今最严苛的应用,如用于IC制造的氧化物、ILD、STI、钨和铜。它们具有出色的可靠性,性能超过250小时MTBF。适用于200和300 mm晶圆直径的F-REX200和F-REX300SII平台分别提供最先进的设计和性能,以满足最先进的器件制造需求。它们提供面向用户的系统配置,旨在实现最大吞吐量和所有干燥/干燥晶圆处理功能。F-REX200工具代表了适用于200 mm晶圆的最新CMP技术(也可用150 mm)。它采用了EB原专利的干进干出晶圆处理技术。清洁模块集成在CMP工具内,从而将干晶片输送到后续工艺中。F-REX200系统配备2个压板,每个压板1个头和4个清洁站,可选配4个盒式SMIF兼容装载端口和CIM主机通信。其他选项包括端点指向、抛光板和在线计量。
2.3 华海清科
自2000年起,清华大学机械系雒建斌院士、“长江学者”路新春教授带领研究团队从事抛光技术研究,在抛光技术与抛光装备研究领域上均取得了突出的成绩, 2012年,清华大学成功研制出具有自主知识产权的国内首台12英寸“干进干出”CMP设备。2013年3月,清华控股联合天津市投资设立华海清科,推动该项科技成果的产业化进程。2014年,通过清华大学科技成果转化,华海清科研制出国内首台12英寸“干进干出”CMP商业机型—Universal-300,2015年该机台进入中芯国际北京厂,2016年通过中芯国际考核并实现销售。这填补了我国集成电路制造领域CMP设备技术的空白,打破了国外垄断。截至2019年4月,该机台已累计加工60000余片硅片。2017年2月,华海清科第二台CMP工艺设备进入中芯国际北京厂,仅用78天的时间就完成了装机、调试,并生产了过百片晶圆,创造了首台国产核心工艺设备在集成电路大生产线上线的最高效率,荣获了中芯国际授予的“突出成就奖”。2018年1月18日,继在中芯国际顺利完成IMD/ILD/STI工艺产品大批量生产之后,清华控股成员企业华海清科的Cu &Si CMP设备进入上海华力。这是国产CMP机台第一次进入上海华力,也标志着国产首台12英寸铜制程工艺CMP设备正式进入集成电路大生产线。
2.4 中电45所
2017年11月21日上午, 由电科装备45所研发的国产首台200 mm CMP商用机通过了严格的万片马拉松式测试,启程发往中芯国际(天津)公司进行上线验证。这意味着电科装备45所的设备得到了用户的认可,产品从中低端迈向了高端,也标志着电科装备向着实现集成电路核心装备自主可控,担起大国重器的责任迈出了重要的一步。杭州众德是新成立的一家公司,由中电科45所中的CMP技术专家创业建立。
2.5 盛美半导体
盛美半导体的CMP设备主要用于后段封装的65~45 nm铜互联工艺。盛美掌握晶圆无应力抛光技术,采用该技术的样机已被Intel和美国LSI Logic公司所采购。在2019年3月上海“SEMICON China2019”上,盛美半导体再次发布先进封装抛铜设备,新推出的封装抛铜设备则针对人工智能(AI)芯片封装工艺开发。不同于传统芯片,AI芯片具有更多的引脚,需要全新的立体封装工艺和封装设备,其中的抛光工艺需要高成本的抛光粉。针对2.5D封装工艺需求,盛美半导体的这款抛光设备采用湿法电抛光工艺,不仅减少约90%抛光粉(CMP)消耗量,还可以对抛光液中的铜进行回收。由于电抛光的化学液可以重复循环使用,这样可以节省80%以上的耗材费用。
3 CMP设备投资要点
CMP设备市场是一个高度垄断的市场,市场份额主要集中于美国应用材料和日本荏原两家巨头,二者占据了全球CMP设备98%的市场份额。其中美国应用材料更是一家独大,2018年市场份额高达71%,排名第二的日本荏原只占有27% [1] 。国产CMP设备目前主要为中低端产品,12英寸的高端CMP设备也主要处在产品验证阶段。虽然出货量较少,但是相较其他半导体设备,国产CMP设备取得了较大的成就,华海清科和中电45所自主研发的12英寸CMP设备填补了我国CMP设备市场的空白,为我国半导体设备国产化替代做出了重要的贡献。
3.1 利好

从市场前景的角度分析,一方面,2018年中国半导体设备市场规模增速将近60%,占全球20%的市场份额。据SEMI预计,2017-2020年间,全球将新增半导体产线62条,其中26条新增产线在中国大陆,占比42%,新增产线将为半导体设备带来巨大的市场空间。另一方面,随着新能源汽车、5G通信以及物联网应用的兴起,MOSFET功率器件、电源管理芯片、5G射频芯片、物联网芯片、MEMS器件以及化合物半导体器件需求非常旺盛,而这些芯片大多是在200 mm的产线上生产完成的,全球集成电路行业在200 mm晶圆厂产能和设备方面都严重短缺,晶圆制造厂一直在寻求扩大200 mm制造产能。但目前国际龙头企业已经基本停产200 mm设备,二手200 mm设备价格也在水涨船高,200 mm设备的市场空间巨大。国内CMP设备厂商200 mm英寸设备技术相对较成熟,国产设备厂商可以抓住集成电路产业快速发展的大好形势,依靠产业政策导向,抢抓机遇、抢占市场,依靠产品价格优势逐步在个别产品或细分领域挤占国际厂商的市场空间,做大做强、实现跨越式发展,为中国极大规模集成电路制造做出积极贡献。
3.2 风险
国内半导体工业的相对落后导致了半导体设备产业起步较晚,尤其在关键设备领域与海外巨头的差距仍有好几十年,受到技术、资金以及人才的限制,国内半导体设备底子薄、基础弱,产业总体表现出企业规模偏小、技术水平偏低、以及产业布局分散的特征。而国际半导体设备发展比较成熟,CMP设备呈现高度垄断的特征,在现有的竞争格局下,国产设备通过研发投入再重头做起,必然会花费大量的时间和精力,产品在下游应用推广过程中还要和海外巨头竞争,而下游厂商对替代也会考量成本因素,能否打开下游市场是企业盈利存活的关键因素。
参考文献
[1]李丹.化学机械抛光(CMP)设备市场概况.电子产品世界,2019(5):11-13
作者简介
李丹,理学博士,中级工程师,研究方向:集成电路材料与设备、化合物半导体、人工智能芯片。
本文来源于科技期刊《电子产品世界》2019年第6期第31页,欢迎您写论文时引用,并注明出处





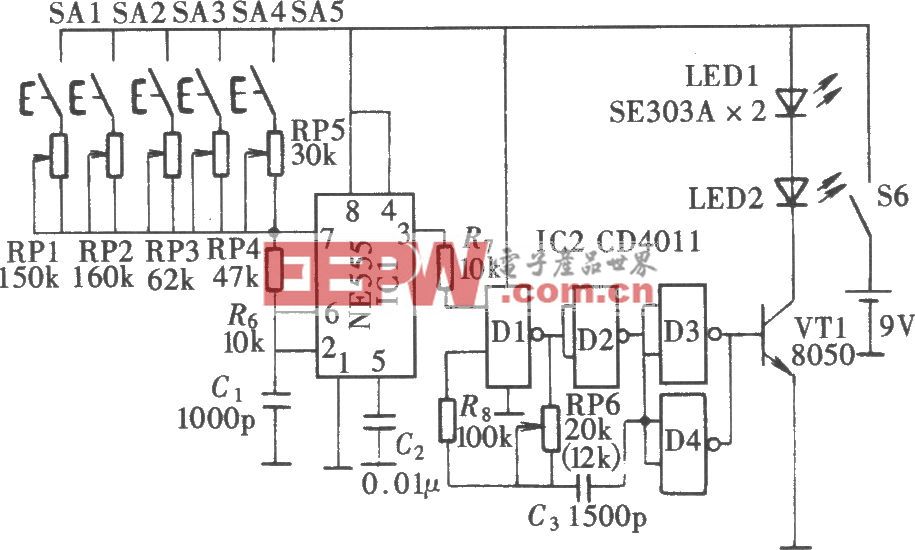

评论