Mentor Tessent VersaPoint 测试点技术帮助 Renesas 降低成本和改进质量
Mentor, a Siemens business 今日宣布在 Tessent® ScanPro 和 Tessent LogicBIST 产品中推出 VersaPoint™ 测试点技术,这些产品仍旧符合 ISO 26262 质量认证要求。VersaPoint 测试点技术不仅能够降低制造测试成本,还能改进在系统测试的质量——对于汽车和其他行业的高质量 IC 而言,这两条要求至关重要。Mentor 还宣布 Renesas Electronics 已经在该公司的汽车 IC 中采用了 VersaPoint 技术,以解决安全关键的测试要求,从而达到汽车安全完整性级别 (ASIL) C 和 D 认证标准。
本文引用地址:https://www.eepw.com.cn/article/201711/371049.htm汽车 IC 中的数字电路通常混合采用片上压缩/ATPG 和逻辑内建自测 (LBIST) 技术来进行测试,从而让制造测试达到极高的缺陷覆盖率,进而实现在系统测试和上电自测试。
测试点是用于改进测试效果的专用设计结构。传统的 LBIST 测试点通过解决 IC 中的“随机模式障碍”来改进测试结果。Mentor 近期专门针对片上压缩/ATPG 的混合使用开发了测试点,相对于仅使用片上压缩的情况,可将 ATPG 模式数减少 2-4 倍。Tessent VersaPoint 测试点技术组合了这些技术,并在它们的基础上进行了改进。
“为了提供业界领先的汽车 IC 产品,Renesas 使用测试点来帮助达到严格的 IC 测试要求,”Renesas Electronics Corporation 汽车 SoC 业务部门副总裁 Hisanori Ito 说道。“利用 Tessent VersaPoint 测试点技术,我们再也无需针对不同类型的 IC 使用单独的解决方案。如此一来,只需通过制造和在系统测试,我们便能改进质量并降低成本。简化的 DFT 实施流程还可缩短开发周期,加快产品上市时间。”
与传统的 LBIST 测试点相比,Tessent VersaPoint 技术可以提高 LBIST 测试覆盖率。而与使用片上压缩/ATPG 测试点相比,它还可以更好地减少 ATPG 模式数。这种技术是专为使用 Tessent 混合 ATPG/LBIST 技术的测试工程师而设计的,旨在降低测试成本、改进测试质量,特别是针对面向汽车应用的 IC 产品。
“随着设计尺寸不断增长,质量要求变得更加严格,我们的客户也一直在努力降低测试成本”,Mentor Tessent 产品系列营销总监 Brady Benware 说道。“与此同时,市场对高可靠性应用中的高效在系统测试的需求也在持续增长。借助 VersaPoint 测试点技术,我们的客户可以通过更有效的方法,同时满足制造和在系统测试要求。”



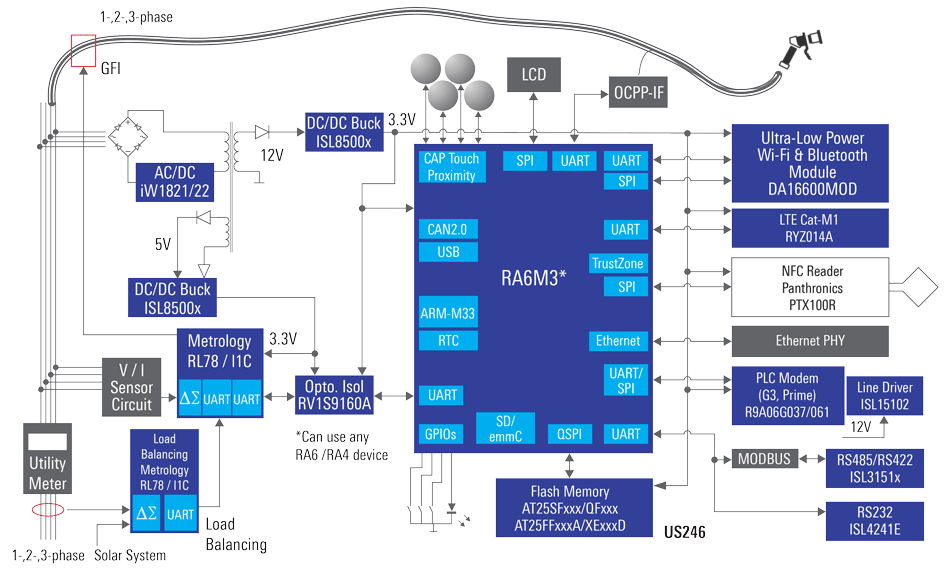






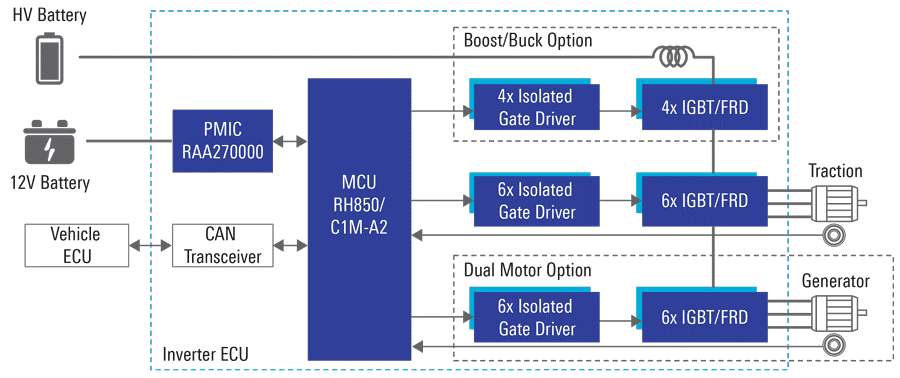







评论