新型部分耗尽SOI器件体接触结构
SOI技术带来器件和电路性能提高的同时也不可避免地带来了不利的影响,其中最大的问题在于部分耗尽SOI器件的浮体效应。当器件顶层Si膜的厚度大于最大耗尽层的宽度时,由于结构中氧化埋层的隔离作用,器件开启后一部分没有被耗尽的si膜将处于电学浮空的状态,这种浮体结构会给器件特性带来显著的影响,称之为浮体效应。浮体效应会产生kink效应、漏击穿电压降低、反常亚阈值斜率等浮体效应。
由于浮体效应对器件性能带来不利的影响,如何抑制浮体效应的研究,一直是SOI器件研究的热点。针对浮体效应的解决措施分为两类,一类是采用体接触方式使积累的空穴得到释放,一类是从工艺的角度出发采取源漏工程或衬底工程减轻浮体效应。所谓体接触,就是使埋氧层上方、Si膜底部处于电学浮空状态的中性区域和外部相接触,导致空穴不可能在该区域积累,因此这种结构可以成功地克服MOSFET中的浮体效应。
人们采取了很多措施来抑制浮体效应,比较常用的如图1所示,有T型栅、H型栅和BTS结构。但T型栅、H型栅技术由于p型Si区体电阻的存在而不能有效抑制浮体效应,而且沟道越宽体电阻越大,浮体效应越显著。BTS结构直接在源区形成p+区,其缺点是源漏不对称,使得源漏无法互换,有效沟道宽度减小。而且,源端的接触引进了较大的寄生电容,使得器件性能变差。

1 新结构的提出
如图2所示,本文提出了一种新的体接触技术,该方法利用局部SIMOX技术,在晶体管的源、漏下方形成离Si表面较近的薄氧化层,采用源漏的浅结扩散,形成侧向体引出结构。未在此基础上,适当加大了Si膜厚度来减小体引出电阻,与以往方法相比,该方法具有较小的体-源、体-漏寄生电容,完全消除了背栅效应、体引出电阻随器件宽度增大而减小,体电阻可以随Si膜厚度的加大而减小,且不以增大寄生电容为代价等优点。因而,该器件能更有效地抑制浮体效应。而且,为形成局部埋氧层,该方法仅仅在工艺上增加了一块掩模版,其他的工艺流程跟标准的SOI CMOS工艺一致,因此该方法具有很好的工艺兼容性。

该结构可以利用低能量、低剂量局部SIMOX技术实现,为了在器件的沟道下方不形成BOX层,在氧离子注入时,利用Si02掩膜进行覆盖,掩膜采用RIE(reactive ion etching),根据形成的局部埋氧层的深度和厚度确定注入的能量和计量,注入完成后,在Ar+0.5%O2的气氛中进行高温退火数小时形成局部埋氧层。Y.M.Dong和P.He等人的实验结果验证了局部SIMOX技术在工艺上的可实现性,利用透射电子显微镜对样品的微结构进行观察,其源、漏下方的BOX层非常完整,BOX层的端口与多晶Si栅相对齐,间距略微大于栅的长度。整个单晶Si的表面非常平整,源漏区没有因为形成BOX层而抬高,也没有在退火过程中受到氧化而降低。表l为新型结构器件的主要工艺参数,其中:Tox为栅氧厚度;TSi为Si膜厚度;Tbox为埋氧层厚度;Tsdbox为源漏下埋氧层厚度;Nch为沟道掺杂浓度;Nsub为衬底掺杂浓度;Ldrawn为沟道长度;Wdrawn为沟道宽度;Xj为源漏结深。
2 模拟结果与讨论
采用ISE―TCAD模拟器对器件进行模拟并讨论模拟结果。体接触可在一定程度上抑制浮体效应。体接触的效果还与接触位置、器件的尺寸和工艺有关。如果体接触效果不好,漏结碰撞电离产生的空穴仍然会在体区积累,使得体区空穴浓度增大,体区电位升高,阈值电压降低,因而漏电流增大。图3为浮体器件、T型栅体接触结构和本文提出的新型体接触结构的输出特性、切线处空穴浓度和器件的转移特性曲线,三种结构工艺条件相同。由图3可见,本文提出的结构体区空穴浓度最低、阈值电压最高、没有kink效应发生,成功的抑制了浮体效应的产生。









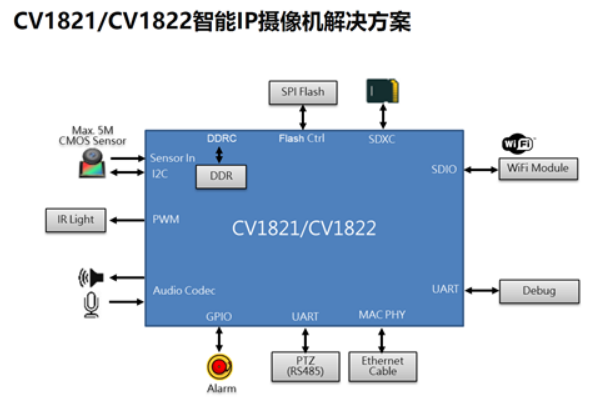
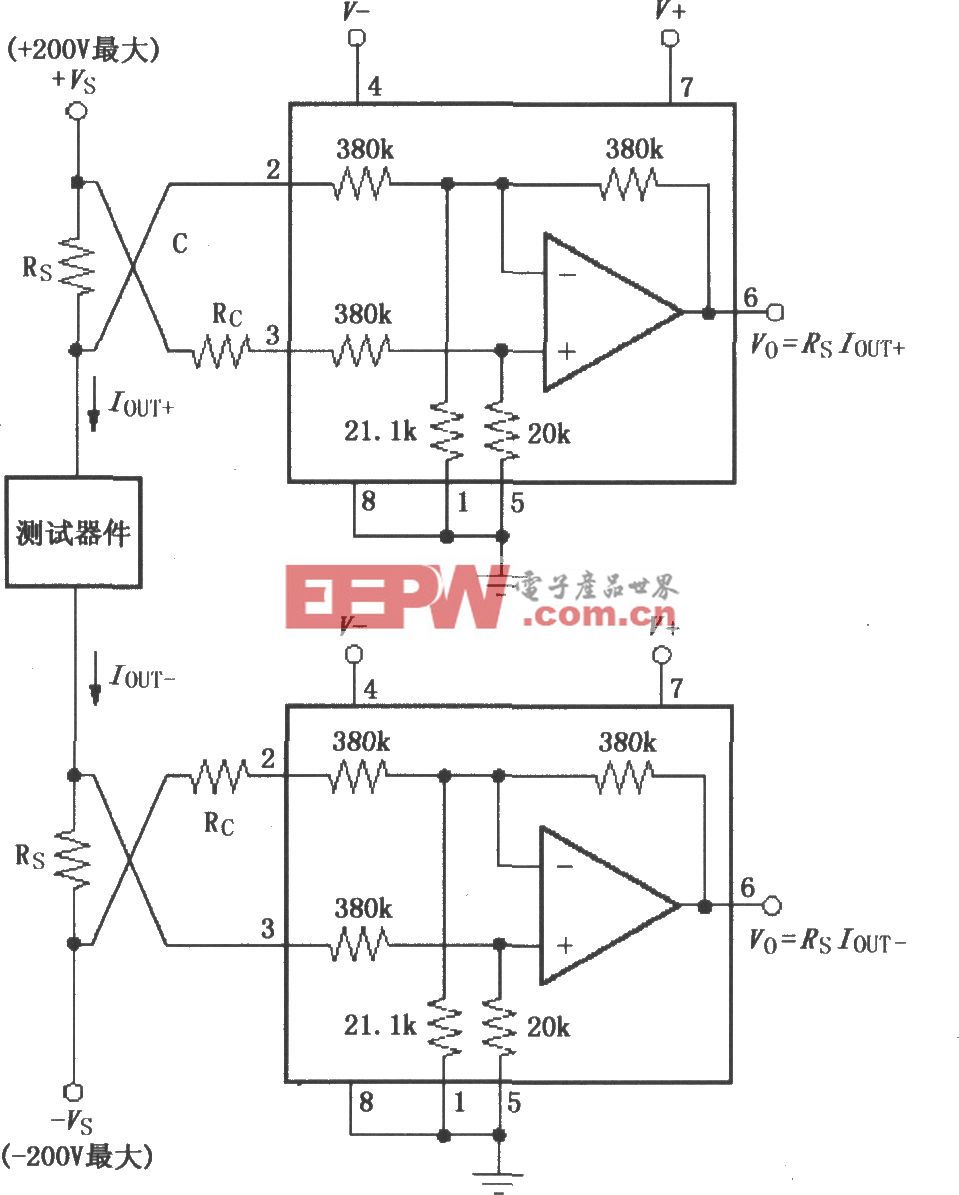





评论