低温p-Si薄膜的制备研究
引言
本文引用地址:https://www.eepw.com.cn/article/168560.htm近年来,有源液晶显示技术在液晶显示产业和研究领域都独占鳌头。在有源液晶显示技术中,多晶硅薄膜因高迁移率展现出独特的优势,它的器件尺寸小,可以获得更高的开口率和分辨率;由于迁移率的提高可以将周边驱动集成于显示板内部,可以有效降低材料成本,同时LCD 整体的重量和厚度将会大幅度的减少。
目前,人们对多晶硅薄膜技术的研究主要集中在降低晶化温度和减少晶化时间上,金属诱导晶化是一项很有潜力的新技术方案,晶化温度可降低到500℃,晶化时间可以缩短。例如Al, Cu, Au, 或 Ni 等沉积在a-Si:H上或离子注入到a-Si:H 薄膜的内部,由于金属的诱导作用,a-Si的晶化温度低于a-Si的SPC温度。准分子激光退火是制备较高迁移率p-Si薄膜的另一有前途的方案,它具有晶化程度高,制备周期短,衬底温度低等一系列突出的优点,呈现出良好的发展前景。
金属诱导法制备多晶硅薄膜
1.金属诱导晶化机理
Hayzelden认为,Ni诱导晶化的发生是由于NiSi2的迁移,由于NiSi2的晶体结构和Si的晶体结构相近,晶格常数相差0.4%,在低于350℃形成NiSi2,作为籽晶,晶化温度可降低到500℃以下。a-Si 在以NiSi2为媒介晶化为多晶硅,硅的晶化是在NiSi2八面体的一面或多面成核。NiSi2的电阻率很低,35uΩ·cm,晶格常数和多晶硅相匹配。金属诱导晶化被认为是由于在界面处金属的自由电子和Si的共价键反应。NiSi2和Si之间的微小的晶格不匹配(0.4%),使Si容易在NiSi2(111)面生长。
2.实验结果与讨论
图1(a)~(c)为Ni-MIC p-Si薄膜在440℃,480℃,520℃退火4h的XRD谱图,图2(a)~(c)为Ni-MIC p-Si薄膜在440℃退火2h、4h、10h的XRD谱图。在XRD衍射谱图上出现多晶硅的特征衍射峰,d=3.13A(111). d=1.91A(220).和d=1.63A(311),a-Si晶化没有优选晶向。XRD衍射峰的强度随着退火时间的延长和退火温度的升高而增强。说明薄膜的晶化强度随着温度的升高和退火时间的增加而增强。
图3为a-Si和a-Si/Ni在440℃退火4h的喇曼光谱图,a-Si谱图上在480cm-1处存在一宽的TO声子峰,Ni存在时其喇蔓谱图在520cm-1处有一个尖锐的TO声子峰,其半峰宽(Full Width at Half Maximum)是5.0cm-1,大于单晶硅的FWHM 4.5cm-1,说明薄膜为多晶结构。由于Ni的存在,a-Si在440℃退火处理后,在480cm-1处没有观察到a-Si的特征峰,说明薄膜完全晶化为多晶结构。
激光退火法制备多晶硅薄膜
1.激光退火法制备多晶硅薄膜原理
a-Si在激光辐射下吸收能量,激发了不平衡的电子-空穴对,增加了自由电子在导带的能量。“热”电子-空穴对在热化时间(约为10-11~10-9s)内用无辐射复合的热途径将自己的能量转给晶格,导致近表层极其迅速地(约为1010K/s)升温。由于a-Si材料具有大量的隙态和深能级,无辐射跃迁是主要的复合过程,因而具有较高的光热转换效率。若激光的能量达到阈值能量密度EC时, 即使半导体加热至熔点温度,薄膜的表面会融化,融化的前沿会以约10m/s的速度深入材料内部,经过激光照射,薄膜形成一定深度的融层,停止照射后融层开始以108-1010K/s的速度冷却,而固相和液相之间的界面将以1~2m/s的速度回到表面。冷却之后,随着薄膜的整体温度下降,在温度较低的固液界面将优先发生非均匀成核,晶核将沿膜的横向和纵向长大。当晶粒相互碰撞后,晶粒停止横向生长。仅有部分“幸运”晶粒的尺寸较大。若激光的能量小于阈值能量EC,即所吸收的激光能量不足以使表面升温至熔点,则薄膜不发生晶化。
2.实验结果与讨论
图4不同激光能量密度扫描所获得薄膜材料的XRD 衍射结果,实验中所使用的衬底温度为400℃、背景真空度为3.2x10-4Pa,激光脉冲频率为3HZ。结果表明,在所使用的激光能量密度范围内,厚度为100nm的a-Si:H薄膜经激光晶化烧结已转化成为多晶硅,其临界能量密度为160mJ/cm2左右。在能量密度为240mJ/cm2 时,XRD谱中已出现了多晶硅的(111)、(200)特征衍射峰,以后随着激光能量密度的增加,(111)、(200)衍射峰的强度增强,在能量密度340mJ/cm2附近,(311)衍射峰也开始出现。从图中可以看出,在所使用的扫描能量密度范围内,a-Si:H薄膜都已出现了由非晶相到结晶相的转变,其中晶面择优化取向的次序为 (111)>(220)>(311)。随着扫描能量的增加,(111)峰强度逐渐增强,而(220)峰则增长缓慢,特别是在激光能量密度增加到456mJ/cm2时,(220)峰反而减弱,显示出较高扫描能量密度时,(111)显著的择优化取向趋势。
图5是使用不同脉冲频率激光光束扫描后所获得薄膜材料的XRD衍射结果。这时所使用的激光能量密度恒定为340mJ/cm2,衬底温度及背景真空度仍分别为400℃和3.2x10-4Pa。从图中可以看出,在较低的扫描激光脉冲频率下,a-Si:H薄膜也出现了由非晶相到结晶相的转变。同时,随着扫描激光脉冲频率的增加,(111)、(220)都逐渐增强,表明材料的晶粒尺寸也在逐渐增大。这是由于随着单位时间内薄膜受光次数的增加,薄膜温度下降速度减慢,固化速度降低,晶粒生长时间延长,尺寸增大。实验中发现,由于类似的原因,在激光扫描烧结中,提高衬底温度,也可以起到降低熔体固化速度、延长晶粒生长时间的作用。因此,在衬底可以承受温度前提下,采用较高的衬底温度,有利于获得较大晶粒尺寸的多晶硅薄膜材料。
图6是采用不同激光能量密度退火时所得薄膜材料的Raman光谱图。由于a-Si:H薄膜的Raman吸收出现在480c-1附近,而Poly-Si出现在520cm-1附近。因此,准分子激光退火多晶硅薄膜材料的结晶度也可以从Raman光谱中获得重要信息。从图中可以看出,随着激光能量密度的升高,结晶度开始时逐渐增大,以后又随着能量密度的增高,结晶度开始下降。这是由于,与能量密度相对较低的情形相比,能量密度的增高导致薄膜的熔融时间延长,成核密度增大,这样在局部区域出现微晶化或非晶化,使薄膜整体的结晶度下降。
小结
我们采用激光退火和金属诱导两种方法在a-Si∶H薄膜基础上制备了p-Si薄膜材料,对在玻璃衬底上制备多晶硅薄膜材料的工艺条件及所获得薄膜材料的结构特征进行了研究。在此基础上可以制作低温p-SiTFT液晶显示器件,能够对我国液晶显示行业的技术进一步提供一些有益的探索。








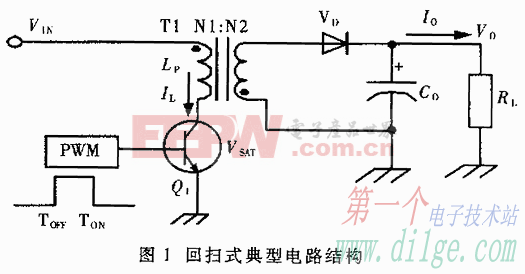


评论