CMOS和MEMS的集成展望
就小型化和提高性能来说,MEMS器件与集成电路的集成已变得愈来愈重要。但目前近一半MEMS市场仍然采用混合方法。由于是模块组装模式,所以混合集成方法的开发时间比单片方法短得多,而且可以独立地优化IC和MEMS工艺技术(图1)。
本文引用地址:https://www.eepw.com.cn/article/160873.htm
但是与单片方法相比,其装配和封装成本却较高。因此,当体积足够大时,单片方法需要的较长开发时间很有可能被装配和封装成本的降低所补偿。
当MEMS和CMOS间的互连很多(如显示器)时,若微型化很重要或要求提高系统性能,即可选择单片集成方法。使用独立的MEMS和IC芯片时,MEMS和逻辑芯片间的互连会产生限制性的寄生参数。这些寄生参数主要是由键合焊盘的大小和长键合线产生的,用芯片上集成的方法可以大大降低这些寄生参数。
当然,成本也是一个重要的考量因素。如果MEMS器件比CMOS电路大得多,单片集成可能非常昂贵。理想情况是它们的大小是匹配的,完全一样的尺寸将不会增加CMOS芯片大小。
不同的单片集成方法
可以用不同方法在先进的CMOS工艺中集成MEMS器件,得到微型单片系统解决方案。主要方法有三个:先加工微系统器件而后加工IC,通常是在敏感元件或执行元件后;二者交错制作;先加工IC而后加工微系统器件,通常是在电路的顶部。
第三种方法是进行智能微系统加工最有前途的方法,因为它可以用标准的CMOS工艺合理地独立优化CMOS和MEMS。而且新一代电路可以很方便地替换老电路而不影响其上部的MEMS。此外,后加工提供了将MEMS和CMOS置于一起的最紧凑形式,因为CMOS电路可能位于MEMS结构下面。但后加工限制了MEMS加工的温度范围。与常规Poly-Si相比,Poly-SiGe在较低温度(即淀积温度≤450℃而不是≥800℃)时仍然能保证MEMS所要求的机械性能和可靠性。这使 Poly-SiGe技术非常适合MEMS的后-CMOS集成。
CMOS-MEMS集成的Poly-SiGe技术
已经开发了多种工艺制造poly-SiGe MEMS,主要研究方向是降低温度或增加同一温度下的淀积速率。采用等离子增强化学气相淀积(PECVD)和CVD结合的多层工艺,能在低温(≤450℃)下以很高的淀积速率(~100nm/min) 得到高质量薄膜(图2)。应力(压应力到张应力)和应力梯度可通过改变SiH4流量或增加应力补偿层调整。这是在标准CMOS顶部淀积厚SiGe层(例如用于电容敏感元件)的理想工艺。对于用富Si应力补偿顶层的10μm厚的薄膜来说,已经获得1.45mΩcm的低电阻率、35MPa的残余张力和3.6×10-6μm-1的极低应变梯度。Al和SiGe间的接触也是CMOS集成需要的欧姆接触。

poly-SiGe MEMS制造陀螺仪
集成陀螺仪已经商品化,但还没有以后加工的形式出现。而是用交错的方法在poly-Si中制作陀螺仪,CMOS电路在另一侧。对于同样的陀螺仪设计,它使得总面积比后加工大且改变CMOS和MEMS工艺都不易。无法采用标准的CMOS工艺,MEMS结构层厚度也受到限制。采用poly-SiGe实现了全功能CMOS上集成ωz-陀螺仪,适合低噪声、高分辨率的要求(图3)。作为功能结构,在标准的高压(20V)、0.35μm CMOS-ASIC上加工10-μm厚的SiGe层,有5层布线和标准的钝化。牺牲层是没有掺杂的厚氧化硅层,用CMP进行平坦化。SiGe结构层由上述的CVD和PECVD工艺淀积,用具有HF和CO2超临界干燥的湿法加工完成应力释放。平面内双翼陀螺仪的驱动和感知是全电容性的。
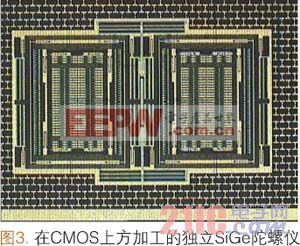








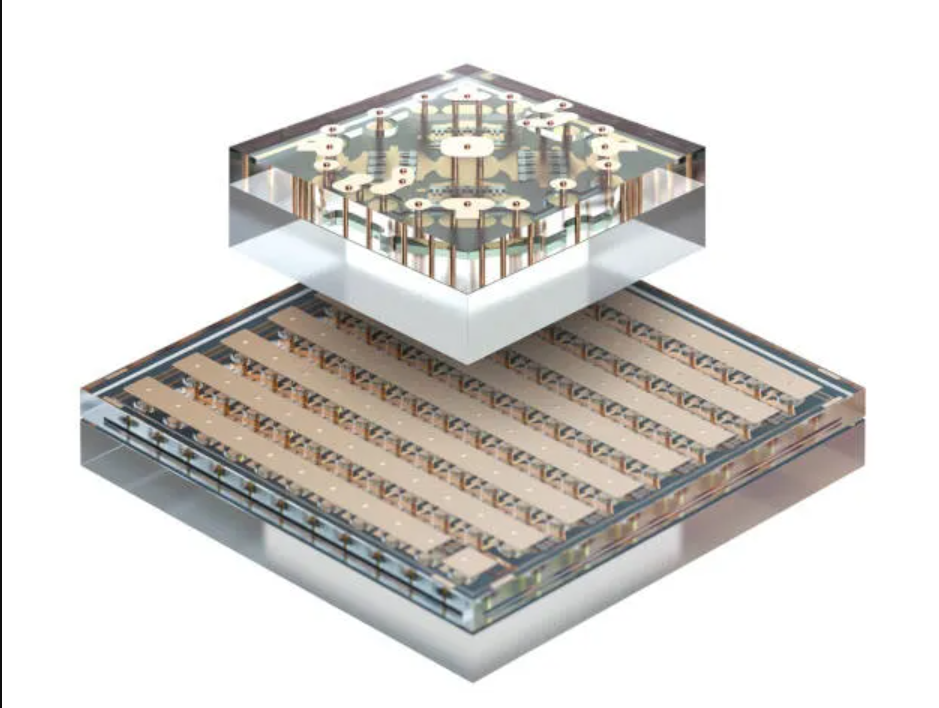





评论