SIP立体封装技术在嵌入式计算机系统中的应用
摘要:描述了立体封装芯片技术的发展概况,SIP立体封装嵌入式计算机系统模块的构成及欧比特公司总线型SIP立体封装嵌入式计算机系统模块产品简介等。
本文引用地址:https://www.eepw.com.cn/article/141885.htm概述
目前大部分集成电路均采用平面封装形式,即在同一个平面内集成单个芯片的封装技术。由于受到面积的限制难以在同一平面上集成多个芯片。所谓立体封装是一项近几年来新兴的一种集成电路封装技术,突破了传统的平面封装的概念;它是在三维立体空间内实现单个封装体内堆叠多个芯片(已封装芯片或裸片)的封装技术(如图1所示)。近些年来随着微电子技术、计算机技术的迅猛发展,嵌入式计算机系统在各类系统级电子产品中得以广泛应用。各类移动设备、手持设备、民用电子产品的操作和控制越来越依赖于嵌入式计算机系统,而且要求系统不仅具有较高的性能,而且还要具有占用空间小、低功耗等特点。这就给嵌入式计算机系统提出了更高的要求。SIP立体封装芯片由于其集成度高,占用空间小,功耗低等特点,在未来的电子设备中将得到越来越广泛的应用。

立体封装芯片的主要特点
(1)集成密度高,可实现存储容量的倍增,组装效率可达200%以上;它使单个封装体内可以堆叠多个芯片,可以实现存储容量的倍增,比如对SRAM、SDRAM、FLASH、EEPROM进行堆叠,可以使存储容量提高8~10倍;
(2)单体内可实现不同类型的芯片堆叠,从而形成具有不同功能的高性能系统级芯片,比如将CPU、SRAM、FLASH等芯片经立体封装后,形成一个小型计算机机系统,从而形成系统芯片(SIP)封装新思路;
(3)芯片间的互连线路显著缩短,信号传输得更快且所受干扰更小;提高了芯片的性能,并降低了功耗;
(4)大幅度的节省PCB占用面积,可以使产品体积大幅度缩小;
(5)该技术可以对基于晶圆级立体封装的芯片进行再一次立体封装,其组装效率可随着被封装芯片的密度增长而增长,因此是一项极具发展潜力而且似乎不会过时的技术。
立体封装芯片技术发展状况
随着IC器件尺寸不断缩小和运算速度的不断提高,封装技术已成为极为关键的技术。封装形式的优劣已影响到IC器件的频率、功耗、复杂性、可靠性和单位成本。集成电路封装的发展,一直是伴随着封装芯片的功能和元件数的增加而呈递进式发展。封装技术已经经历了多次变迁,从DIP、SOP、QFP、MLF、MCM、BGA到CSP、SIP,技术指标越来越先进。封装技术的发展已从连接、组装等一般性生产技术逐步演变为实现高度多样化电子信息设备的一个关键技术。目前封装的热点技术为高功率发光器件封装技术、低成本高效率图像芯片封装技术、芯片凸点和倒装技术、高可靠低成本封装技术、BGA基板封装技术、MCM多芯片组件封装技术、四边无引脚封装技术、CSP封装技术、SIP封装技术等。
立体封装被业界普遍看好,立体封装的代表产品是系统级封装(SIP)。SIP实际上就是一系统级的多芯片封装,它是将多个芯片和可能的无源元件集成在同一封装内,形成具有系统功能的模块,因而可以实现较高的性能密度、更高的集成度、更低的成本和更大的灵活性。立体封装技术是目前封装业的热点和发展趋势。
linux操作系统文章专题:linux操作系统详解(linux不再难懂)





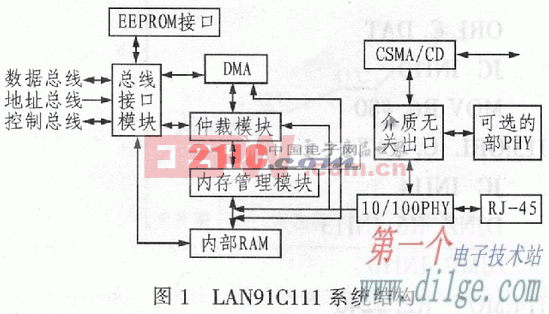
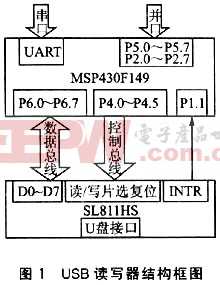

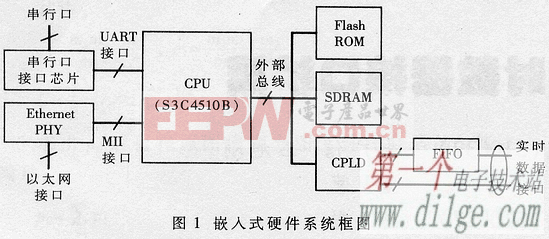
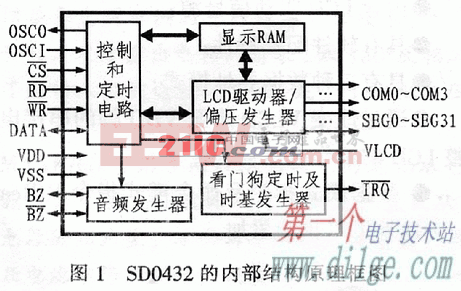
评论