科利登GlobalScan-I解决系统定位复杂设计和成品率问题
科利登系统有限公司日前宣布:突出GlobalScan-I系统-用于器件物理分析和定位工艺性能成品率问题的新型集成电路诊断系统。GlobalScan-I能够鉴别出通常被测试失效分析和调试方法遗漏的失效源,这一特点可以实现快速的设计修正,从而降低掩模重加工成本并缩短产品进入量产时间。
科利登董事会主席兼首席执行官Graham Siddall博士说:“现代集成电路呈现广泛的失效模式,从结构化失效到间歇的或敏感的缺陷,可能的根本原因会有很多。通过隔离与设计或制造工艺无关的问题,用户能够通过提高产品性能和缩短产品面市时间获得显著的竞争优势。”
专利的光学、扫描技术和软件设计使GlobalScan-I更高效同时与目前市场上其它失效分析系统相比更稳固。与传统的激光扫描显微镜 (LSM)系统不同,GlobalScan-I支持多种物镜选件,采用亚微米图像叠加方法的精密定点和步进扫描模式和实时的集成CAD导航技术。物镜的选择包括用于倒贴片和线绑定封装芯片的两个固体浸润物镜系统和用于较难探测结构条件下的长工作距离 (LWD)物镜。此外 GlobalScan-I 还具有一个倒向腔体(inverted-column )设计,用于与生产测试设备对接。
该系统与科利登的EmiScope系统(业界领先的IC调试探测系统)构建于同一平台上,可以根据需要直接升级使其具有和EmiScope相同的功能。将EmiScope技术结合到GlobalScan-I系统中允许用户通过重新装配,在整体隔离技术和节点级信号探测间切换系统功能。




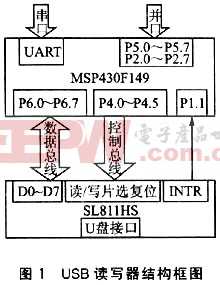
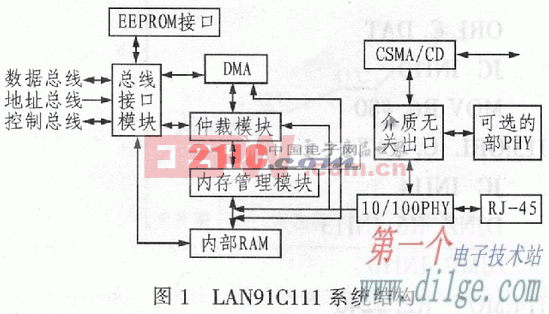

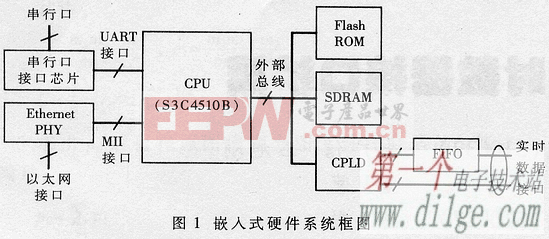
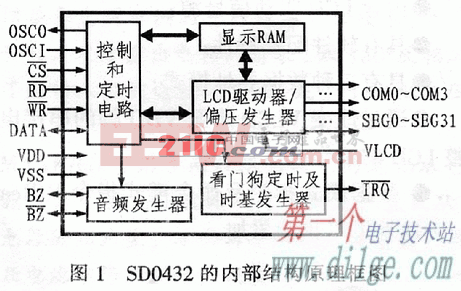
评论