AI芯片需求激增,封装材料短缺冲击韩国半导体产业
据业内人士透露,随着AI服务器和高速运算(HPC)需求的快速增长,半导体供应链面临严峻挑战。尽管晶圆代工产能紧张,但对许多以成熟制程为主的通信IC设计公司而言,真正的瓶颈却出现在封装测试环节。
NVIDIA等大客户提前锁定关键材料和基板产能,导致新客户在封测供应链端的等待时间被拉长至一年左右。韩国通信IC设计行业相关人士指出,晶圆代工阶段的影响相对较小,交期约3个月,但封测环节的交期却延长至4~5个月,新客户甚至需要等待6个月到1年。
特别是高频率通信芯片的生产,受到封装基板关键材料T-Glass(低热膨胀系数玻纤布)短缺的严重影响。T-Glass能有效抑制封装过程中因高温产生的细微翘曲变形,从而提升AI芯片的性能稳定性。然而,目前全球90%的T-Glass由日本日东纺生产,供需失衡问题日益严重。
据日东纺透露,新一代T-Glass的研发目标是将热膨胀系数从2.8ppm降至2.0ppm,预计2028年实现量产。然而,新产能扩张计划要到2026年底才能加速推进,这使得T-Glass的供应短缺问题短期内难以缓解。
与此同时,中小型IC设计公司面临更大的压力。即使已签订合同,封测代工(OSAT)合作伙伴的交期也拉长至18~28周,新客户甚至需要等待52周。价格方面,新客户特别是资源有限的中小型公司,可能因高昂的报价而难以承受。












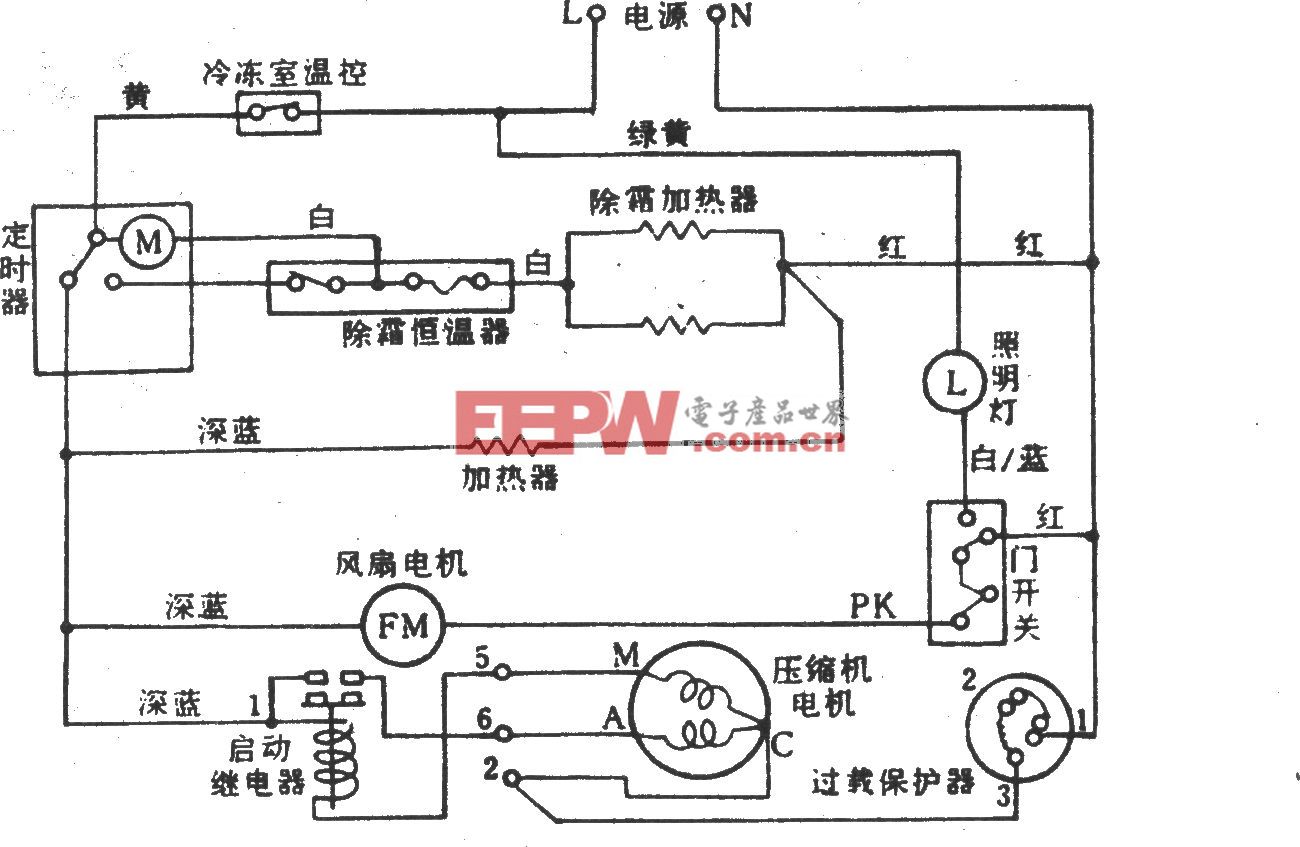



评论