需求爆发,英伟达等大厂积极争夺CoWoS产能
人工智能(AI)芯片热潮之下,CoWoS先进封装需求水涨船高。最新消息显示,英伟达、AMD、苹果等厂商正积极争夺CoWoS产能。
CoWoS需求爆发,英伟达、AMD等积极追单
近期,媒体报道,GPU大厂英伟达10月已经扩大CoWoS订单,除此之外,包括苹果、AMD、博通、美满电子等在内的四家大厂近期同样积极追单。
据悉,英伟达一直是台积电CoWoS封装大客户,单英伟达一家公司就占据了台积电CoWo六成产能,主要应用于H100、A100等高性能芯片。未来,英伟达将陆续推出H200与B100架构,先进封装需求将持续上升。
与此同时,AMD相关AI芯片处于量产阶段,明年先进封装需求同样高涨,加上AMD旗下赛灵思也是台积电 CoWoS先进封装主要客户,需求将进一步上升。业界认为随着AI需求持续增加,英伟达、AMD等公司开始对台积追加 CoWoS先进封装产能,未来CoWoS将迎来需求大爆发。
为此,台积电正积极扩充CoWoS产能。报道指出台积电正对设备厂商追加订单,已有多家先进封装设备厂陆续接获台积电通知,必须全力支援其扩大先进封装产能。此外,台积电还计划到2024年将CoWoS产能提升至3.5万片/月,该数字比台积电原计划提升了20%。
先进封装供不应求,未来产能将再成长3-4成
根据TrendForce集邦咨询研究指出,AI及HPC等芯片对先进封装技术的需求日益提升,其中,以台积电的CoWoS为目前AI 服务器芯片主力采用者。CoWoS封装技术主要分为CoW和oS两段,其中,CoW主要整合各种Logic IC(如CPU、GPU、AISC等)及HBM存储器等,另外,oS部分则将上述CoW以凸块(Solder Bump)等接合,封装在基板上,最后再整合到PCBA,成为服务器主机板的主要运算单元,与其他零部件如网络、储存、电源供应单元(PSU)及其他I/O等组成完整的AI 服务器系统。
TrendForce集邦咨询观察,估计在高端AI芯片及HBM强烈需求下,TSMC于2023年底CoWoS月产能有望达12K,其中,英伟达在A100及H100等相关AI Server需求带动下,对CoWoS产能较年初需求量,估提升近5成,加上AMD、Google等高端AI芯片需求成长下,将使下半年CoWoS产能较为紧迫,而此强劲需求将延续至2024年,预估若在相关设备齐备下,先进封装产能将再成长3-4成。
TrendForce集邦咨询指出,值得注意的是,在AI较急促需求下,无论是HBM或CoWoS生产过程中,得后续观察周边配套措施,例如硅通孔封装技术(TSV)、中介层电路板(Interposer)以及相关设备(如湿制程设备)等是否能到位,如前置时间(Lead Time)等考量。而在AI强劲需求持续下,预估英伟达针对CoWoS相关制程,亦不排除将评估其他类似先进封装外援,例如安靠或三星等,以应对可能供不应求的情形。



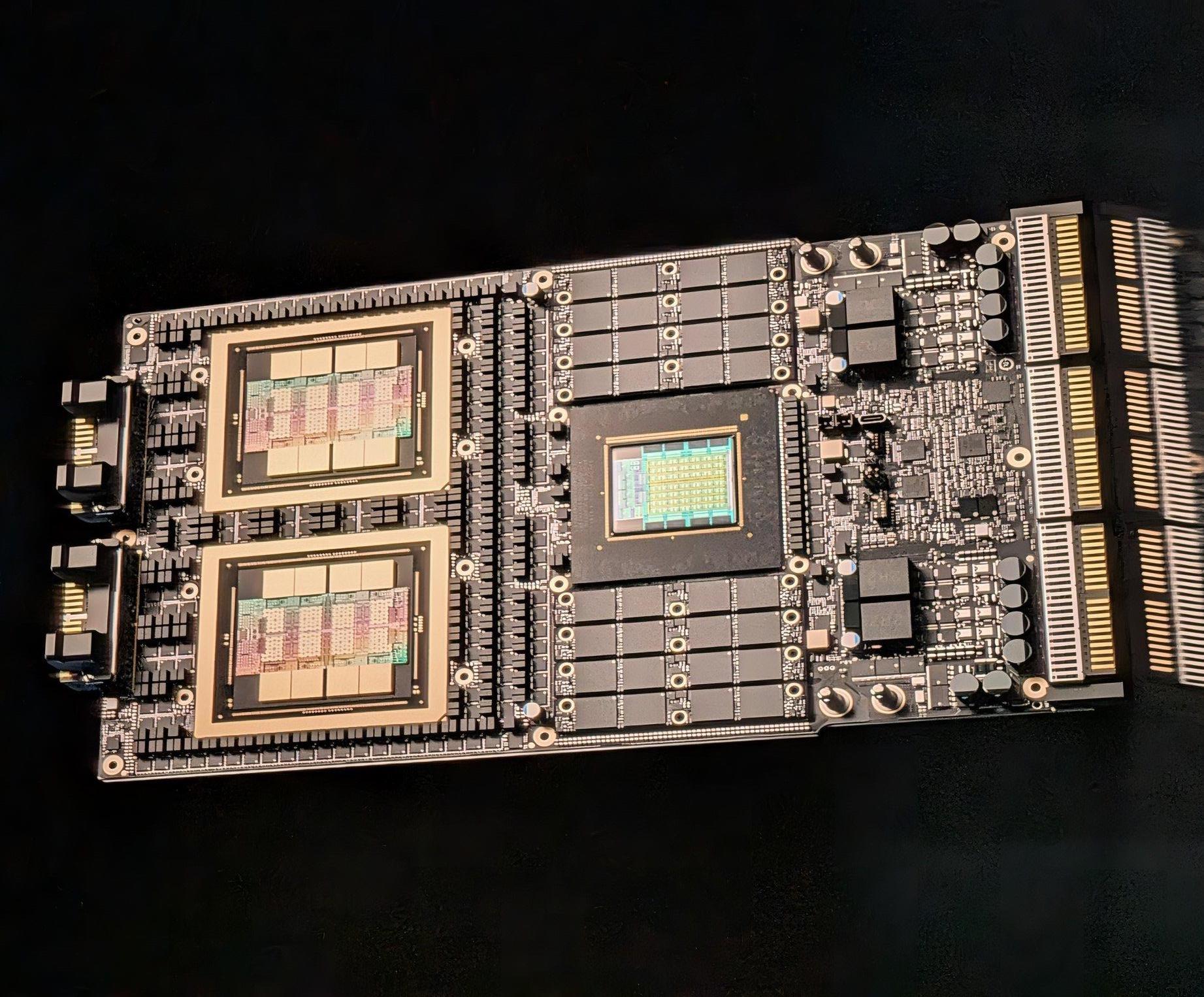





评论