栅极导电层Au 迁移导致放大器失效原因分析
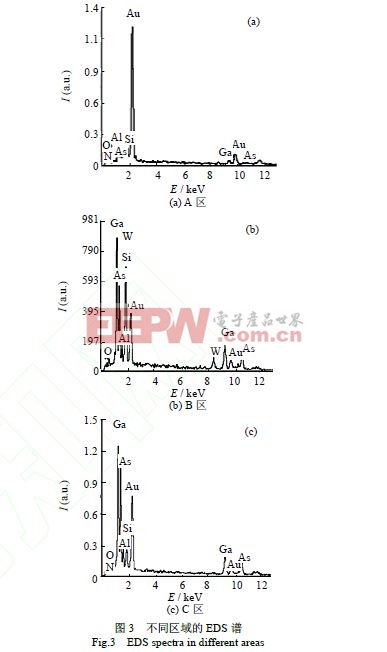

因此,图3 和表1 的数据表明,镀Au 导电层B区域出现Au 迁移现象,导致其表面出现孔洞,而一部分的Au 又迁移到C 区域形成小丘状的金属颗粒。
2.2 Au 迁移引起MESFET 管失效原因分析
Au 做肖特基势垒金属时,Au 与GaAs 的黏附性能也不好,并且Au 向半导体内部扩散及镓向Au 的扩散还促进了Au 向砷化镓扩散。而铝不但具有高的电导率,还与砷化镓有好的黏附性,但铝具有易氧化,承受电冲击的能量较小、易电迁移和电导率比Au 低等特性,因此在铝和Au 之间加入钨阻挡层,防止铝易氧化及屏蔽Au 向GaAs 扩散效应。
电路工作过程中,栅条较细,其导电层上面的电流密度较高,金属离子主要受到电子流对它的作用力,从而和电子流一样朝正极方向移动,相应所产生的金属离子空位向负极方向移动,这样就造成了Au的净质量传输。
在电迁移过程的扩展阶段,由于采用了高对流系数的热传导方法,互连结构的实际温升得到了控制,显着减小了高温引起的原子热迁移对电迁移的干扰,所以此阶段Au的迁移驱动力主要是电迁移力。
在电迁移过程的快速失效阶段,Au 的迁移是热迁移和电迁移共同作用的结果:电迁移力驱动阴极处原子的迁移,Au 的流失导致电阻增大造成了局部区域的快速温升;而更高的温度使得热迁移力成为原子迁移的主要驱动力,并最终导致了Au 严重的流失,使B 区域出现孔洞现象,C 区域出现了含有大量Au 的金属小丘。
3 结论
在电流作用下,放大器中MESFET 栅条镀Au层出现了Au 的电迁移,使导线局部电阻的增大,温度升高,使 Au 的热迁移加重,最终导致导线出现孔洞现象和栅源极处出现小丘状的金属颗粒。孔洞现象会使导线出现开路,而栅源极间的金属颗粒造成的不稳定接触会出现短路现象,导致MESFET 工作参数漂移和放大器不正常工作。
因此,为了提高抗电迁移能力,设计方面应从降低电流密度、降低结温、增加散热方面合理研发半导体器件;工艺方面应严格控制金属膜质量并进行检查;最后建议器件在封装、存储时应避免湿气环境,一定程度上可以降低电迁移的发生几率。
电子管相关文章:电子管原理











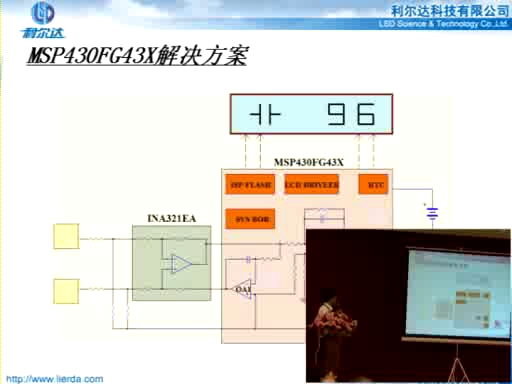

评论