如何使用氮化镓器件:引进氮化镓晶体管技术
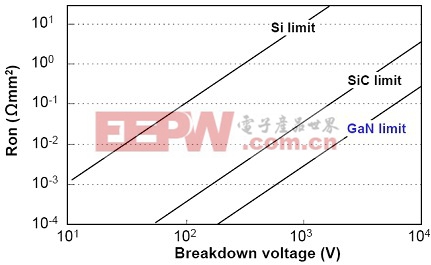
图一:硅、碳化硅及氮化镓器件的理论导通电阻与阻挡电压能力的关系的比较。

图二:在一个12 V 转1.2 V的降压转换器,氮化镓场效应晶体管与硅功率MOSFET器件的硬开关开启速度的比较。 可见三个器件均具备相同导通电阻,但具有不同的击穿电压。
氮化镓器件的横向结构有助它的flip-chip封装,它是一种高性能的封装,因为具最低阻抗及端子电感。此外,氮化镓功率器件在晶片尺寸方面比硅器件优越,因为它采用高效封装,使它的尺寸比现今器件小很多。
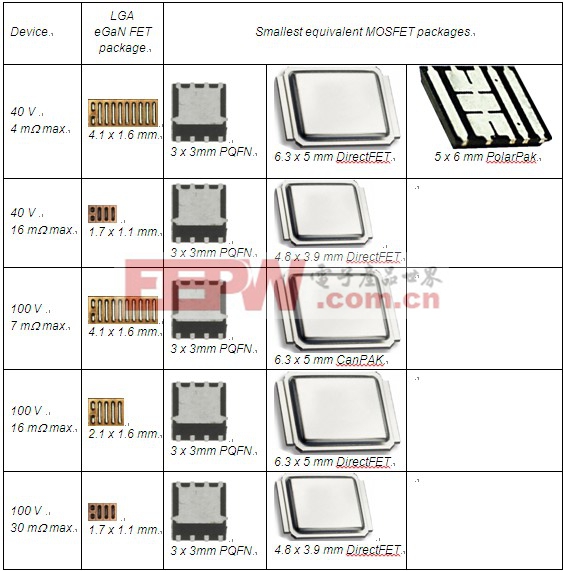
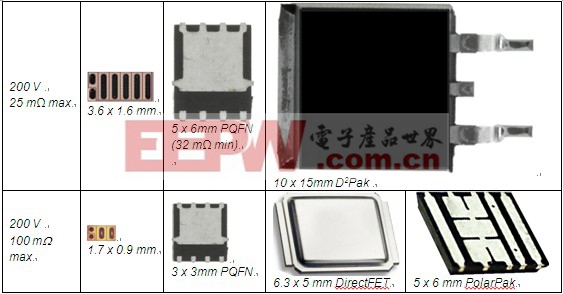
表二:功率MOSFET器件的各种封装与氮化镓场效应晶体管的栅格阵列封装的比较。
表二比较了氮化镓场效应晶体管与具有相同导通电阻的MOSFET器件的尺寸。氮化镓场效应晶体管由于具有高效晶片级栅格阵列封装及更小的晶片尺寸,大大缩小了器件在印刷电路板上的总体占位区域。这证明氮化镓器件再次比MOSFET器件优胜!
氮化镓晶体管建构于一个比较新的技术,因而它的制造成本比等效硅器件为高。但这是暂时的情况,正如在我们的教科书(氮化镓晶体管-高效功率转换器件)第十四章所述,氮化镓场效应晶体管可以逾越这个障碍,实现比等效功率MOSFET或IGBT器件更低的成本。
氮化镓场效应晶体管的基本结构
氮化镓场效应晶体管的基本结构见图3。与任何功率场效应晶体管一样,氮化镓器件的结构具有栅极、源极和漏极电极。源极和漏极电极穿过AlGaN 顶层与下面的二维电子气形成欧姆接触,并在源极和漏极之间形成短路,直至二维电子气区域内的电子耗尽,以及半绝缘的氮化镓晶体可以阻隔电流为止。为了耗尽二维电子气的电子,我们需要将栅极电极放置在AlGaN 层的上面。对于很多早期的氮化镓晶体管来说,这个栅极电极形成为一个与顶部的表面接触的肖特基接触点。在这个接触点施加负电压,肖特基势垒将变成反向偏置,从而使下面的电子耗尽。因此,为了把器件关断,需要施加相对于漏极和源极电极的负电压。这种晶体管名为耗尽型或D 型异质结构场效应晶体管(HFET)。
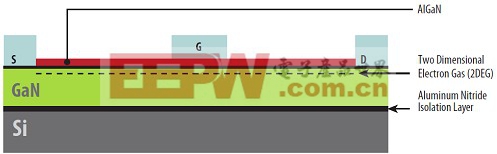
图三:典型的AlGaN/GaN 异质结构场效应晶体管结构,具栅极、源极和漏极三个金属半导体接触点。














评论