CMOS和MEMS的集成展望
做特性测量时,陀螺仪芯片置于有辅助电路的试验板上。在3mBar处工作时得到0.01°s-1 sqrt(Hz)-1/2的噪声,相应于50Hz带宽系统的最小分辨率为0.07°s-1。
poly-SiGe MEMS制造平坦可靠的微镜
单片集成微镜阵列已是在视频投影、自适应光学和掩膜制作系统中应用的成熟器件。现在大多数集成微镜采用Al基,常常引起可靠性方面的问题。用Si替换Al可解决此问题,但将Si微镜与CMOS驱动电路集成只能用晶圆键合技术实现。与陀螺仪的情况类似,当需要在CMOS上加工MEMS器件时,SiGe可以替代Si。IMEC开发的用于微镜的SiGe结构层是微晶SiGe层(μc-SiGe:H)(图4),它可以在比用于陀螺仪的厚SiGe(450℃)更低的温度(300-400℃)下淀积。而且SiGe的小晶粒(最大的直径为100nm)确保了亚微米铰链一致和可重复的机械性质。用μc-SiGe:H制作的微镜尺寸在7.5×7.5和16×16μm2之间,亚微米铰链从250到400nm。工艺流程的热温度范围保持在CMOS兼容的420℃以下。十分平坦的微镜(3-4nm 凹凸,表面粗糙度0.3nm)显示,20天以上没有铰链蠕变,5×1010次循环后没有疲劳损伤。这些器件是现在Al基微镜非常有希望的替代品,也是能满足微镜平坦性、一致性和可靠性等性能的优良备选者。

结论
Poly-SiGe后加工有可能成为一种通用技术,用它能在标准CMOS顶部加工不同的MEMS器件。此外,类似的加工可用来制作MEMS器件上方的薄膜覆盖,形成节省面积的MEMS器件规模0级封装。此工艺有可能最终促成高度集成的产生,这种微型系统具有多个在单芯片上后加工的封装传感器和执行元件。








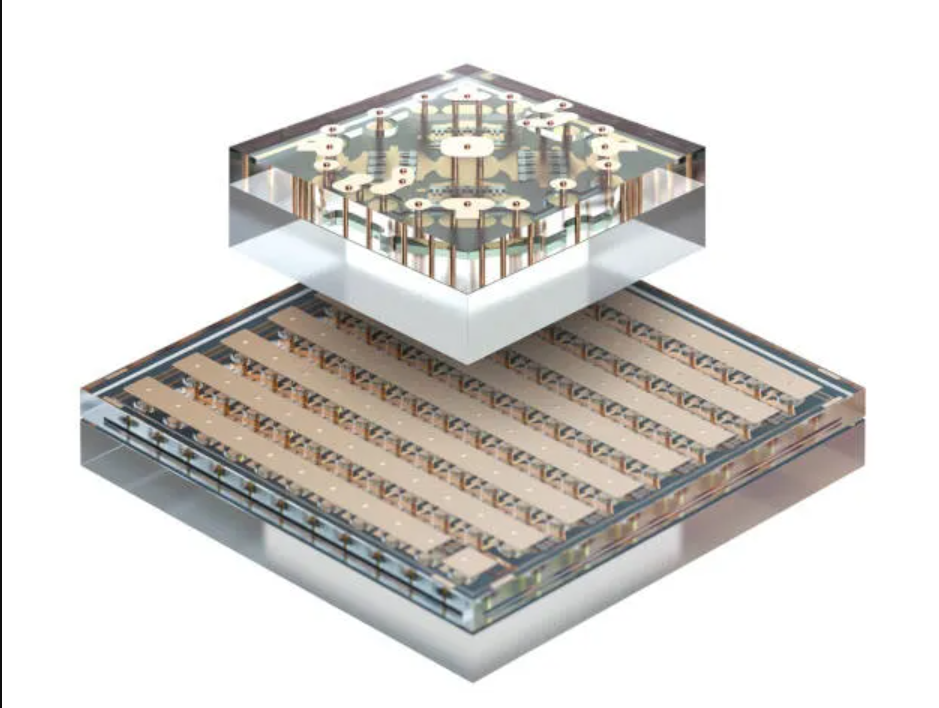





评论