扫描测试提高130nm成品率
传统基于扫描的实时(at-speed)延迟测试系统以系统时钟的速度来检查信号的跃迁。但对于130nm节点及以下的设计,实时测试已不足以检测出许多设计路径中的微小延迟缺陷。因此,我们需要一种新的检测方法,能够检测所有电路路径中的微小延迟,并且比实时测试速度更快。
由于像电阻断路等故障并不会影响一个电路的整个逻辑结果,因此很难采用单时钟(粘着性故障)模式来进行检测。虽然其中一些缺陷可以采用IDDQ模式进行检测,但是,这种方式却很难隔离和诊断检测出来的故障,而且,尽管是在新设计中,相对较高的背景漏电流也会使IDDQ检测很难进行。
为了有效地检测延迟缺陷,业内正在转向路径延迟测试。这种模式的检测效果取决于一个故障传输以及最终观测到的路径中的松弛量(slack)。如果微小物理缺陷(small physical defect)与其观测点相距过于松弛的话,就会无法观测到缺陷,因为,松弛量过大就会延长故障时间。
实时延迟测试
延迟测试生成算法基于可控性和可观测性评估,趋向于沿着最容易接近的路径生成测试模式,这些算法以系统时钟速度对瞬态变化进行测试,其所选择的路径也趋向于最短。
如果在一个较短路径中,模式生成器将故障划分为“已测”,那么,生成器就不会再次对该故障进行评估,而是沿着较长的路径继续观测。因此,较短路径中其他的微小缺陷可能就会被漏测,甚至被标记为已检测。
例如,如图1,假设在位置A有一个缺陷,并且缺陷效应可以在位置B或C观测到,则自动测试模式生成器将会沿着底部较短的、到C的短路径进行检测,因为这样做相对容易并且速度较快,但如果沿着顶部较长路径检测,其发现微小缺陷的机会会更大。
图 1

为了在现有测试软件的局限性内工作(现有软件趋向于沿着较短的、不重要的路径检测和划分故障)并消除沿路的松弛量(消除逃脱测试的可能性),可以使用比系统速度更快的新技术来测试芯片。
比实时延迟测试更快的测试技术
解决松弛问题相当直接的办法是在尽可能消除松弛的情况下创建测试模式。假设对测试生成或故障仿真不做任何变化,增加测试模式的时钟速度就可以消除松弛量。
换言之,该方法仍然测试短路径,但是测试速度将会变快。为了采用这种方法,必须确定合适的时钟范围,以便大部分路径在尽可能小的松弛量下被测量。针对每一个时钟域获取电路中路径长度的分布,来确定时钟范围。一旦确定了范围,就需要生成在这些不同速度下运行的测试模式,而且必须选择每一个频率增量的间隔。这些间隔可能再次引入松弛问题,但是,工程师们可以选择足够小的间隔使松弛量为最小。理想情况下,测试生成器将为每一个具有最小可能松弛量的瞬变自动创建测试。
在图2中,FTAS(faster than at-speed)测试消除了沿着路径A到C的松弛,并允许在A检测故障。然而,为了这个测试成功,必须标记沿着较长路径的触发器。因此,为了以各种速度创建工作在实际硅片测试器上的测试模式,必须指示出那些不能以高于系统速度运行的路径所反馈的触发器,以便测量Xs(不必在意状态)。
图 2

自动生成FTAS测试的方法之一,是采用电路时序,为较短的路径生成FTAS测试,并根据需要掩蔽较长的路径。根据从业内标准时序分析工具获得的标准延迟格式(SDF)时序数据,可以为自动测试程序生成器(ATPG)引擎提供时序信息。ATPG引擎以内部为测试模式“安排时序”,并确定哪些触发器要被不满足所需时序的路径反馈。然后自动标记这些触发器以便在模式集里测量X。
测试生成算法应该首先创建频率最快的模式,然后依次创建频率较慢的模式。随着测试生成的进行,测试覆盖率也逐渐被累计起来。而后续的测试模式运行不会再沿着较慢的路径测试这些故障,从而节省了测试生成和仿真的时间。
实际测试案例
我们研究了该方法在130nm图像处理器上的应用,其中生成了大约27,000个双时钟延迟测试模式,实现了85%的瞬态故障覆盖率。这些测试模式都是以功能速度(functional speed, 保持系统功能正常的运行速度)运行。尽管利用了这种鲁棒(robust)的模式集,但在系统级测试里仍然发现了一些故障。
在芯片的特定路径上,主时钟域里,我们运行了静态延迟分析以确定松弛量(假设时钟以实时运行),如图3所示。注意大约一半的路径松弛时间超过1ns。该芯片非常适合用做这些实验,因为许多路径都具有高松弛时间。增加大量短路径,会增加故障效应流入短路径和长路径的机会。
图 3

这些芯片中有一个被发现没有通过系统级测试的芯片X。芯片X通过了27,000个实时延迟测试模式的鲁棒集,我们将此集合称为模式集P1。另外增加的1000个测试模式称为模式集P2,它们被定时为刚好超过两倍功能时钟速度(在邻近某处对13%的延迟故障进行检测)。
在根据模式集P1划分出的覆盖率顶上,我们对模式集P2进行了故障仿真,发现没有额外故障被划分出。这就表明,模式集P1已经测试了由模式集P2覆盖的所有故障,因此,两个模式集的主要差异在于测试器上模式运行的速度。
我们又利用为低压和高温这样的最坏情况生成的SDF文件创建了模式集P2。由于实际测试器条件比创建SDF的条件(较高温度和较高电压)要好一些,所以,我们线性地调整了延迟数据,直到测试模式以其额定速度开始在实际硅片上开始工作。我们无法以额定速度对触发器进行测量,所以必须正确地校正延迟数据以便掩蔽触发器。根据经验,当我们将数据调整为其数值的95%时,为1.08 V和125









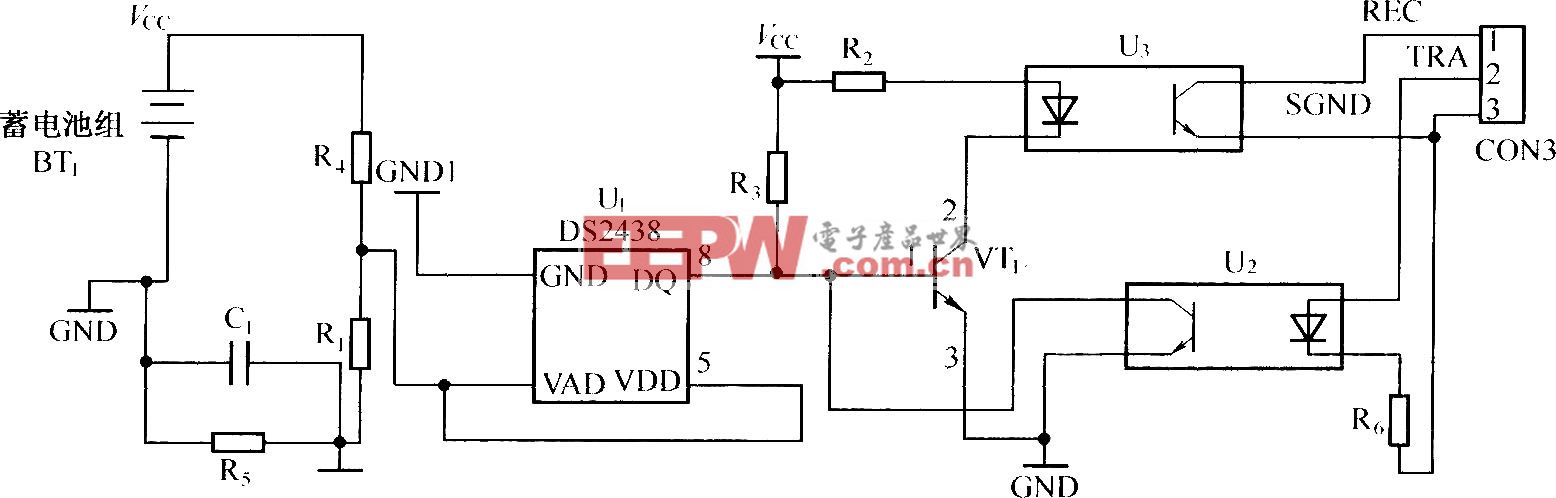
评论