第三代半导体材料封装过程中如何降低“受损率”
半导体封装是一套非常复杂的流程,支撑起了全球庞大的产业链条,这个链条上的每一环都有着细致的分工和严苛的要求,封装形式和封装技术也非常多,且在不断迭代当中。
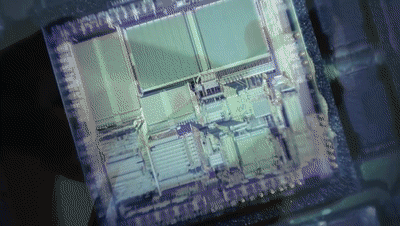
笼统来讲,封装技术就是将集成电路用绝缘的塑料或陶瓷材料打包的技术。
而集成电路则是将具有一定功能的电路所需的半导体、电阻、电容等元件及布线全部集成在一小块硅片上,再封装在一个管壳内所形成的微型结构。 当今半导体工业大多数应用的都是基于硅(Si)和锗(Ge)的集成电路,硅(Si)和锗(Ge)也就是我们所说的第一代半导体材料。

随着终端市场需求的不断升级,如今半导体材料已经发展到了第三代,第四代也已在研究当中,虽然现在还未得到广泛应用,但对下游产业链的发展有着积极的导向作用。

第三代半导体材料的特性及应用
第一代半导体材料中的硅(Si)目前依然是市场上最主流的半导体材料,制程技术最为成熟,成本也最低;第二代半导体材料主要应用在射频、通讯及照明产业,市场份额相对较小。
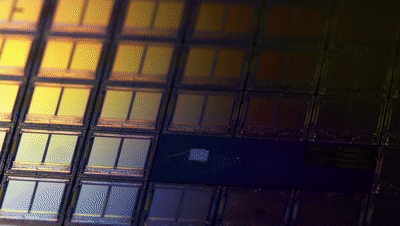
第三代半导体材料具有宽禁带、高热导率、高发光效率、高电子密度、高迁移率、高饱和电子速度等特性。SiC的击穿电场强度高于Si一个数量级,饱和电子漂移速度是Si的2.5倍。
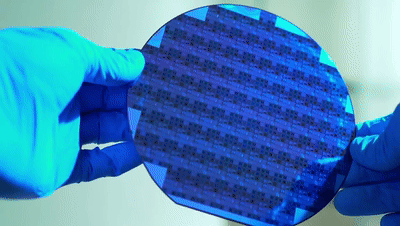
所以,第三代半导体材料更适用于制作高温、高频、抗辐射及大功率电子器件,在5G****、快充、智能电网、新能源汽车、半导体激光器等领域大有可为。
第三代半导体材料的应用难点
1.成本高SiC成本高昂,同等规格的SiC器件比硅器件单个管芯的价格要高3-5倍。尽管SiC在晶圆上的尺寸可以做到很小,平均下来可降低一定的成本,但总体来说还是更贵。
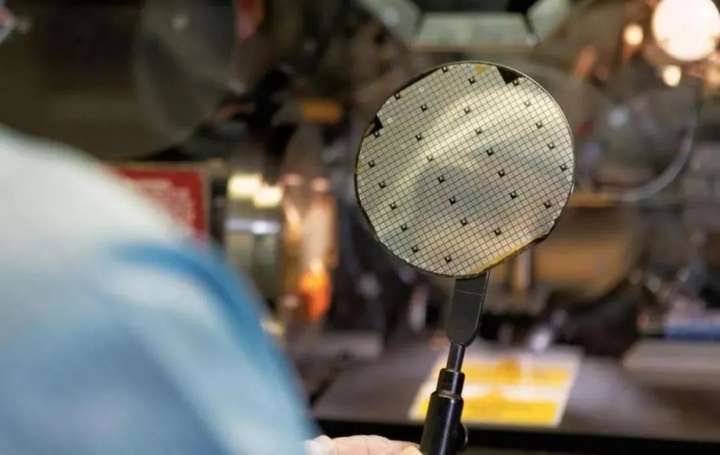
由于GaN可在6寸、甚至8寸的Si衬底上实现工艺,成本相对更低,所以目前第三代半导体的主流材料还是GaN。
2.易碎
SiC是一种天然超晶格,十分易碎,制备难度相对较大。虽然目前SiC衬底制造技术已经达到8英寸水平,但要突破更大尺寸的生产,提高生产良率,依然是个难题。
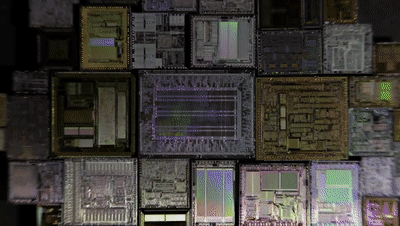
在芯片制程中,材料易碎称为“破片“, 主要由制程不稳定、材料不合格、制造用具不良等原因造成。第三代半导体材料本身的易碎性我们无从改变,唯有提高技术水平和设备的柔性化程度,才能更好地避免“破片“、提高生产良率,推动第三代半导体材料的广泛应用。
高精软着陆,提升设备柔性化程度

▲ 国奥直线旋转电机
高度集成
85mm*130mm*20mm高度集成设计,大大降低机身体积及重量,为高速稳定贴片保驾护航,生产效率大幅提升!
高精力控
+/- 3g以内力控稳定精度,力控分辨率优于0.01N,软着陆功能以较轻的力量接触,使得机器不会损坏芯片或在芯片上留下痕迹,提高产能!
微米级位置反馈
重复定位精度达+/- 2μm,径向偏摆小于10μm,编码器分辨率标准1μm,确保精密贴合、高速持续动作!


双向线性致动器和软着陆能够精准地控制力量,更轻柔地触碰材料表面,进行准确的真空取放,为半导体封测设备提供最佳ZR轴解决方案,量身定制高精度直线旋转电机。(+v:Uaua_1234)
部分图片来源网络,侵删。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。












