环球仪器专家解读:FC装配技术
李忆—环球仪器上海SMT工艺实验室工艺研究工程师
器件的小型化高密度封装形式越来越多,如多模块封装(MCM)、系统封装(SiP)、倒装芯 片(FC,Flip-Chip)等应用得越来越多。这些技术的出现更加模糊了一级封装与二级装配之间的界线。毋庸置疑,随着小型化高密度封装的出现,对高速与高精度装 配的要求变得更加关键,相关的组装设备和工艺也更具先进性与高灵活性。
由于倒装芯片比BGA或CSP具有更小的外形尺寸、更小的球径和球间距、它对植球工艺、基板技术、材料的兼容性、制造工艺,以及检查设备和方法提出了前所未有的挑战。
倒装芯片的发展历史
倒装芯片的定义
什么器件被称为倒装芯片?一般来说,这类器件具备 以下特点:
1.基材是硅;
2.电气面及焊凸在器件下表面;
3.球间距一般为4-14mil、球径为2.5-8mil、外形尺寸为1-27mm;
4.组装在基板上后需要做底部填充。
其实,倒装芯片之所以被称为“倒装”,是相对于传 统的金属线键合连接方式(Wire Bonding)与植球后的工艺 而言的。传统的通过金属线键合与基板连接的芯片电气面朝 上(图1),而倒装芯片的电气面朝下(图2),相当于将 前者翻转过来,故称其为“倒装芯片”。在圆片(Wafer) 上芯片植完球后(图3),需要将其翻转,送入贴片机,便于贴装,也由于这一翻转过程,而被称为“倒装芯片”。
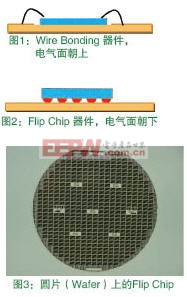
倒装芯片的历史及其应用
倒装芯片在1964年开始出现,1969年由IBM发明了倒 装芯片的C4工艺(Controlled Collapse Chip Connection, 可控坍塌芯片联接)。过去只是比较少量的特殊应用,近 几年倒装芯片已经成为高性能封装的互连方法,它的应用 得到比较广泛快速的发展。目前倒装芯片主要应用在Wi- Fi、SiP、MCM、图像传感器、微处理器、硬盘驱动器、医用传感器,以及RFID等方面(图5)。
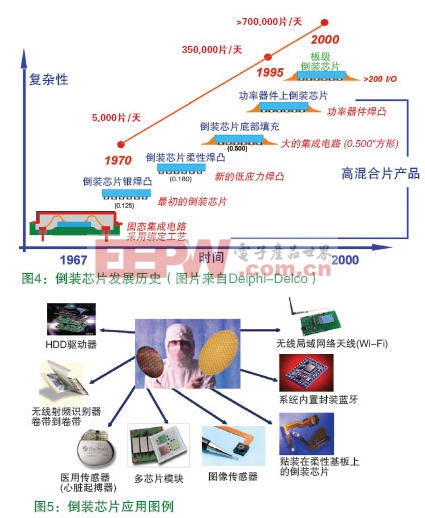
与此同时,它已经成 为小型I/O应用有效的互连解决方案。随着微型化及人们已 接受SiP,倒装芯片被视为各种针脚数量低的应用的首选方 法。从整体上看,其在低端应用和高端应用中的采用,根 据TechSearch International Inc对市场容量的预计,焊球凸点倒装芯片的年复合增长率(CAGR)将达到31%。
倒装芯片应用的直接驱动力来自于其优良的电气性能,以及市场对终端产品尺寸和成本的要求。在功率及电 信号的分配,降低信号噪音方面表现出色,同时又能满足高密度封装或装配的要求。可以预见,其应用会越来越广泛。
倒装芯片的组装工艺流程
一般的混合组装工艺流程
在半导体后端组装工厂中,现在有两种模块组装方法。在两次回流焊工艺中,先在单独的SMT生产线上组装SMT器件,该生产线由丝网印刷机、贴片机和第一个回 流焊炉组成。然后再通过第二条生产线处理部分组装的模块,该生产线由倒装芯片贴片机和回流焊炉组成。底部填 充工艺在专用底部填充生产线中完成,或与倒装芯片生产线结合完成。
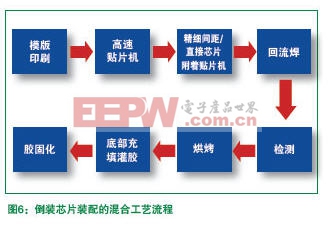
倒装芯片的装配工艺流程介绍
相对于其它的IC器件,如BGA、CSP等,倒装芯片 装配工艺有其特殊性,该工艺引入了助焊剂工艺和底部填充工艺。因为助焊剂残留物(对可靠性的影响)及桥连的 危险,将倒装芯片贴装于锡膏上不是一种可采用的装配方法。业内推出了无需清洁的助焊剂,芯片浸蘸助焊剂工艺成为广泛使用的助焊技术。目前主要的替代方法是使用免洗助焊剂,将器件浸蘸在助焊剂薄膜里让器件焊球蘸取一 定量的助焊剂,再将器件贴装在基板上,然后回流焊接;或者将助焊剂预先施加在基板上,再贴装器件与回流焊 接。助焊剂在回流之前起到固定器件的作用,回流过程中起到润湿焊接表面增强可焊性的作用。
倒装芯片焊接完成后,需要在器件底部和基板之间填充一种胶(一般为环氧树酯材料)。底部填充分为于“毛细流动原理”的流动性和非流动性(No-follow)底部填充。
上述倒装芯片组装工艺是针对C4器件(器件焊凸材料为SnPb、SnAg、SnCu或SnAgCu)而言。另外一种工艺是 利用各向异性导电胶(ACF)来装配倒装芯片。预先在基板上施加异性导电胶,贴片头用较高压力将器件贴装在基板 上,同时对器件加热,使导电胶固化。该工艺要求贴片机具有非常高的精度,同时贴片头具有大压力及加热功能。 对于非C4器件(其焊凸材料为Au或其它)的装配,趋向采用此工艺。这里,我们主要讨论C4工艺,下表列出的是倒装芯片植球(Bumping)和在基板上连接的几种方式。
倒装倒装芯片几何尺寸可以用一个“小”字来形容:焊球直径小(小到0.05mm),焊球间距小(小到0.1mm),外形尺寸小(1mm2)。要获得满意的装配良率,给贴装设备及其工艺带来了挑战,随着焊球直径的缩小,贴装精度要求越来越高,目前12μm甚至10μm的精度越来越常见。贴片设备照像机图形处理能力也十分关键,小的球径小的球间距需要更高像素的像机来处理。
随着时间推移,高性能芯片的尺寸不断增大,焊凸(Solder Bump)数量不断提高,基板变得越来越薄,为了提高产品可靠性底部填充成为必须。
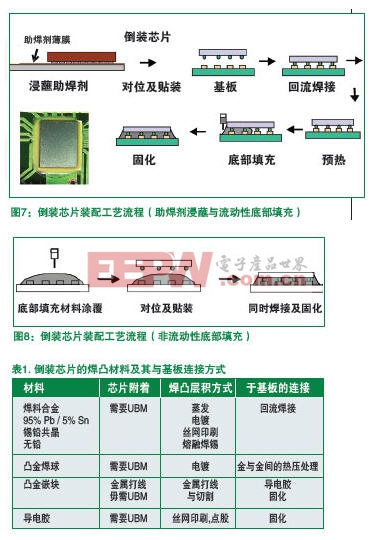
对贴装压力控制的要求
考虑到倒装芯片基材是比较脆的硅,若在取料、助焊剂浸蘸过程中施以较大的压力容易将其压裂,同时细小的焊凸在此过程中也容易压变形,所以尽量使用比较低的贴装压力,一般要求在150g左右。对于超薄形芯片,如0.3mm,有时甚至要求贴装压力控制在35g。
对贴装精度及稳定性的要求
对于球间距小到0.1mm的器件,需要怎样的贴装精度 才能达到较高的良率?基板的翘曲变形,阻焊膜窗口的尺寸和位置偏差,以及机器的精度等,都会影响到最终的贴 装精度。关于基板设计和制造的情况对于贴装的影响,我们在此不作讨论,这芯片装配工艺对贴装设备的要求里我们只是来讨论机器的贴装精度。为了回答上面的问题,我们来建立一个简单的假设模型:
1.假设倒装芯片的焊凸为球形,基板上对应的焊盘为圆形,且具有相同的直径;
2.假设无基板翘曲变形及制造缺陷方面的影响;
3.不考虑Theta和冲击的影响;
4.在回流焊接过程中,器件具有自对中性,焊球与润湿面50%的接触在焊接过程中可以被“拉正”。
那么,基于以上的假设,直径25μm的焊球如果其对应的圆形焊盘的直径为50μm时,左右位置偏差(X轴)或 前后位置偏差(Y轴)在焊盘尺寸的50%,焊球都始终在焊盘上(图9)。对于焊球直径为25μm的倒装芯片,工艺能力Cpk要达到1.33的话,要求机器的最小精度必须达到12μm@3sigma。
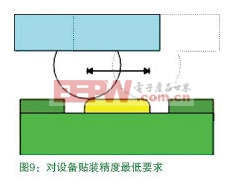
对照像机和影像处理技术的要求
要处理细小焊球间距的倒装芯片的影像,需要百万像素的数码像机。较高像素的数码像机有较高的放大倍率, 但是,像素越高视像区域(FOV)越小,这意味着大的器件可能需要多次“拍照”。照像机的光源一般为发光二极 管,分为侧光源、前光源和轴向光源,并可以单独控制。倒装芯片的的成像光源采用侧光、前光,或两者结合。
那么,对于给定器件如何选择像机呢?这主要依赖图 像的算法。譬如,区分一个焊球需要N个像素,则区分球间 距需要2N个像素。以环球仪器的贴片机上Magellan数码像机为例,其区分一个焊球需要4个像素,我们用来看不同的 焊球间隙所要求的最大的像素应该是多大,这便于我们根 据不同的器件来选择相机,假设所有的影像是实际物体尺寸的75%。

倒装芯片基准点(Fiducial)的影像处理与普通基准 点相似。倒装芯片的贴装往往除整板基准点外(Global fiducial)会使用局部基准点(Local fiducial),此时的基 准点会较小(0.15—1.0mm),像机的选择参照上面的方 法。对于光源的选择需要斟酌,一般贴片头上的相机光源 都是红光,在处理柔性电路板上的基准点时效果很差,甚至找不到基准点,其原因是基准点表面(铜)的颜色和基 板颜色非常接近,色差不明显。如果使用环球仪器的蓝色光源专利技术就很好的解决了此问题。

吸嘴的选择
由于倒装芯片基材是硅,上表面非常平整光滑,最好选择头部是硬质塑料材料具多孔的ESD吸嘴。如果选择头部 为橡胶的吸嘴,随着橡胶的老化,在贴片过程中可能会粘连器件,造成贴片偏移或带走器件。
对助焊剂应用单元的要求
助焊剂应用单元是控制助焊剂浸蘸工艺的重要部分, 其工作的基本原理就是要获得设定厚度的稳定的助焊剂薄 膜,以便于器件各焊球蘸取的助焊剂的量一致。 要精确稳定的控制助焊剂薄膜的厚度,同时满足高速浸蘸的要求,该助焊剂应用单元必须满足以下要求:
1. 可以满足多枚器件同时浸蘸助焊剂(如同时浸蘸4或7枚)提高产量;
2. 助焊剂用单元应该简单、易操作、易控制、易清洁;
3. 可以处理很广泛的助焊剂或锡膏,适合浸蘸工艺的 助焊剂粘度范围较宽,对于较稀和较粘的助焊剂都 要能处理,而且获得的膜厚要均匀;
4. 蘸取工艺可以精确控制,浸蘸的工艺参数因材料的不同而会有差异,所以浸蘸过程工艺参数必须可以单独控制,如往下的加速度、压力、停留时间、向上的加速度等。
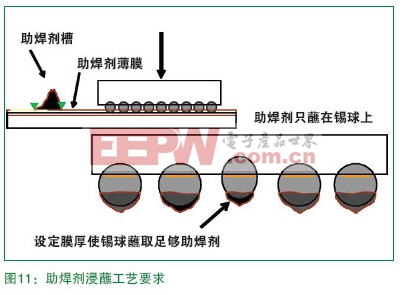
对供料器的要求
要满足批量高速高良率的生产,供料技术也相当关键。倒装芯片的包装方式主要有这么几种:2×2或4×4英 JEDEC盘、200mm或300mm圆片盘(Wafer)、还有 卷带料盘(Reel)。对应的供料器有:固定式料盘供料器 (Stationary tray feeder),自动堆叠式送料器(Automated stackable feeder),圆片供料器(Wafer feeder),以及带式供料器。
所有这些供料技术必须具有精确高速供料的能力,对于圆片供料器还要求其能处理多种器件包装方式,譬如: 器件包装可以是JEDEC盘、或裸片,甚至完成芯片在机器内完成翻转动作。
我们来举例说明几种供料器. Unovis的裸晶供料器(DDF Direct Die Feeder)特点:
可用于混合电路或感应器、 多芯片模组、系统封装、RFID和3D装配
圆片盘可以竖着进料、节省空间,一台机器可以安装多台DDF
芯片可以在DDF内完成翻转
可以安装在多种贴片平台上,如:环球仪器、西门子 、安必昂、富士
对板支撑及定位系统的要求
有些倒装芯片是应用在柔性电路板或薄型电路板上,这时候对基板的平整支撑非常关键。解决方案往往会用到 载板和真空吸附系统,以形成一个平整的支撑及精确的定位系统,满足以下要求:
1.基板Z方向的精确支撑控制,支撑高度编程调节;
2.提供客户化的板支撑界面;
3.完整的真空发生器;
4.可应用非标准及标准载板。
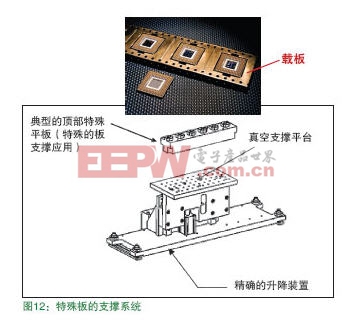
回流焊接及填料固化后的检查
对完成底部填充以后产品的检查有非破坏性检查和破坏性检查,非破坏性的检查有
利用光学显微镜进行外观检查,譬如检查填料在器件侧面爬升的情况,是否形成良好的边缘圆角,器件表面是否有脏污等
利用X射线检查仪检查焊点是否短路,开路,偏移,润湿情况,焊点内空洞等
电气测试(导通测试),可以测试电气联结是否有 问题。对于一些采用菊花链设计的测试板,通过通断测试还可以确定焊点失效的位置
利用超声波扫描显微镜(C-SAM)检查底部填充后 其中是否有空洞、分层,流动是否完整
破坏性的检查可以对焊点或底部填料进行切片,结合光学显微镜,金相显微镜或电子扫描显微镜和能谱分析仪 (SEM/EDX),检查焊点的微观结构,例如,微裂纹/微 孔,锡结晶,金属间化合物,焊接及润湿情况,底部填充 是否有空洞、裂纹、分层、流动是否完整等。
完成回流焊接及底部填充工艺后的产品常见缺陷有: 焊点桥连/开路、焊点润湿不良、焊点空洞/气泡、焊点开 裂/脆裂、底部填料和芯片分层和芯片破裂等。对于底部填充是否完整,填料内是否出现空洞,裂纹和分层现象,需 要超声波扫描显微镜(C-SAM)或通过与芯片底面平行的 切片(Flat section)结合显微镜才能观察到,这给检查此 类缺陷增加了难度。
底部填充材料和芯片之间的分层往往发生在应力最大 器件的四个角落处或填料与焊点的界面,如左图13 所示。
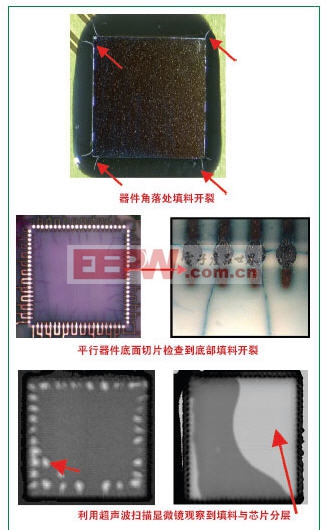
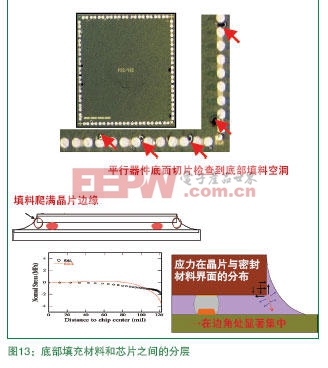
总结
倒装芯片在产品成本,性能及满足高密度封装等方面 体现出优势,它的应用也渐渐成为主流。由于倒装芯片的 尺寸小,要保证高精度高产量高重复性,这给我们传统的 设备及工艺带来了挑战,具体表现在以下几个方面:
1. 基板(硬板或软板)的设计方面;
2.组装及检查设备方面;
3.制造工艺,芯片的植球工艺,PCB的制造工艺,SMT工艺;
4.材料的兼容性。
全面了解以上问题是成功进行倒装芯片组装工艺的基础。
环球仪器SMT实验室自1994年已成功开发此完整工 艺,迄今我们使用了约75种助焊剂和150种底部填充材料在 大量不同的基板上贴装了100,000个倒装片,进行测试和细致的失效分析,涵盖了广泛的参数范围。
环球仪器对于倒装芯片装配的设备解决方案,兼顾了高速和高精度的特点,譬如:DDF送料器结合GI-14平台可 以实现裸芯片进料高速贴装,而AdVantis XS 平台可以实现精度达9微米3西格码的贴装(下图)。可以应用这些解决方案实现倒装芯片,系统封装(高混合装配),裸芯片装配及内植器件。
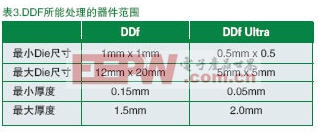
如果读者对完整的倒装芯片装配工艺感兴趣或有疑问,欢迎与本文作者联系:liyi@uic.com。






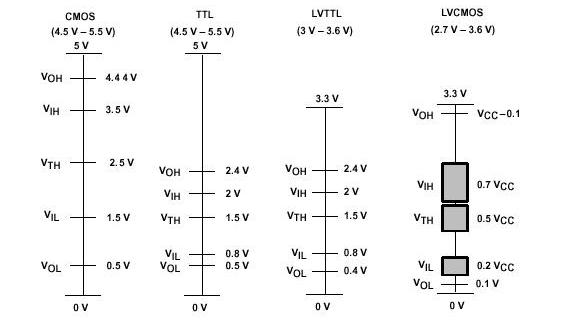

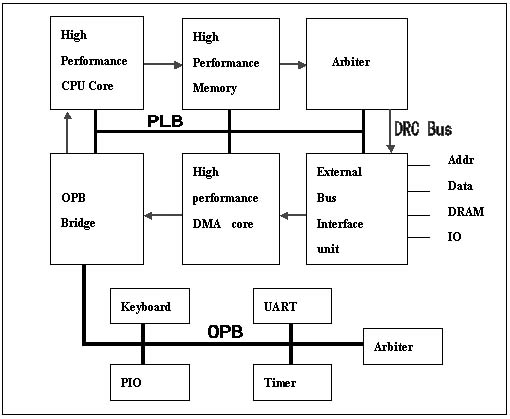


评论