共晶材料的选择及焊接温度的控制 高亮度LED封装工艺及方案
随着手机闪光灯、大中尺寸(NB、LCD-TV等) LED显示屏光源模块以至特殊用途照明系统之应用逐渐增多。末来再扩展至用于一般照明系统设备,采用白光LED技术之大功率(High Power)LED市场将陆续显现。在技术方面,现时遇到最大挑战是提升及保持亮度,若再增强其散热能力,市场之发展深具潜力。
近年来,随着LED生产技术发展一日千里,令其发光亮度提高和寿命延长,加上生产成本大幅降低,迅速扩大了LED应用市场,如消费产品、讯号系统及一般照明等,于是其全球市场规模快速成长。2003年全球LED市场约44.8亿美元 (高亮度LED市场约27亿美元),较2002年成长17.3% (高亮度LED市场成长47%),乘着手机市场继续增长之势,预测2004年仍有14.0%的成长幅度可期。
芯片设计
从芯片的演变历程中发现,各大LED生产商在上游磊晶技术上不断改进,如利用不同的电极设计控制电流密度,利用ITO薄膜技术令通过LED的电流能平均分布等,使LED芯片在结构上都尽可能产生最多的光子。再运用各种不同方法去抽出LED发出的每一粒光子,如生产不同外形的芯片;利用芯片周边有效地控制光折射度提高LED取光效率,研制扩大单一芯片表面尺寸(>2mm2)增加发光面积,更有利用粗糙的表面增加光线的透出等等。有一些高亮度LED芯片上p-n两个电极的位置相距拉近,令芯片发光效率及散热能力提高。而最近已有大功率LED的生产,就是利用新改良的激光溶解(Laser lift-off)及金属黏合技术(metal bonding),将LED磊晶晶圆从GaAs或GaN长晶基板移走,并黏合到另一金属基板上或其它具有高反射性及高热传导性的物质上面,帮助大功率LED提高取光效率及散热能力。
封装设计
经过多年的发展,垂直LED灯(φ3mm、φ5mm)和SMD灯(表面贴装LED)已演变成一种标准产品模式。但随着芯片的发展及需要,开拓出切合大功率的封装产品设计,为了利用自动化组装技术降低制造成本,大功率的SMD灯亦应运而生。而且,在可携式消费产品市场急速的带动下,大功率LED封装体积设计也越小越薄以提供更阔的产品设计空间。
为了保持成品在封装后的光亮度,新改良的大功率SMD器件内加有杯形反射面,有助把全部的光线能一致地反射出封装外以增加输出流明。而盖住LED上圆形的光学透镜,用料上更改用以Silicone封胶,代替以往在环氧树脂(Epoxy),使封装能保持一定的耐用性。
封装工艺及方案
半导体封装之主要目的是为了确保半导体芯片和下层电路间之正确电气和机械性的互相接续,及保护芯片不让其受到机械、热、潮湿及其它种种的外来冲击。选择封装方法、材料和运用机台时,须考虑到LED磊晶的外形、电气/机械特性和固晶精度等因素。因LED有其光学特性,封装时也须考虑和确保其在光学特性上能够满足。
无论是垂直LED或SMD封装,都必须选择一部高精度的固晶机,因LED晶粒放入封装的位置精准与否是直接影响整件封装器件发光效能。若晶粒在反射杯内的位置有所偏差,光线未能完全反射出来,影响成品的光亮度。但若一部固晶机拥有先进的预先图像辨识系统(PR System),尽管品质参差的引线框架,仍能精准地焊接于反射杯内预定之位置上。
一般低功率LED器件(如指示设备和手机键盘的照明)主要是以银浆固晶,但由于银浆本身不能抵受高温,在提升亮度的同时,发热现象也会产生,因而影响产品。要获得高品质高功率的LED,新的固晶工艺随之而发展出来,其中一种就是利用共晶焊接技术,先将晶粒焊接于一散热基板(soubmount)或热沉(heat sink)上,然后把整件晶粒连散热基板再焊接于封装器件上,这样就可增强器件散热能力,令发光功率相对地增加。至于基板材料方面,硅(Silicon)、铜(Copper)及陶瓷(Ceramic)等都是一般常用的散热基板物料。
共晶焊接
技术最关键是共晶材料的选择及焊接温度的控制。新一代的InGaN高亮度LED,如采用共晶焊接,晶粒底部可以采用纯锡(Sn)或金锡(Au-Sn)合金作接触面镀层,晶粒可焊接于镀有金或银的基板上。当基板被加热至适合的共晶温度时,金或银元素渗透到金锡合金层,合金层成份的改变提高溶点,令共晶层固化并将LED紧固的焊于热沉或基板上。选择共晶温度视乎晶粒、基板及器件材料耐热程度及往后SMT回焊制程时的温度要求。考虑共晶固晶机台时,除高位置精度外,另一重要条件就是有灵活而且稳定的温度控制,加有氮气或混合气体装置,有助于在共晶过程中作防氧化保护。当然和银浆固晶一样,要达至高精度的固晶,有赖于严谨的机械设计及高精度的马达运动,才能令焊头运动和焊力控制恰到好处之余,亦无损高产能及高良品率的要求。
进行共晶焊接工艺时亦可加入助焊剂,这技术最大的特点是无须额外附加焊力,故此不会因固晶焊力过大而令过多的共晶合金溢出,减低LED产生短路的机会。
覆晶(Flip Chip)焊接
覆晶焊接近年被积极地运用于大功率LED制程中,覆晶方法把GaN LED晶粒倒接合于散热基板上,因没有了金线焊垫阻碍,对提高亮度有一定的帮助。因为电流流通的距离缩短,电阻减低,所以热的产生也相对降低。同时这样的接合亦能有效地将热转至下一层的散热基板再转到器件外面去。当此工艺被应用在SMD LED,不但提高光输出,更可以使产品整体面积缩小,扩大产品的应用市场。
在覆晶LED技术发展上有两个主要的方案:一是铅锡球焊(Solder bump reflow)技术;另一个是热超声(Thermosonic)焊接技术。铅锡球焊接已在IC封装应用多时,工艺技术亦已成熟,故在此不再详述。针对低成本及低线数器件的生产,热超声覆晶(Thermosonic flip chip)技术尤其适用于大功率LED焊接。以金做焊接的接口,由于金此物本身熔点温度较铅锡球和银浆高,对固晶后的制程设计方面更有弹性。此外,还有无铅制程、工序简单、金属接位可靠等优点。热超声覆晶工艺经过多年的研究及经验累积,已掌握最优化的制程参数,而且在几大LED生产商已成功地投入量产。足生产线使用外,其余大量的(如芯片粘片机、引线焊接机、测试机、编带机)等自动化设备还全都依赖进口。





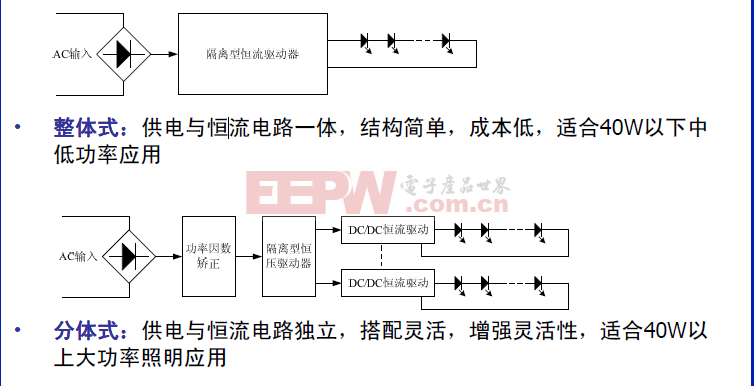






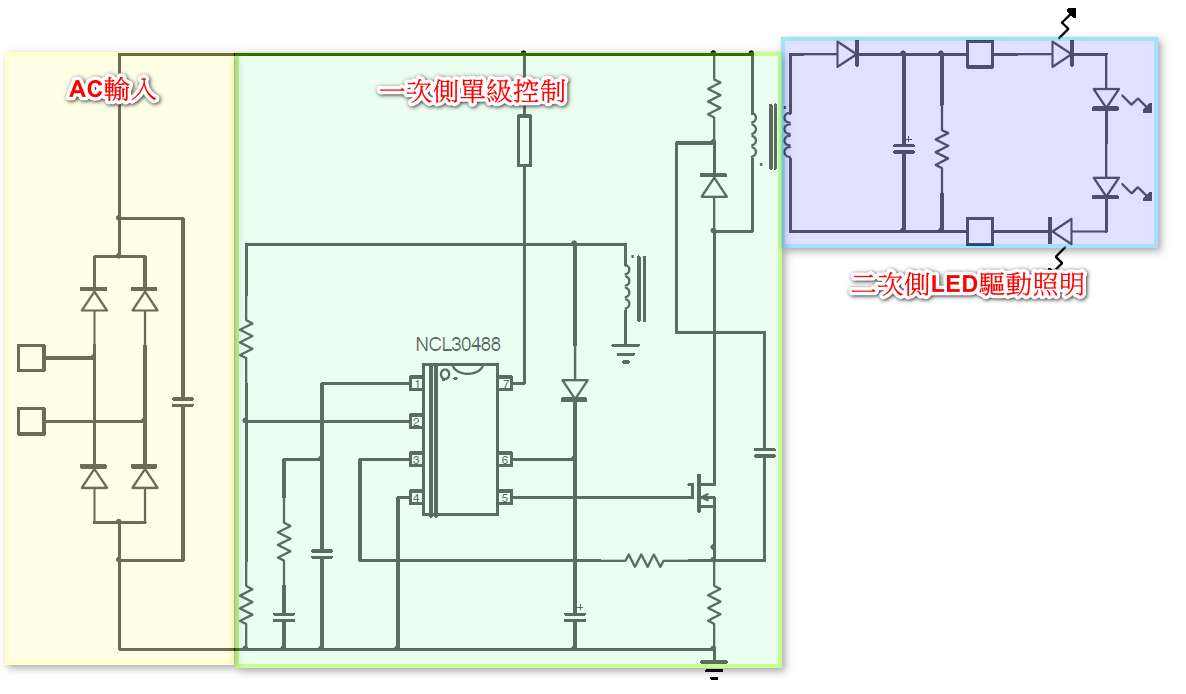




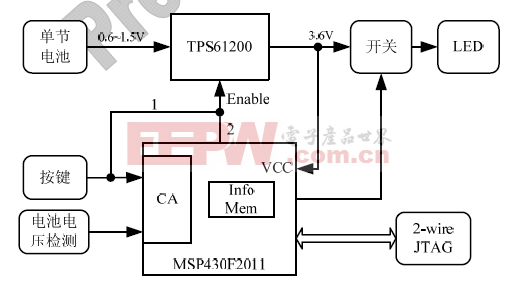
评论