详解LED封装技术之陶瓷COB技术
LED封装方式是以芯片(Die)借由打线、共晶或覆晶的封装技术与其散热基板Submount(次黏着技术)连结而成LED芯片,再将芯片固定于系统板上连结成灯源模组。

目前,LED封装方法大致可区分为透镜式(Lens-type)以及反射杯式(Reflector-type),其中透镜的成型可以是模塑成型(Molding)或透镜黏合成型;而反射杯式芯片则多由混胶、点胶、封装成型;近年来磊晶、固晶及封装设计逐渐成熟,LED的芯片尺寸与结构逐年微小化,高功率单颗芯片功率达1~3W,甚至是3W以上,当LED功率不断提升,对于LED芯片载版及系统电路版的散热及耐热要求,便日益严苛。
鉴于绝缘、耐压、散热与耐热等综合考量,陶瓷基板成为以芯片次黏着技术的重要材料之一。其技术可分为厚膜工艺(Thick film)、低温共烧工艺(LTCC)与薄膜工艺(DPC)等方式制成。然而,厚膜工艺与低温共烧工艺,是利用网印技术与高温工艺烧结,易产生线路粗糙、对位不精准、与收缩比例问题,若针对线路越来越精细的高功率LED产品,或是要求对位准确的共晶或覆晶工艺生产的LED产品而言,厚膜与低温共烧的陶瓷基板,己逐渐不敷使用。
为此,高散热系数薄膜陶瓷散热基板,运用溅镀、电/化学沉积,以及黄光微影工艺而成,具备金属线路精准、材料系统稳定等特性,适用于高功率、小尺寸、高亮度的LED的发展趋势,更是解决了共晶/覆晶封装工艺对陶瓷基板金属线路解析度与精确度的严苛要求。当LED芯片以陶瓷作为载板时,此LED模组的散热瓶颈则转至系统电路板,其将热能由LED芯片传至散热鰭片及大气中,随着LED芯片功能的逐渐提升,材料亦逐渐由FR4转变至金属芯印刷电路基板(MCPCB),但随着高功率LED的需求进展,MCPCB材质的散热系数(2~4W/mk)无法用于更高功率的产品,为此,陶瓷电路板(Ceramic circuit board)的需求便逐渐普及,为确保LED产品在高功率运作下的材料稳定性与光衰稳定性,以陶瓷作为散热及金属佈线基板的趋势已日渐明朗。陶瓷材料目前成本高于MCPCB,因此,如何利用陶瓷高散热系数特性下,节省材料使用面积以降低生产成本,成为陶瓷LED发展的重要指标之一。因此,近年来,以陶瓷材料COB设计整合多晶封装与系统线路亦逐渐受到各封装与系统厂商的重视。COB,在电子制造业里并不是一项新鲜的技术,是指直接将裸外延片黏贴在电路板上,并将导线/焊线直接焊接在PCB的镀金线路上,也是俗称中的打线(Wire bonding),再透过封胶的技术,有效的将IC制造过程中的封装步骤转移到电路板上直接组装。在LED产业中,由于现代科技产品越来越讲究轻薄与高可携性,此外,为了节省多颗LED芯片设计的系统板空间问题,在高功率LED系统需求中,便开发出直接将芯片黏贴于系统板的COB技术。
COB的优点在于:高成本效益、线路设计简单、节省系统板空间等,但亦存在着芯片整合亮度、色温调和与系统整合的技术门槛。以25W的LED为例,传统高功率25W的LED光源,须采用25颗1W的LED芯片封装成25颗LED元件,而COB封装是将25颗1W的LED芯片封装在单一芯片中,因此需要的二次光学透镜将从25片缩减为1片,有助于缩小光源面积、缩减材料、系统成本,进而可简化光源系二次光学设计并节省组装人力成本。此外,高功率COB封装仅需单颗高功率LED即可取代多颗1瓦(含)以上LED封装,促使产品体积更加轻薄短小。
目前市面上,生产COB产品仍以使用MCPCB基板为主,然而MCPCB仍有许多散热以及光源面积过大的问题须解决,故其根本之道,还是从散热材料更新为最有效的解决方案。陶瓷COB基板有以下几点好处:1.薄膜工艺,让基本上的线路更加精确、(2)量大降低成本、(3)可塑性高,可依不同需求做设计。
现MCPCB基板COB芯片制作的LED灯泡均无法调光,而ledaladdin公司用陶瓷COB芯片组装的LED可调光灯泡已上市,有5W、6W、7W,性能更好,色温可做到2200K---8000K,流明达60LM/W以上。
陶瓷MCOB/COB的发展,是简化系统板的一种趋势,照明灯具的实用化、亮度、散热以及成本的控管,都是重要的关键因素。




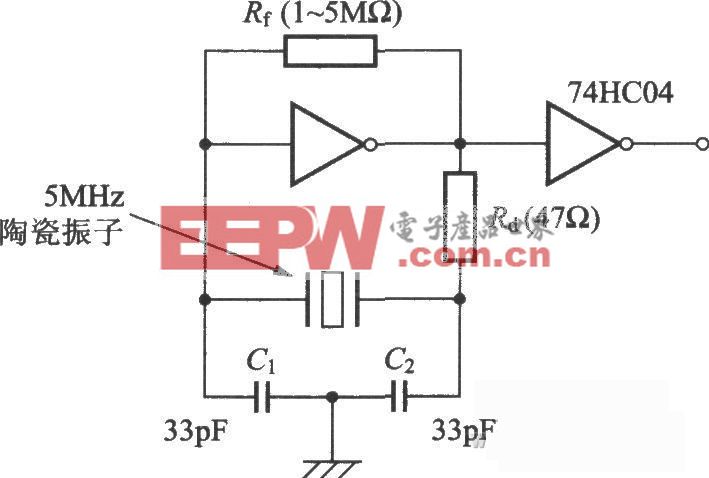





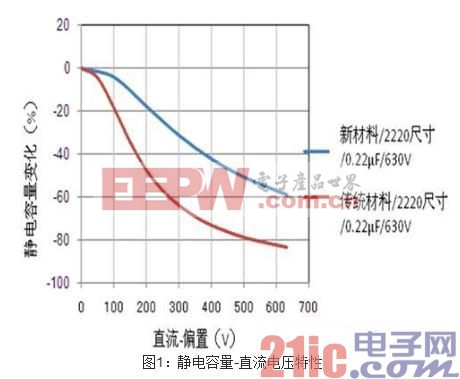
评论