彻底攻克汽车半导体设计散热难题(二)
对于汽车半导体而言,单一装置的散热效能及设计通常是建立模型的重点,必须审慎简化,才能取得建立模型资料。去除模型中多余的低功率装置、简化PCB铜线佈线、假设基座对在固定温度散热,加速完成散热模型,才能準确呈现热阻抗网路。
封装层级散热模型建立能在不需要高成本的开发和测试状况下,进一步检视可能的封装设计变更,进而免除材料建置。因为半导体封装设计可以改变,依据应用需求达到最的散热效果。在汽车半导体元件中,PowerPAD等外露焊垫封装可使晶粒快速散热到PCB。加大的晶粒座、改良的PCB连接或基座设计等封装都是为了达到更有效的散热效能。散热模型建立也用于检查装置中材料变换所造成的潜在影响。封装材料的导热性有极大的差异,从0.4W/mK(热绝缘体)到300W/mK(热良导体)不等。建立散热模型有助于兼顾产品成本与效能平衡。
建立模型验证
对于重要的系统而言,审慎的实验数据分析可决定散热效能及运作温度,但实验测量这些系统相当费时且耗成本。散热模型能够确实符合系统的散热及运作要求,在半导体产业中,散热模型已经成为概念测试及硅晶设计过程的前置作业,理想的散热模型建立流程会在晶片生产前几个月进行。积体电路设计人员和散热工程人员负责先检查装置的晶片配置及电源耗损,然后散热模型工程人员依据检查结果,建立散热模型,一旦散热模型结果备齐,设计人员及建立模型工程人员将检查数据并调整模型,以準确反映可能的应用情形。
汽车半导体产业多年来使用散热模型提升产品设计,由其是有限元素分析(finite element analysis; FEA)验证的模型。TI的塬则是先比较散热建立模型结果与系统的实体测量,以进行相关分析。这些相关分析着重于潜在误差,包括材质、电源定义及尺寸简化。没有任何模型能够完全呈现实际的系统,因此必须注意建立模型期间所做的假设,以确实呈现最準确的系统。
对于材质而言,发佈的数据通常呈现特定材料的容积传导率,不过应用材料表面的反应会影响散热效能。必须注意模型中呈现的功率,因为运作期间施加于装置的功率会随着时间而变化。电路板或系统其他区域的电源耗损可能也会影响晶片表面的实际功率。
建立模型类型
针对特定专案的散热状况,汽车半导体的散热模型主要分为四种,可用以了解和验证散热效能:系统等级、封装等级、晶粒等级和晶粒暂态分析。
系统层级散热建立模型相当重要,因为模型可呈现特定装置在某些系统中运作的效能。基本上,汽车半导体散热建立模型将PCB纳入考量,因为PCB是大多数半导体封装的主要散热器。PCB的铜层和散热孔结构都必须包含在散热模型中,才能準确判断散热行为。如果系统使用嵌入式散热器之类的元件,及螺丝或铆钉作金属连接,都必须纳入模型中,以判断对于装置的散热效能所产生的影响。
强制对流(forced airflow)及PCB周围的空气流通对于系统导热也相当重要。半导体的散热模型通常是针对单一高功率装置,但PCB的其他电源元件对于系统的整体效能也相当重要。若要简化这些封装的输入,并维持準确度,通常可使用精简模型。精简模型是简化的热阻抗网路,合理估算PCB上的较不重要的装置所达到的散热效能。
在低接脚数的小型装置中(见图2),可使用其他方法提升散热效能。将多个封装接脚接在装置的基座之后,即可大幅改善整体的接点温度,而不影响装置的运作。
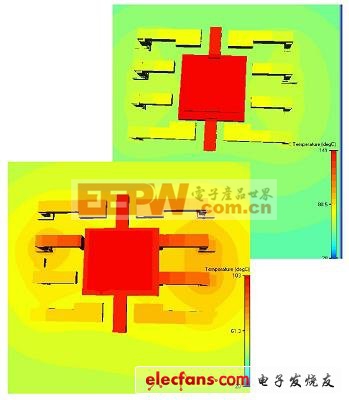
图2:对于 8 接脚 SOIC 封装,将多个接脚接在基座之后,接点温度最低可达 25°C。
建立模型假设
晶粒分析首先需要準确呈现硅晶配置,包括晶粒上任何用电的区域。简单来说,可以假设电源平均分配到晶片的各个区域,不过,对于大多数的晶片配置而言,皆会因为功能而出现供电不平均的情况,这种现象对于装置的整体散热效能至关重要。针对重视散热功能的装置而言,必须特别注意晶片的用电结构。
在某些散热软体程式中,可使用逗号分隔变数(.csv)来输入晶片配置,如图3所示。如此即可在晶粒配置与散热模型软体之间轻鬆传输资讯。视装置的复杂度及用电量而定,这些用电区域可能有两到叁处,甚至数百处。散热模型工程人员应该与IC设计人员密切合作,找出哪些用电区域应该纳入散热模型。考量装置的整体用电时,通常可以将用电量较小的小区域合併为大区域,以简化散热模型。在散热模型中,也可以在晶粒表面使用背景功耗或静态功耗,以考量大部份的非重要低功耗晶粒结构。
装置功能通常需要比晶粒上的小区域更高的电源。这些高用电区域会导致该区域过热,温度明显比周围高。相邻的中度用电晶粒可能造成受测的晶粒出现残余热度及热应力,散热模组也可显现这些散热问题。
模型也可用于协助放置或调整嵌入式温度感测器的位置。温度感测器适合放在最高用电量的区域,不过由于配置限制,这通常不可能达成。如果不放在用电区域的中央,温度感测器无法读取装置的实际最高温度。散热模型可用于判断晶粒上的热梯度,包括在感测器的位置。感测器可加以调整,以因应最高温区域与感测器区域之间的温差。
假设前文提及的模型类型全部以稳定的DC电源输入,在实际运作中,装置电源会随着时间和配置而变动。如果设计散热系统解决最不理想的用电情况,散热负载将变得相当严重。有许多方法可用来观察暂态散热反应,最简单的方法是假设晶片上的直流电源,然后追踪装置随时间变化所呈现的散热反应。第二种方法是输入不同的电源,然后使用散热软体判断最终的稳定状态温度。第叁种最为实用的暂态模型建立方法是观察晶片的不同位置上,电源随时间所产生的变化,如图4所示。使用这种方法,可以了解装置之间在正常运作下无法呈现的互动过程。暂态模型也有助于观察正常装置运作之外,某个晶片运作的全部过程,例如装置的通电或断电模式。

图3:散热模型软体使用逗号分隔变数输入产生详细的晶粒配置,并显示晶粒表面的潜在热点位置。

图4:半导体装置表面上的散热反应随着时间而变化。在此情况下,晶粒的不同区域是以交错的方式获得电源。散热模型可供更密切观察随时间变化的晶粒温度。
在煞车制动或安全气囊配置等许多汽车系统中,装置用电量在装置使用寿命期间都相当低。对于安全气囊系统,电源脉衝会短时间升高。
改善之道
对于汽车半导体产业,散热建立模型的目的是设计优化及降低整体温度。只要降低运作晶片接点温度,即可提升装置的可靠性。系统、电路板、封装或晶粒的小幅度改善能够大幅改善最终的温度。但装置及系统限制可能会使得其中一些选项无法适用,本文仍列举系统降温的几个最佳实务做法。
有许多方法可改善系统或PCB的散热效能,包括空气流通、导热途径或外部散热器。提供更多金属区域进行散热能够改善散热效能,这包括外部散热器、基座的金属连接、印刷电路板的更多分层或更密集的铜层、基于散热用途而连接的铜层及散热通孔。
位于装置的外露焊垫下方的散热通孔将装置内部的热度散出,使得电路板的其他部份加速散热。半导体装置封装的设计能够使晶粒快速对外散热。半导体封装的散热改善包括传导性更高的材料、PowerPAD等直接附加于PCB的做法、接在晶粒座的接脚或外部散热器的黏接位置。半导体晶粒本身有许多方法可降低整体温度,降低温度的最佳方法就是减少用电量。
对于半导体电路设计及配置,良好的散热做法包括扩大散热区域、找出晶片边缘外的用电区域、使用狭长形用电区域而非方形区域,及使高用电量区域之间有充足的间隔距离。硅本身是热良导体,导热性约为117W/mK。只要用电区域周围有最多的硅,即可改善装置的散热效果。对于晶粒上的暂态电源,只要将电源脉衝交错而降低瞬间功耗,使电源脉衝的间隔时间加长,让热度能够散出,或者将高用电量元件分配在




评论