IGBT模块中不同金属化方法覆铜氮化铝陶瓷基板的可靠性研究
0 引言
在电力电子的应用中,大功率电力电子器件IGBT是实现能源控制与转换的核心,广泛应用于高速铁路、智能电网、电动汽车与新能源装备等领域[1-2]。随着能量密度提高,功率器件对陶瓷覆铜基板的散热能力和可靠性的要求越来越高。目前的陶瓷基板材料主要有:Al2O3、ALN、Si3N4、BeO、SiC 等[3-4]。其中Al2O3 陶瓷开发最早,技术最为成熟,成本最低,应用最广泛,但Al2O3陶瓷的热导率仅为17 ~ 25 W/(m·K),且与Si 及GaAs 等半导体材料的热膨胀系数匹配性较差,限制了其在高频、大功率、高集成电路中的使用。SiC 陶瓷基板的热导率高,热膨胀系数与Si 最为相近,但其介电性能(εr = 42)较差,烧结损耗大、难以致密,成本高,限制了其大批量应用。Si3N4 虽然强度、韧性高、可靠性高,以其等优异的综合热力学性能成为较有前途的大功率候选材料之一,但多晶Si3N4 陶瓷在室温下的热导率均较低,且关键技术都掌握在日本,限制了在国内Si3N4基板在IGBT 组件中的应用。BeO的热导率虽与AlN相当,但热膨胀系数过高,且BeO 粉体有毒性,吸入人体后会导致慢性铍肺病,世界上大多数国家早已停止使用BeO。相比而言,AlN 陶瓷基板具有高的导热性(理论值319 W/(m·K)) 与Si 等半导体材料较匹配的热导率、宽的操作温度(工作温度范围和耐高温方面)和优良的绝缘性能,在大功率电力半导体模块、智能功率组件、汽车电子、高密度封装载板和发光二极管(LED)等方面有很好的发展前景,是先进集成电路陶瓷基板最重要的材料之一。
AlN基板金属化技术主要有厚膜法(TFC)、薄膜法(DPC)、直接覆铜法(DBC)及活性金属钎焊法(AMB)等方法。本文着重开展以上4 种金属化方法制备覆铜AlN 基板的可靠性研究,为相应功率器件在我国高速铁路、智能电网、电动汽车等领域的广泛应用积累基础实验数据。
1 试验方法
使用厚度1 mm 的AlN 陶瓷基板( 福建华清电子材料科技有限公司), 无氧高导电铜箔(OFHC,0.05 mm,中国国药化学试剂有限公司),五水硫酸铜(CuSO4·5H2O,中国国药化学试剂有限公司),盐酸(HCl,中国国药化学试剂有限公司),硫酸(H2SO4,中国国药化学试剂有限公司),Cu-P 阳极板(P 含量0.05%,深圳市斗光电子科技公司),AgCuTi 活性金属焊膏(Ti含量4.5%,长沙天九金属材料有限公司),烧结Cu浆(惠州市腾辉科技有限公司)。将AlN 陶瓷和铜箔切割为尺寸10 mm×10 mm 的正方形块状,并使用1 000 目砂纸打磨表面,然后在蒸馏水浴中超声清洗20 min 备用。
DPC 金属化:采用磁控溅射先在AlN 陶瓷表面制备厚约1 μm 的Ti 打底层,再制备一层厚约3 μm 的Cu种子层。最后将该陶瓷基板置于电镀液(CuSO4·5HO 200 g/L,H2SO4 50 g/L,Cl- 60 μg/L)中电镀,使Cu 层增厚至约50 μm,完成金属化。
TFC 金属化:将铜浆料通过丝网印刷涂布在AlN陶瓷基板上,膜厚50 μm,850 ℃ 真空烧结,得到TFC覆铜AlN 基板。
DBC 金属化:将AlN 基板与Cu 箔对齐装配后施加一定压力,控制炉内氧分压,加热至1 065 ℃,使得Cu箔表面的氧化物薄层与AlN 基板表面氧化产生的Al2O3反应生成CuAlO2 化合物,并产生冶金结合。
AMB 金属化: 在AlN 表面涂布一层AgCuTi 焊膏,并覆上Cu 箔,之后将样件置于真空环境中加热至890 ℃ 并保温一段时间,即可得到覆铜AlN 基板。
2 分析测试
使用岛津拉力机分别测试四种金属化方法制备的覆铜AlN 陶瓷基板的剥离强度,使用冷热冲击试验箱测试覆铜基板可靠性,最后对基板进行功率循环测试和热阻测试。
3 结果与讨论
3.1 不同金属化方法制备AlN覆铜基板的剥离强度
AlN 陶瓷金属化铜层与基板的结合力大小决定了其在实际应用过程中的可靠与否,是陶瓷金属化基板的核心性能指标。本文借鉴《微电子技术用贵金属浆料测试方法 附着力测定》[9]中的方法,通过剥离强度测试金属化层的附着力。图1 是DPC 金属化基板、TFC 金属化基板、DBC 金属化基板和AMB 金属化基板Cu 层的剥离强度。

图1 不同金属化方法制备覆铜陶瓷基板的剥离强度
从图1 可知,AMB 金属化陶瓷基板陶瓷与金属化层结合力最好,剥离强度为25 Mpa,接下来是DBC和TFC 金属化陶瓷基板,剥离强度分别为21 Mpa 和15 Mpa,最差的是DPC 金属化基板,剥离强度仅为13 Mpa。
对于AMB 基板,由于中间有1 层活性钎料,其中的Ti 元素对附着力起到关键因素,Ti 元素与AlN 基板反应生成TiN,可以提升金属层的附着力。对于DBC基板,在覆铜过程中Cu 箔与微量氧气生成Cu2O,而Cu2O 可以与金属Cu 形成共晶组织。AlN 基板在覆Cu 箔之前通常需要对其进行预氧化处理,形成几个μm 厚度的Al2O3 层,Cu2O 与Al2O3 可以在高温下生成CuAlO2 化合物,因此AlN 基板与覆Cu 层具有很好的界面结合[5]。TFC 基板的附着力主要由浆料内部的玻璃成分决定,高温烧结过程中玻璃软化并与陶瓷基板润湿产生结合,此外软化的玻璃还可以锚接铜粉烧结形成的金属化层,从而使金属化层与陶瓷基板牢固结合。对于DPC 陶瓷基板,电镀Cu 层与AlN 基板之间仅有一层Ti薄膜层,该薄膜与陶瓷基板仅有物理结合,因此金属层结合力最低。
3.2 4种AlN基板可靠性测试(冷热冲击)
对4 种AlN 覆铜基板循环进行冷热冲击热循环实验,条件为在-55 ℃ ~ 150 ℃,每个温度保温30 min,5 s 内完成到155 ℃ 温度转换,循环次数为100、500、1 000、1 500 cycles。
表1 不同金属化方法制备覆铜陶瓷基板的冲击实验结果
| 制备工艺 | -55 ℃~150 ℃冷热冲击循环次数 |
| DPC | 200 |
| TFC | 500 |
| DBC | 1 000 |
| AMB | 1 500 |
从表1 可知,AMB 法制备的AlN 覆铜板耐热冲击次数明显高于其他制备工艺。AlN 覆铜板耐热冲击主要的失效模式为金属层剥离和AlN 陶瓷基板开裂。
对于DPC 基板,在200 次冷热循环后,金属层与AlN 完全剥离,剥离强度为0。AlN 厚膜覆铜板,在500 次冷热循环后,金属层有局部剥离,剥离强度降为20%。DBC 基板在1 000 次冷热循环后,剥离强度降低了20%,但去除金属层,通过超声波扫描显微镜探测,与铜结合边缘处AlN 基板有微裂纹,这是由于金属Cu和AlN 的热膨胀系数差别大,两者在高温急速降温过程中,材料内部存在大量的热应力,而导致开裂。AMB基板在1 500 次冷热循环后,金属层剥离力无下降现象,陶瓷表面无微裂纹。由于金属层与AlN 陶瓷之间有刚度较低的活性钎料过渡层,可以避免大量的热应力形成而造成的AlN 陶瓷基板微裂纹产生[6]。
表2 AlN与Cu热膨胀系数对比
| 材质 | α/K-1 @ 20 ℃ |
| AlN | 4.7×10-6 |
| Cu | 18.6×10-6 |
3.3 4种AlN基板功率循环耐测试
为了更好地评估AlN覆铜板耐久性和寿命,将4 种AlN覆铜板以常规工艺封装成IGBT 模块,用硅胶进行密封保护,恒定功率为1 200 A/3.3 kV、0~85 000 次循环测试,验证4 种AlN 覆铜板IGBT 模块的功率循环可靠性。器件的起始温度T0 设置为45 ℃,Tc 为循环后的温度,相对热阻Rr 由下式计算[7]:
![]()

图2 功率循环试验曲线
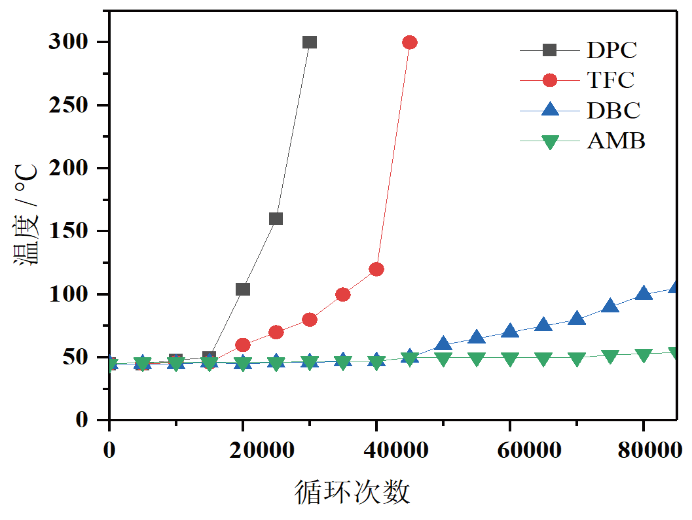
图3 不同金属化方法制备覆铜陶瓷基板IGBT模块功率循环后的热阻
从图3 可知,AMB 陶瓷基板IGBT 模块在7 万次功率循环后,模块温度为50 ℃,相对热阻<15%,满足电力电子器件特别是高压、大电流IGBT 模块可靠性要求(相对热阻<15%)。DBC 陶瓷基板IGBT 模块在4 万次循环前,相对热阻保持在15% 以内,超过4 万次,模块温度逐渐增高,相对热阻(> 15%)超出了可靠性要求。DPC 陶瓷基板在1 万次相对热阻为22%,器件受到破坏,在3 万次循环后器件完全失效。TFC 陶瓷基板在2 万次循环后相对热阻为33%,器件受到破坏,4.5 万次循环后器件完全失效。
4 结束语
本文对比了4 种AlN 基板的剥离强度、热循环可靠性、模块功率循环可靠性。从对比可知,AlN-AMB 覆铜板可靠性最好,剥离强度25 MPa,-40~150 ℃ 热循环达到1 500 次,能耐1200 A/3.3 kV 功率循环测试,满足高压、大电流、高频IGBT 模块封装对覆铜板的可靠性要求。采用氮化铝基板进行功率负载的制备可有效提高器件的耐功率能力。
参考文献:
[1] 齐维靖.大功率LED氮化铝陶瓷散热基板的制备[D].南昌:南昌大学,2012.
[2] 严光能,邓先友,林金堵.高导热氮化铝基板在航空工业的应用研究[J].印制电路信息,2017(11):43-47.
[3] 陈科成.功率电子器件封装用氮化铝陶瓷基板覆铜的研究[D].杭州:中国计量大学,2019.
[4] 温晖.大功率IGBT模块系统级封装设计与实现[D].成都:电子科技大学, 2021.
[5] 张振文,崔嵩,詹俊,许海仙.大功率IGBT模块用氮化铝DBC基板技术研究[J].真空电子技术,2017(5):33-38.
[6] 钱建波,黄世东.IGBT用氮化铝覆铜衬板可靠性研究[J].大功率变流技术,2017(5):55-69.
[7] 张薷方. 基于有限元法的IGBT模块封装散热性能及热应力的仿真研究[D].重庆:重庆大学,2015.
[8] GB/T 17473.4—2008微电子技术用贵金属浆料测试方法附着力测定[S].
(本文来源于《电子产品世界》杂志2022年12月期)




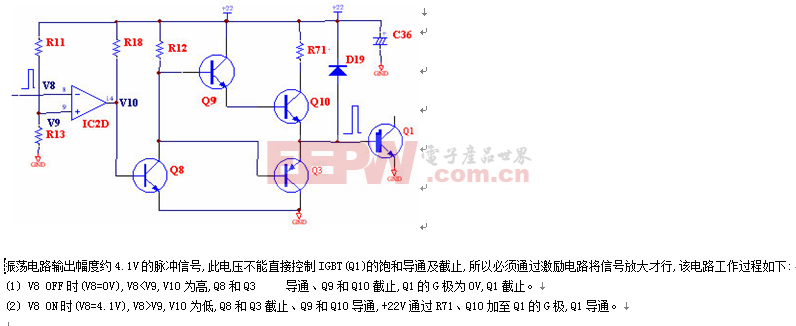


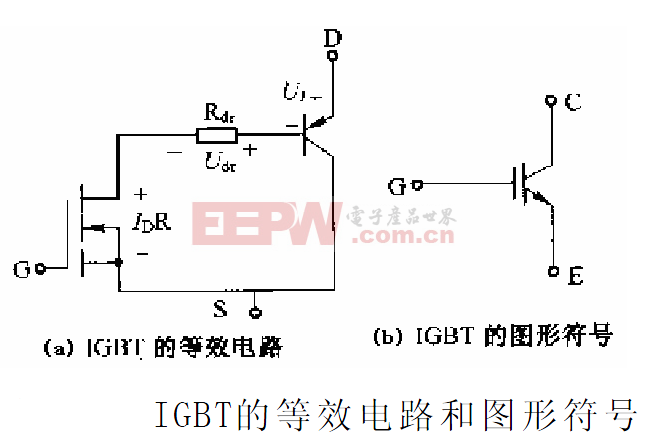

评论