先进封装工艺WLCSP与SiP的蝴蝶效应
晶圆厂插足Fan-out封装工艺
本文引用地址:http://www.eepw.com.cn/article/201610/310984.htm台积电的InFo(Intergrated Fan-out)在分类上不仅属于WLCSP的Fan-out技术,同时也属于多晶片封装的SiP技术。
今年台积电以集成扇出型封装InFo的优势抢在三星前一举拿下iPhone7 A10全部订单,三星为了与台积电角逐,期望在下一代iphone手机夺回部分订单,也加快了布局扇形晶圆级封装技术(FoWLP),预计2017年上半年实现量产。
据统计,全球Fan-out 2016年市场规模约1.3亿美元,仍然是一片蓝海,台积电则在Fan-out市场先发制人,处于领先地位。如今Apple开始采用InFo封装技术后,Fan-out市场将会进一步被催化,后期会有更多的制造和封测厂商参与进来。
那么原本属于封测厂商业务领域的蛋糕,现在不得不面临与前端制造厂商一起分食,而随着物联网IoT、移动智能设备等电子产品快速发展,高阶封装技术Fan-out的渗透率将会不断升高。
现阶段封测厂商与制造厂商在高阶封装领域的交叉拓展将会进入一定的磨合期,这个磨合期到底会持续多久,主要取决于封测厂商在Fan-out技术领域推进的步伐,如果届时封测厂商所持Fan-out技术能够快速响应前端制造厂商产品需求,那么接下来的发展很有可能趋向共赢方向——制造端与封测端各司其职、明确分工、互惠共赢。
目前来看,在这场博弈中封测厂商处于被动地位,承担了更多压力,在台积电InFo问世之前,包括星科金朋、艾克尔、日月光、矽品等在内的封测厂商均已将Fan-out技术纳入先进制程蓝图中,下一步实力厂商如果决心拿下这幅封测蓝海图,在购入相关设备及增加研发投入方面定会不遗余力。
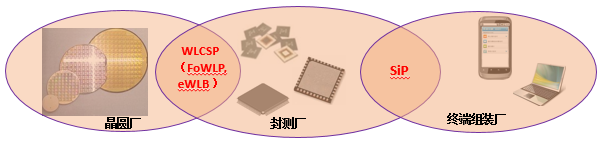
Source:拓璞产业研究所整理,2016.9
SiP封装技术侵蚀后端模组组装利润
如果说封测厂商在Fan-out技术方面正面对着来自制造端压力,SiP技术则为封测厂商带来了一份大礼。SiP封装工艺不仅仅是将多功能芯片整合于一体,还将组装模块的体积大幅地缩小,甚至可以跳过PCB等模组连接工艺。
也就是说,封测厂商通过SiP技术,将业务领域向下游大幅覆盖至组装及模块厂,那么处于下游的模块组装厂商,原本利润就低,如今又要面临来自封测端竞争的压力,随着SiP技术在智能手机、VR/AR、智能穿戴设备等越来越多的应用,SiP在制造产业链中的交叉拓展将会更加深入。
未来趋势判断:因SiP产生的交叉份额会基于在封测端技术和成本的优势,封测厂商将占取主导地位,这对后端组装厂营收份额核心技术与管理模式将会产生一定的影响;但是终端组装厂商在系统组装方面仍具备贴近市场的优势,这就要求封测端与终端组装厂商之间由竞争慢慢转向垂直整合模式。
表1:各主要封测厂商与台积电在Fan-out及SiP封测技术现况

Source:拓璞产业研究所整理,2016.9
在物联网、VR/AR、智能手机、智能穿戴设备等热点的强力推动下,高阶先进封装技术Fan-out WLP及 SiP在封测产品中的渗透率会逐渐升高,介于晶圆厂、封测厂及后端模组组装厂之间的竞争将会愈演愈烈,原有产业链结构是否会在未来的博弈中重新划分?一方面要看封测厂商在Fan-out技术开发的效率,另一方面还要看封测厂商在大肆布局SiP的道路上对后端系统组装厂垂直整合的态度,可以说先进封装技术WLCSP与SiP的蝴蝶效应已开始蔓延。









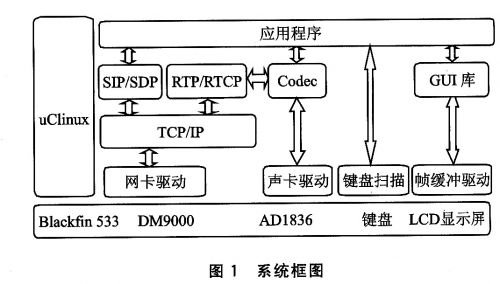

评论