应用散射技术测试复杂Spacer结构
长久以来,散射技术已充分展示其精准测量简单结构的能力,例如对浅沟槽隔离结构(STI)和栅极模块的量测。但是,IC制造商现在需要监测和控制越来越复杂的结构。
本文引用地址:https://www.eepw.com.cn/article/195947.htmSpacer是目前散射技术正在处理的复杂结构之一。Spacer会影响多种器件的特征,所以非常重要。因此,在线测量spacer结构可预测器件性能,并籍此提高性能和良率。本文所描述就是用散射技术测量复杂的spacer结构,并使用此类测量预测电学性能。采用了一种名为“预测分析”的方法,并以此来证明散射技术测量的某些参数与栅极电阻、栅极Lpoly和晶体管电流 (Ion) 等电学性能的相关性。
由这种密切的相关性,散射测量可在电性测试前作为电学性能的重要预测指标。因此,散射技术是提高spacer控制、缩短某些轮廓异常平均检测时间(MTTD)的可靠测量技术。
硅片、结构和模型
本次研究共使用了三批硅片。对硅片上的器件制造特意采用非标准化工艺,从而将工艺窗口扩展到正常器件功能之外。因此,这些硅片间的制造工艺有足够大的差异,完全可以探索器件结构差异与电学性能间的相关性。
对90纳米节点的NFET和PFET结构均进行了测量。根据散射技术标准,这两种结构都非常复杂,且彼此间的差异很大。这两种结构最明显的特征包括:带注入区域的绝缘硅(SOI)基层、覆盖有掺杂的栅极多晶硅以及在氧化物spacer外部覆盖氮化物spacer的结构。PFET亦包含第二个位于L形氮化物spacer顶部的氧化物结构。FET不同的形貌结构和不同的注入物,都会造成各自结构间有很大的差异。图1为NFET和PFET结构的XSEM图像。
散射测量数据是在KLA-Tencor Spectra CD100 机台上收集的。为了让包含这些结构的多种不同薄膜有正确的模型,已测量光谱和实际轮廓的匹配至关重要。应该考虑多种注入物和其它工艺的影响,以确保能够提取精准的光学特征数据。对于NFET和PFET结构,初次建模有10个以上的变量参数或自由度(DOF)。最后,为NFET设置七个DOF,为PFET设置八个DOF。这两种结构,其建模的DOF为栅极顶部的氮化物、掺杂栅极多晶硅高度、非掺杂栅极多晶硅高度、栅极多晶硅中部宽度(MCD)、氮化物spacer底部宽度、已注入的SOI厚度和SOI高度。PFET还有一个DOF是氮化物spacer厚度,此参数未应用于NFET。NFET和PFET结构的模型图和其DOF见图2。
为减缓复杂模型不稳定的问题,并取得较高的精度值,需收集短期动态精度数据。NFET取样由一块硅片上的五块芯片构成,每块芯片有三个动态循环;PFET 取样由一块硅片上的九块芯片构成,每块芯片上有五个动态循环。如果 PFET 取样的九块芯片之一产生“极端”结果,意味其测量包含极高的变数。尽管此取样是有限制的,但仍然适合这种概念验证实验。关键DOF的3σ精准结果摘要见表1。大多数的3σ精准值小于1纳米,这些结果对于如此复杂的建模非常重要,并显示出模型的稳定可靠。
结果和讨论
在此过程中共收集了两个电学测试数据。第一个称为PS测试,是在栅极硅化物形成后收集的。第二个称为M1测试,是在第一层后道金属层淀积后收集的。所有图像均显示的是硅片的中值数据,在每幅图像中,通过电性测量的芯片和使用散射测量的芯片都属于同一组芯片。任何一组测量中的“极端”值都没有从分析中移除。
用FMP分析法计算电性测量错误 (Vy),而不是 TMU分析,因为整个过程中使用的多种机台已被假定为良好的测量参考机台。计算散射测量错误 (Vx) 时使用表1中的精确值(使用包含极端项的PFET数据)。使用精确值是因为只使用了一个机台,且TMU分析并未在散射数据上执行。尽管精度元素应该可以估算出来,但却无法确知,因此并入Vother精度元素能否预测或并入对TPE、CPE和CPQ的主要度量区别不大,因此区别在于这些度量的二阶效应。由于计算两种系统测量错误时都需使用芯片级数据,所以误差必须转换为硅片级数据,以便用于预测分析。该转换值是通过使用芯片级别数据的变化量除以每个硅片上测得芯片数量大致得出的。
PS测试:栅极电阻
PS测试时发现,栅极电阻与氮化物spacer pulldown相关联。NFET栅极电阻采用栅极电阻参数PCN_Rs,而PFET栅极电阻采用参数PCP_RS进行测量。栅极电阻的电性测量在两个不同的物理结构上执行,因此仅将NFET pulldown与NFET栅极电阻(PCN_RS) 相比较;并仅将PFET pulldown与PFET栅极电阻(PCP_RS) 相比较,结果见图3。由于氮化物pulldown在散射模型中被定义为负数,因此请注意每个图像的左边表示更多pulldown。
TPE、CPE和CPQ的x和y形式以及百分比度量、数据对的数量和R2均如图中所示。TPE和CPE亦显示,对NFET来说,氮化物pulldown可预测的栅极电阻在0.68ohm/square之内;对于PFET则在1.4 ohm/square之内。图像的CPQ范围大约在3和4之间。Vother是主要的误差来源。即使在Vx的精度组件已确定并且并入Vx时也是如此。
此实验数据的物理解释是,由于pulldown增加,更多的栅极需面临以后的硅化物形成(氧化物隔板在硅化物成形前将去除)。形成更多的硅化物后,栅极电阻由于硅化物的高传导性而降低。
M1测试:栅极电阻
栅极电阻也会在 M1测试时进行测量,图4是它和氮化物spacer pulldown的关系。TPE和CPE显示,对NFET来说,氮化物pulldown可预测栅极电阻在0.73ohm/square之内;对于PFET则在0.82ohm/square内。CPQ的范围大约在3到4之间。再次对应于某个数据范围,足以显示出其间良好(但不是极佳)的关联性。此关联的物理解释和在PS测试中的解释相同。
图5对M1测试时测得的栅极电阻与多晶硅MCD进行比较。这一次,TPE和CPE两种度量都再次显示多晶硅MCD可预测栅极电阻到0.88ohm/square以内 (NFET),或1.3ohm/square以内(PFET)。与氮化物pulldown比较,CPQ (~2-3) 值略低。这表示数据范围足以显示某些级别的关联。此关联的物理解释为:栅极CD更大,则其栅极顶部的表面区域也更多,以方便未来硅化物成形,这样会造成更低的栅极电阻。
M1测试:Lpoly
Lpoly是在M1测试中基于电容的栅极长度电性测量,它和栅极多晶硅MCD散射测量相关联(图6)。CPE 略小于TPE,因此电性测量误差非常小,但对整体误差却有明显影响。多晶硅MCD测量能够预测Lpoly的测量,对于NFET和PFET来说,其误差都在~1.5 nm以内。NFET的CPQ为~2-3,这表示数据范围对显示某些量级的关联已足够;PFET的CPQ为~5,这表示数据范围足以显示其良好的关联。Lpoly的测量表示它能够准确地测量物理栅极长度,因此应该与散射多晶硅MCD测量相关联。
M1测试:晶体管电流
图7显示了进行M1测量时,通过NFET (nIon) 的晶体管电流和氮化物pulldown测量相关联。再次发现CPE仅略小于TPE。氮化物pulldown测量预测NFET晶体管电流误差范围在~40μA/μm 以内,~2-3的CPQ值表示数据范围已足够显示某些关联。如前文所示,此实验数据的物理解释为:spacer被过度刻蚀,使得氮化物pulldown增加,导致掺杂的SOI层上层氧化物损耗增加。由于氧化物层减少,源漏掺杂剂向外扩散,更薄的氧化物导致更多的掺杂剂向外扩散。源漏中的掺杂剂变少会降低传导性,导致NFET源漏中的电流 (nIon) 减少。由于PFET中的搀杂剂差异,在pIon和PFET氮化物pulldown之间看不到类似的关联。
结论
预测分析方法可用于预测一个基于其它测量(称为自变量)的测量(因变量),因此不可避免会出现预测测量误差。
散射技术可成功的为复杂的NFET和PFET spacer结构建模。散射测量数据是从非标准工艺硅片上收集的,以探索结构变量和电性参数之间的关系。栅极电阻Lpoly和晶体管电流 (Ion) 的电性测量,与用散射测量方式对氮化物spacer pulldown和栅极多晶硅MCD进行的在线测量相关联。在每种情况中,都可使用散射测量预测电性测量,具备相关的3σ置信范围。通过对spacer进行在线监控来预测器件性能,从而改善器件性能和良率。
此工作证实了电性测量是判断复杂结构的散射测量的适当方法。由于有了这些功能,使用电性测量对这些复杂结构参数进行在线测试将会变得更普遍。
致谢
本文参考了《Proceedings of SPIE 2007 Metrology, Inspection, and Process Control for Microlithography XXI Conference》卷 6518 同名标题的原版 SPIE 出版物。IBM 的 Chas Archie 为本文的预测分析发展部分提供了清晰明确的建议;IBM 的 Blaze Messer 协助收集和分析过许多数据;IBM 的 RonFiege 和 Clem Bottini 协助收集过光谱,而 IBM 的 Ben Himmel 还提供过电性测试工具匹配数据。作者在此向以上人员致谢。最后,我们还要感谢 KLA-Tencor 的 Jesus Rivas,他曾帮助我们提取薄膜光学常数。




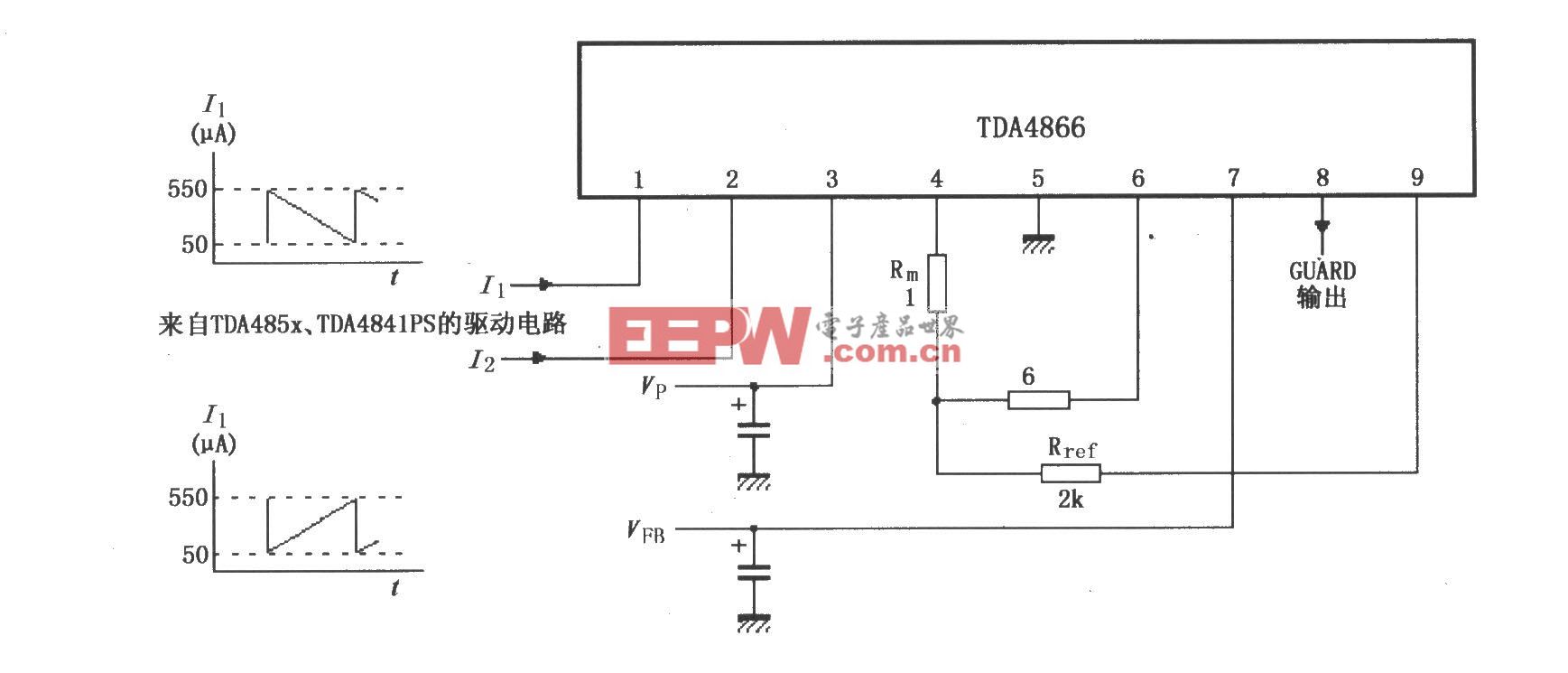
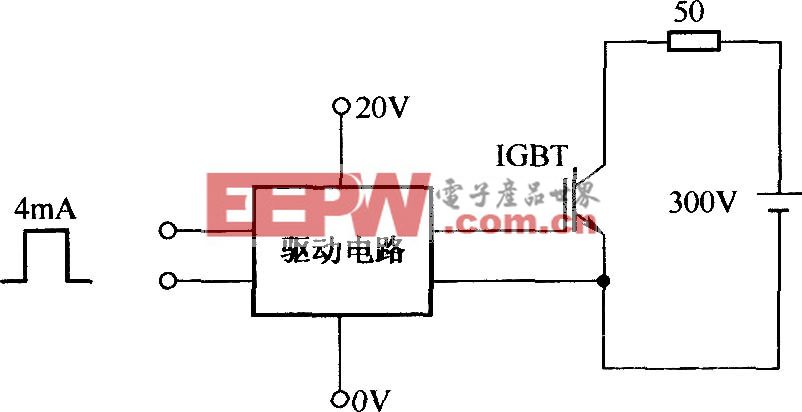
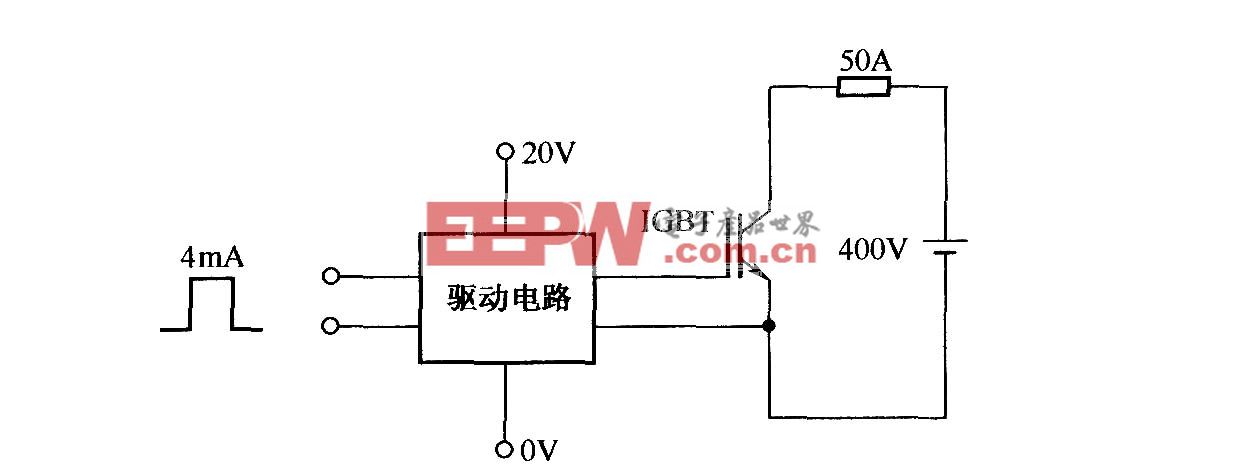
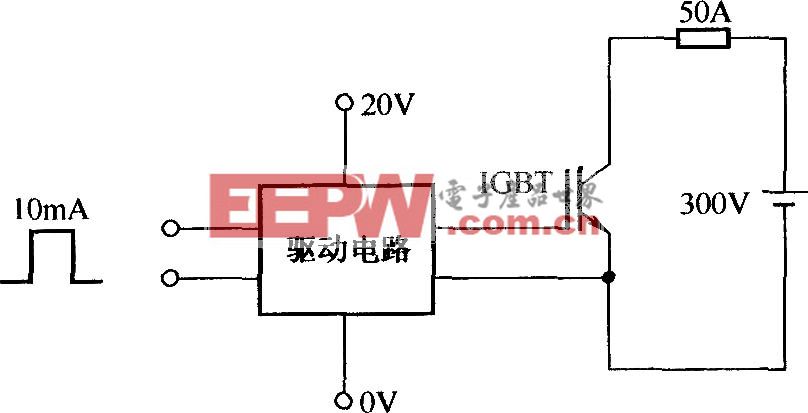
评论