典型MEMS工艺流程
MEMS表面微机械加工工艺是指所有工艺都是在圆片表面进行的MEMS制造工艺。表面微加工中,采用低压化学气相淀积(LPCVD)这一类方法来获得作为结构单元的薄膜。表面微加工工艺采用若干淀积层来制作结构,然后释放部件,允许它们做横向和纵向的运动,从而形成MEMS执行器。最常见的表面微机械结构材料是LPVCD淀积的多晶硅,多晶硅性能稳定且各向同性,通过仔细控制淀积工艺可以很好的控制薄膜应力。此外,表面微加工工艺与集成电路生产工艺兼容,且集成度较高。
本文引用地址:https://www.eepw.com.cn/article/161012.htm下面结合北京大学微系统所的MEMS标准工艺,以一个MEMS中最主要的结构——梁为例介绍一下MEMS表面加工工艺的具体流程。
1.硅片准备
2.热氧生长二氧化硅(SiO2)作为绝缘层
3.LPCVD淀积氮化硅(Si3N4)作为绝缘及抗蚀层
4.LPCVD淀积多晶硅1(POLY1)作为底电极
5.多晶硅掺杂及退火
6.光刻及腐蚀POLY1,图形转移得到POLY1图形
7.LPCVD磷硅玻璃(PSG)作为牺牲层
8.光刻及腐蚀PSG,图形转移得到BUMP图形
9.光刻及腐蚀PSG形成锚区
10.LPCVD淀积多晶硅2(POLY2)作为结构层
11.多晶硅掺杂及退火
12.光刻及腐蚀POLY2,图形转移得到POLY2结构层图形
13.溅射铝金属(Al)层
14.光刻及腐蚀铝层,图形转移得到金属层图形
15.释放得到活动的结构
至此,我们利用MEMS表面加工工艺完成了一个梁的制作。这个工艺流程中共有五块掩膜版,分别是:
1.POLY1,用的是阳版,形成的多晶1图形用来提供机械层的电学连接,地极板或屏蔽电极;
2.BUMP,用的是阴版,在牺牲层上形成凹槽,使得以后形成的多晶硅机械层上出现小突起,减小在释放过程或工作过程中机械层与衬底的接触面积,起一定的抗粘附作用;
3.ANCHOR,用的是阴版,在牺牲层上刻孔,形成机械层在衬底上的支柱,并提供电学连接;
4.POLY2,用的是阳版,用来形成多晶硅机械结构;
5.METAL,用的是阳版,用来形成电连接或测试接触。









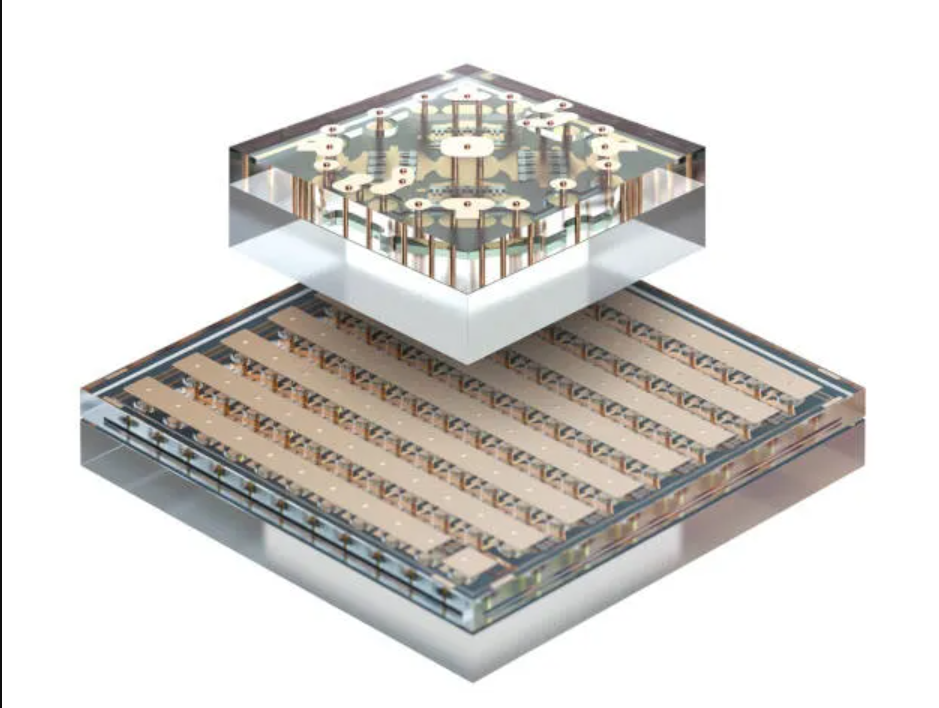
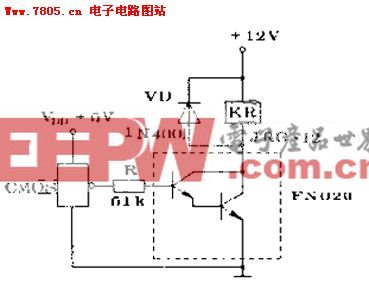



评论