突破委外产能限制 半导体OEM亟需重新整合供应链
在今年初于法国Grenoble举行的欧洲3D TSV高峰会上,来自半导体产业的业界专家们似乎都认同这样的看法:在包括消费市场等许多领域,采用2.5D整合(透过利用中介层)仍将比采用真正的3D垂直整合更具成本竞争力。而这可能对于电子制造产业带来重大变化。
本文引用地址:https://www.eepw.com.cn/article/270726.htm半导体谘询公司ATREG资深副总裁兼负责人Barnett Silver在会中发表对于封装与IC制造市场的看法。
他说,“过去十年来,随着技术迈向下一个先进节点,半导体制程与晶圆厂开发的总成本急遽上升,预计在14nm节点以后只有台积电(TSMC)、三星电子 (Samsung)与英特尔(Intel)等少数几家代工厂还握有足够的资金持续这一制程竞赛。这使得OEM以及无晶圆厂的IC设计公司只能依靠少数几家 代工选择,持续地受到牵制。因此,大型OEM必须垂直地重新整合其具策略性的芯片供应链。”
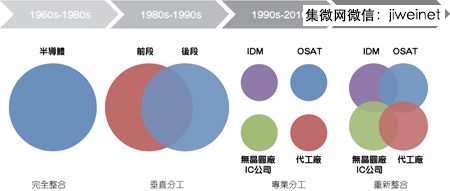
图1:芯片整合历经周期性循环。
Silvers 预计在未来三年内将会出现转捩点——诸如苹果(Apple)、Google和亚马逊(Amazon)等资金充裕的OEM可望投资于越来越多的代工厂与IC 封装厂,以确保其供应链稳定,届时半导体产业将能更有效地利用先进节点,以及降低芯片产能分配的风险。从观察多家代工厂与IDM的收购/整并谈判 中,Silver目睹了这一类大型OEM的竞价过程(不过至今并未成功)。
对于OEM而言,抗衡台积电等少数几家晶圆代工厂市场主导地位的方法之一,就是透过不同程度的资本参与、经营权与所有权介入,以及收购委外半导体组装与测试服务供应商(OSATS)与代工厂的股份,以及开发其他的替代生产模式。
Silver 表示,这种混合的半导体制造模式可能为其带来‘产能权益’,即半导体公司或OEM可投资于一座晶圆厂,以便取得该晶圆厂(包括保证获得产能)整体成功的股份;或者透过更进一步的合作(共同合作)模式,由多家半导体公司共同拥有与经营一座晶圆厂,并确保按比例获得整体产能,同时共同分担营运费用。

图2:先进封装仍将是一个明显的差异化因素,将推动产业重新整合。
“在此过程中,封装技术至关重要,然而却经常被忽视了”,Silver表示,他看到OSAT和晶圆代工服务的融合态势。
根据Yole Developpement的调查报告,2014年全球半导体IC晶圆中约有19%采用晶圆级封装技术(如晶圆植凸块、RDL与TSV等)制造,预计在2015年还将提高到20%。
Silver表示:“在代工厂、OSAT和IDM竞相抢占510亿美元的芯片组装与测试市场之际,我预期未来将会看到更多的整并与收购。随着封装技术变得越来越先进,特别是在晶圆级,在前段制程与后段封装之间将会发生重新整合与融合。”
尽管大部分的进展都来自于矽穿孔(TSV)技术,包括解析度、深度与长宽比等,该技术仍被认为成本高昂,而仅限于高阶应用,包括服务器存储器或高性能运算等。虽然2015年被认为是3D TSV起飞的一年,可望看到更多高频宽存储器加速量产,但在今年欧洲3D TSV高峰会上的众多争议多半都围绕在这种全3D架构何时才能和2.5D中介层一样在消费应用上展现竞争力与成本优势。这种不确定性对于OSAT来说正是 一个好机会,让他们能够扩展产品组合,以及抗衡企图掌控一切的代工厂。
根据半导体封装谘询公司TechSearch International总裁E. Jan Vardaman指出,虽然TSV技术已经被广泛地应用在感测器和MEMS,但产能问题以及堆叠存储器与逻辑元件带来的热挑战仍然让3D TSV无法得到消费应用的青睐。
















评论