BGA/QFN封装难题终结者:360°无死角渗透,返修成本直降
一次失效=30万报废?
不,只是钱的话还是小事,严重的话可能影响生命安全!——对智能驾驶芯片,焊点脱落=死神踩油门!
中国电动汽车产业正加速崛起,迈向“弯道超车”,智能手机、智能手表等消费电子也日新月异,驱动智能设备迈向新高度。然而,高性能芯片封装却面临两大挑战:
第一,高温下芯片、焊点与基板的热膨胀差异,易导致焊点断裂,芯片失效;
第二,跌落或震动冲击,尤其对尺寸高达500×500毫米的智能驾驶芯片,稍有颠簸就可能引发焊点脱落,一旦失效,将严重威胁自动驾驶系统的安全。
这些可不是简单的“死机”,而是瞬间从“酷”变“危险”!
面对这些痛点,世强推出了高Tg、低CTE、高可靠性的底部填充方案,全面提升芯片封装可靠性。
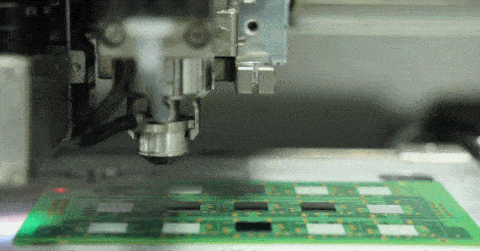
● 精密无缝填充:支持BGA、QFN等高密度封装,借助毛细作用实现360°无死角渗透,全面覆盖千余引脚,完美适配超薄、精细化芯片趋势。

● 超高可靠性:通过柔性填充,有效缓解热膨胀差异与震动冲击,保护焊点,大幅降低芯片失效风险。
● 优异材料与高适应性:固化速度快,高玻璃化转变温度(Tg),低粘度,耐湿热性能强,低模量与低CTE(热膨胀系数)设计显著减少封装应力,在高低温循环中表现出色,确保长期可靠性。
为满足多样化需求,世强除了提供全面填充、边角绑定两种方案,也推出了可返修胶水,加热后胶体可剥离,便于芯片检修与重新焊接,降低返修成本,提升生产效率。

从手机摄像头模组到智能驾驶芯片,从扫地机器人到电控系统,世强底填胶广泛应用于消费电子、汽车、工业等领域,已经帮助苹果、特斯拉等头部客户实现了高可靠性封装。性能对标国际顶尖,但价格更有优势。
关于世强硬创:
全球领先的硬件创新研发及供应服务平台,获1000多家知名原厂授权代理,链接100万工程师,为ICT、工业自动化、汽车电子、消费电子、物联网等行业提供IC、元件、电气、电机、材料、仪器等从方案设计、选型到采购的一站式服务,是电子行业的首选研发与采购平台。




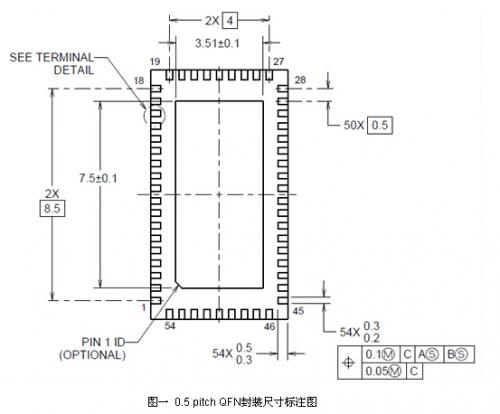

评论