创建灵敏的MEMS结构的工艺技术介绍
表面微加工技术可用于创建微机电传感器及激励器系统,它能够通过高适应度的弹性,形成锚定在基底上的悬浮式结构。该工艺流程借鉴了先进的IC技术以及高纵横比干蚀刻和牺牲层(sacrificial-layer)去除等专用的MEMS操作。意法半导体的Thelma(微加速计厚外延层)工艺与传统微加工工艺不同,主要区别在于它采用了15微米厚的多晶硅外延层。
与传统微加工工艺相比,Thelma工艺允许相对较厚的硅结构。这会增加垂直表面积,从而增大平行于基底移动的静电激励器中的总电容。
此外,与标准微加工工艺相比,Thelma工艺还允许更高的质量,这反过来能实现更高灵敏度的器件。该工艺更大的厚度还能减少交叉灵敏度误差。同样重要的是,该技术可以减少芯片面积,从而克服体型微加工(bulk micromachining)过程常见的设计局限。
可靠性测试证明多晶硅具有良好的耐疲劳性及抗冲击性。此外,对于结构性外延多晶硅层,该工艺展现出极好的且可重复的电气及机械属性。杨氏系数、残余应力及应力梯度等属性可以方便地通过在器件上的测试结构自动监测。 Thelma工艺流程包括六个主要步骤:基底热氧化、水平互连的沉积与表面图样化(patterning)、牺牲层的沉积与表面图样化、结构层的外延生长、用沟道蚀刻将结构层图样化、以及牺牲层的氧化物去除与接触金属化沉积。
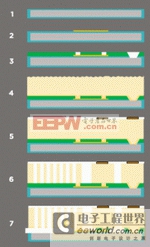
图4:Thelma工艺流程包括6个主要步骤
在基底热氧化阶段,先用一个2.5微米厚的永久氧化物层(通过1,100℃的热处理获得)来覆盖硅基底;紧接着,在热氧化物上沉积第一层多晶硅,以实现水平互连的沉积与表面图样化。这一层定义了掩埋轨道,用于将电位和电容信号带到器件外部。
在牺牲层阶段,利用等离子增强型化学汽相淀积(PECVD)得到1.6微米厚的氧化层。该层与热氧化层共同形成厚度为4.1微米的层,将移除部分与基底隔开。此步骤类似传统表面微加工工艺中牺牲层的生成过程。
结构化多晶硅层的外延生长过程包括在反应堆中生成一个15微米厚的外延多晶硅。结构层图样化步骤则通过蚀刻一条直达氧化层的深度沟道来形成运动部分的结构。
在最后一个主要阶段,为了避免由毛细管作用而造成的任何粘着,它利用化学反应将牺牲层氧化物去除。为获得最大效率,此步骤需要在严格干燥的条件下完成。最后,再进行接触金属化沉积,目的在于形成器件与金属引线框之间的线邦定。最终的硅结构由一系列垂直柱状的单晶体构成,每个晶体都是在一个外延反应堆中生成的。
必须指出的是,工艺中采用的热处理会在所获得的MEMS器件中产生残余应力。专用测试结构,如枢轴或伽马形样本等可以被用来对这些应力进行实验测定。测试结果表明,这些残余应力具有压缩性,而且其值很小(低于10 MPa),一般发生在与基底平行运动的多晶硅层中。该层的应力梯度也能得到很好的控制。对SEM图片的分析表明,事实上,测试光束的最大面外位移(out-of-plane displacement)偏差值在1,000微米长度上小于1微米。
Thelma 工艺可以实现模拟输出惯性三轴传感器等器件,这种器件能够在4kHz(x与y方向)及2.5 kHz(z方向)的最大带宽范围内测量2或6个g(满量程,可由用户选择)的静、动态加速度。100Hz带宽内的分辨率为0.5mg。该系列传感器的其他特性包括2.4V至5V单电源工作、与电源电压成比例的输出电压偏移与灵敏度、嵌入式自检能力、高耐冲击性及工厂微调等。Thelma 工艺还可以制造数字输出加速计,它由2.4V至3.6V单电源供电,带有1.8V兼容I/O及I2C/SPI数字输出接口。
该加速计芯片可被客户用作运动激活功能的基础,用于移动终端、汽车防盗及惯性导航系统、游戏与虚拟现实输入设备、振动监视与补偿系统以及机器人控制应用中。








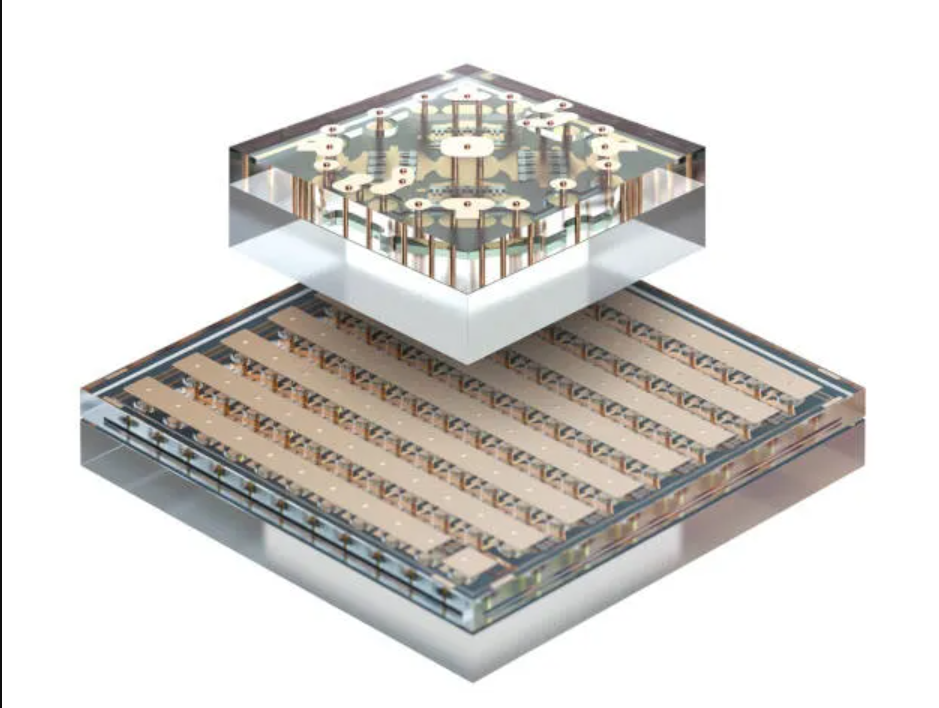





评论