MEMS结构科普:氧传感器知识研究
图1是MEMS 结构氧传感器的示意图。在P型硅衬底上热氧化生长SiO2 隔离层,采用LPCVD设备生长多晶硅并光刻加热电阻。为了控制加热电阻的阻值,在多晶硅中掺入P。然后使用LPCVD法,在衬底正反两面淀积Si3 N4 层,背面刻蚀腐蚀窗口,利用各向异性腐蚀技术刻蚀出硅杯。正面蒸Pt光刻得到叉指检测电极。然后利用钛靶采用交流磁控溅射镀膜法,在检测电极上生长TiO2 敏感薄膜。可看到,该MEMS 结构氧传感器利用敏感膜下的磷多晶硅电阻作加热器,采用了MEMS 的深刻蚀工艺, 从而减少器件的热容量,降低功耗。把检测电极和加热电极合理设计成一体化器件,可以集成化生产、批量制作。整个芯片的尺寸为3 mm×3mm×0 .54 mm ,膜片厚度约为2 .5 μm,硅杯的杯底膜片尺寸为1 .4 mm× 1 .4 mm, 敏感膜片大小为0 .72mm×0 .72 mm。MEMS 结构的TiO2 氧传感器的工艺流程图如图2 所示。
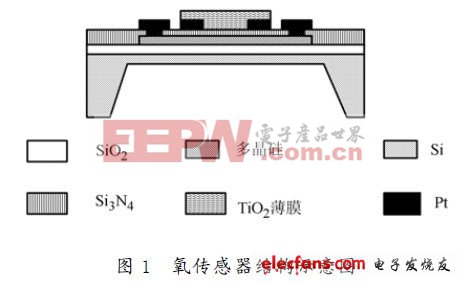
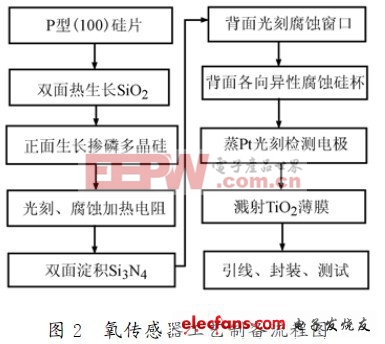
TiO2 是宽禁带半导体,禁带宽度在3 eV 以上。在真空制备TiO2 半导体时,当氧分压较低时,在TiO2 中产生大量的氧空位,构成N 型半导体 。TiO2 薄膜的氧敏机理是作为施主中心的氧空位随外界氧分压的变化而变化,从而引起了材料电阻率的变化。氧空位的变化是通过TiO2 表面的氧吸附平衡而实现的。TiO2 表面对氧气的吸附过程首先是氧吸附于TiO2 表面的物理吸附,然后过渡到化学吸附,最后进入常晶格的氧位置。随着氧分压的上升,TiO2 吸附的氧越来越多,氧空位也越来越少,所以电阻也逐渐增大。利用质量作用关系,得到二氧化钛的电导率与氧分压P 的关系为:σ = Aμn eP^(- 1/x)
其中:A是质量作用常数,是和氧空位浓度有关的系数;σ是TiO2 的电导率;μn 是电子迁移率;P 为氧分压;随着离子缺陷的本质及电离情况,x 的值在4~6 之间变化。
交流磁控溅射镀膜法是在磁场的控制下,利用高压电场使惰性气体辉光放电产生电离,电离产生的正离子高速轰击靶材,使靶材上的钛原子溅射出来,溅射出的钛原子与反应气体O2 反应,在基板上沉积出TiO2 薄膜。
我们在JGP - 350 磁控溅射仪中用高纯钛板作靶材,其直径为60 mm,厚度为4 mm,靶与衬底间距为60 mm,反应磁控溅射用频率为13 .56 MHz。工作气体为纯度99 .99 % 的Ar 和99 .99 % 的O2 。采用质量流量控制器来控制反应气体O2 的流量,同时使用压电阀来控制真空腔内的工作气体气压。利用复合压强控制仪来控制压电阀和真空计,使得气体压强及流量控制非常稳定。气体比例为O2 :Ar= 1 :2 保持恒定。反应室预真空为10^(- 3) Pa。溅射时工作气压为70 Pa。试样基体为单晶硅片,镀膜前用丙酮超声波清洗,后再用去离子水漂洗、烘干。衬底采用水冷却,用热电偶测量其温度值。此时得到的是无定型的二氧化钛薄膜,在500℃ 做退火处理,得到锐钛矿二氧化钛。图3 是交流磁控溅射镀膜法制备的二氧化钛薄膜的X 射线衍射图谱(XRD)。由图3 可以看出最强的两个衍射峰出现在锐钛矿相(101) 晶面(2θ = 25 .24°) 和(004) 晶面(2θ= 37 .820°) ,特别是(101)晶面择优趋向明显,结晶度增大,表明TiO2 薄膜表面结晶相为锐钛矿相。


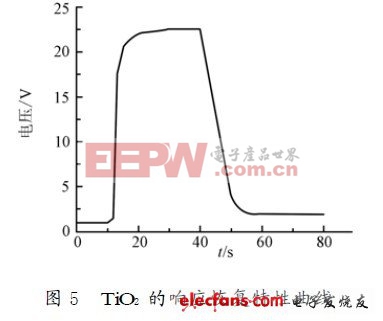
电阻型氧敏感材料性能的指标主要是在气氛改变时电阻的变化幅度和响应时间。薄膜元件的氧敏感性能测试可用氧含量气氛变化时检测电阻变化来表示。由于当温度保持恒定时,检测电阻的阻值只依赖于气体中的氧体积份数,所以本实验是在室温下的纯N2 的气氛中,逐渐加入一定量的O2 ,然后测定各个氧气体积份数下的电阻值。薄膜的氧敏感性能如图4 所示。可以看到,薄膜元件的氧敏感性能较好,电阻的变化幅度比较明显。响应时间也是气敏器件的一个重要参数,一般将器件阻值增量由33 % 变化到稳定增量的66 %所需的时间定义为响应时间和恢复时间。在通有恒定电流的情况下,测量TiO2 的电压值,得到图5 所示的薄膜元件在空气附近气氛反复变化时的响应特性。从图中可以看到薄膜元件对O2 具有较好的响应。对氧气氛的响应时 间在300 ms 左右,恢复时间在6s 左右。










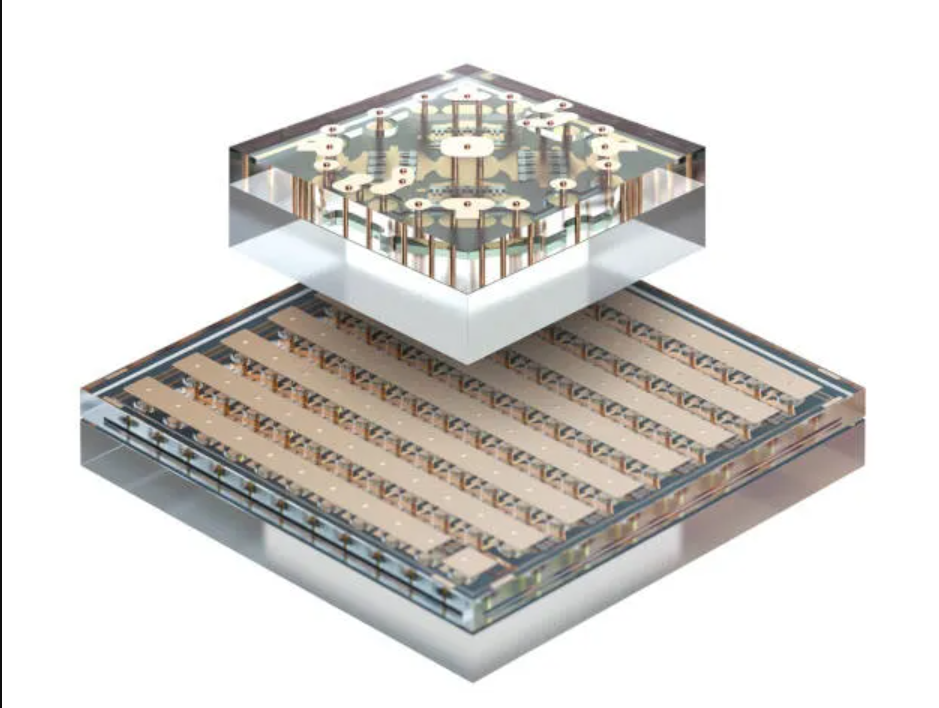



评论