无铅焊点可靠性问题分析及测试方法
随着电子信息产业的日新月异,微细间距器件发展起来,组装密度越来越高,诞生了新型SMT、MCM技术,微电子器件中的焊点也越来越小,而其所承载的力学、电学和热力学负荷却越来越重,对可靠性要求日益提高。电子封装中广泛采用的SMT封装技术及新型的芯片尺寸封装(CSP)、焊球阵列(BGA)等封装技术均要求通过焊点直接实现异材间电气及刚性机械连接(主要承受剪切应变),它的质量与可靠性决定了电子产品的质量。
一个焊点的失效就有可能造成器件整体的失效,因此如何保证焊点的质量是一个重要问题。传统铅锡焊料含铅,而铅及铅化合物属剧毒物质,长期使用含铅焊料会给人类健康和生活环境带来严重危害。
目前电子行业对无铅软钎焊的需求越来越迫切,已经对整个行业形成巨大冲击。无铅焊料已经开始逐步取代有铅焊料,但无铅化技术由于焊料的差异和焊接工艺参数的调整,必不可少地会给焊点可靠性带来新的问题。因此,无铅焊点的可靠性也越来越受到重视。本文叙述焊点的失效模式以及影响无铅焊点可靠性的因素,同时对无铅焊点可靠性测试方法等方面做了介绍。
焊点的失效模式
焊点的可靠性实验工作,包括可靠性实验及分析,其目的一方面是评价、鉴定集成电路器件的可靠性水平,为整机可靠性设计提供参数;另一方面,就是要提高焊点的可靠性。这就要求对失效产品作必要的分析,找出失效模式,分析失效原因,其目的是为了纠正和改进设计工艺、结构参数、焊接工艺等,焊点失效模式对于循环寿命的预测非常重要,是建立其数学模型的基础。下面介绍3种失效模式。
1焊接工艺引起的焊点失效
焊接工艺中的一些不利因素及随后进行的不适当的清洗工艺可能会导致焊点失效。SMT焊点可靠性问题主要来自于生产组装过程和服役过程。在生产组装过程中,由于焊前准备、焊接过程及焊后检测等设备条件的限制,以及焊接规范选择的人为误差,常造成焊接故障,如虚焊、焊锡短路及曼哈顿现象等。
另一方面,在使用过程中,由于不可避免的冲击、振动等也会造成焊点的机械损伤,如波峰焊过程中快速的冷热变化对元件造成暂时的温度差,使元件承受热一机械应力。当温差过大时,导致元件的陶瓷与玻璃部分产生应力裂纹。应力裂纹是影响焊点长期可靠性的不利因素。
同时在厚、薄膜混合电路(包括片式电容)组装过程中,常常有蚀金、蚀银的现象。这是因为焊料中的锡与镀金或镀银引脚中的金、银形成化合物,从而导致焊点的可靠性降低。过度的超声波清洗也可能对焊点的可靠性有影响。
2时效引起的失效
当熔融的焊料与洁净的基板相接触时,在界面会形成金属间化合物(intermetallicCompounds)。在时效过程中,焊点的微结构会粗化,界面处的IMC亦会不断生长。焊点的失效部分依赖于IMC层的生长动力学。界面处的金属间化合物虽然是焊接良好的一个标志,但随着服役过程中其厚度的增加,会引起焊点中微裂纹萌生乃至断裂。
当其厚度超过某一临界值时,金属间化合物会表现出脆性,而由于组成焊点的多种材料间的热膨胀失配,使焊点在服役过程中会经历周期性的应变,形变量足够大时会导致失效。研究表明Sn60/Pb40软钎料合金中加入微量稀土元素镧,会减少金属化合物的厚度,进而使焊点的热疲劳寿命提高2倍,显著改善表面组装焊点的可靠性。
3热循环引起的失效
电子器件在服役条件下,电路的周期性通断和环境温度的周期性变化会使焊点经受温度循环过程。封装材料问的热膨胀失配,将在焊点中产生应力和应变。如在SMT中芯片载体材料A1203陶瓷的热膨胀系数(CTE)为6×10-6℃-1,而环氧树脂/玻璃纤维基板的CTE则为15×10-6℃-1。温度变化时,焊点将承受一定的应力和应变。一般焊点所承受应变为1%~20%。在THT工艺中,器件的柔性引脚会吸收由于热失配而引起的大部分应变,焊点真正承受的应变是很小的。而在SMT中,应变基本由焊点来承受,从而会导致焊点中裂纹的萌生和扩展,最终失效。

波峰焊相关文章:波峰焊原理





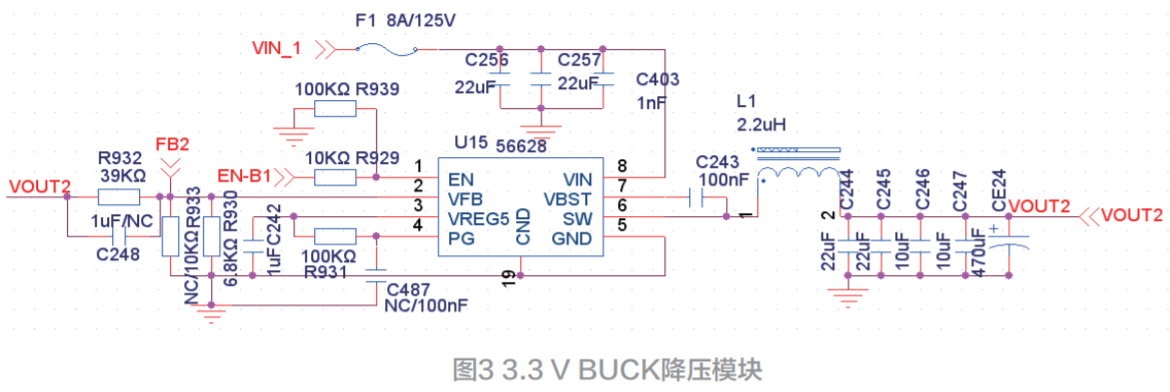



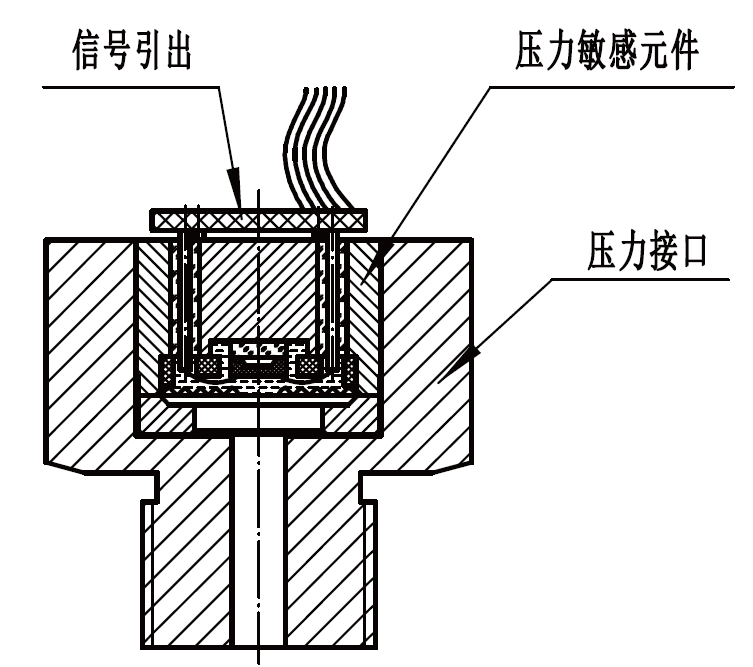


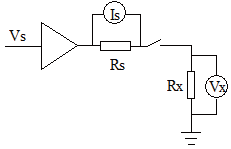
评论