芯片是如何被制造出来的?芯片光刻流程详解
三、光刻胶涂覆(Photoresist Coating)
本文引用地址:http://www.eepw.com.cn/article/201902/397742.htm光刻胶涂覆通常的步骤是在涂光刻胶之前,先在900-1100度湿氧化。氧化层可以作为湿法刻蚀或B注入的膜版。作为光刻工艺自身的第一步,一薄层的对紫外光敏感的有机高分子化合物,即通常所说的光刻胶,要涂在样品表面(SiO2)。首先光刻胶被从容器中取出滴布到置于涂胶机中的样品表面,(由真空负压将样品固定在样品台上),样品然后高速旋转,转速由胶粘度和希望胶厚度确定。在这样的高速下,胶在离心力的作用下向边缘流动。
涂胶工序是图形转换工艺中最初的也是重要的步骤。涂胶的质量直接影响到所加工器件的缺陷密度。为了保证线宽的重复性和接下去的显影时间,同一个样品的胶厚均匀性和不同样品间的胶厚一致性不应超过±5nm(对于1.5um胶厚为±0.3%)。
光刻胶的目标厚度的确定主要考虑胶自身的化学特性以及所要复制图形中线条的及间隙的微细程度。太厚胶会导致边缘覆盖或连通、小丘或田亘状胶貌、使成品率下降。在MEMS中、胶厚(烤后)在0.5-2um之间,而对于特殊微结构制造,胶厚度有时希望1cm量级。在后者,旋转涂胶将被铸胶或等离子体胶聚合等方法取代。常规光刻胶涂布工序的优化需要考虑滴胶速度、滴胶量、转速、环境温度和湿度等,这些因素的稳定性很重要。
在这里说一下,光刻胶的主要成分有一种聚合物(树脂)、敏化剂和溶剂。聚合物在被辐照时结构变化,溶剂使其能被甩胶并在样品表面形成薄膜,敏化剂控制聚合相的化学反应。不含有敏化剂的光刻胶有时称为单元或一元体系,而含有敏化剂使则称为二元体系。溶剂或其它添加物通常不计入元数,因为它们不直接参与光刻胶的光化学反应。
根据性质的不一样,光刻胶可以分为正胶和负胶。
在工艺发展的早期,负胶一直在光刻工艺中占主导地位,随着VLSI IC和2~5微米图形尺寸的出现,负胶已不能满足要求。随后出现了正胶,但正胶的缺点是粘结能力差。
用正胶需要改变掩膜版的极性,这并不是简单的图形翻转。因为用掩膜版和两种不同光刻胶结合,在晶园表面光刻得到的尺寸是不一样的,由于光在图形周围的衍射效应,使得用负胶和亮场掩膜版组合在光刻胶层上得到的图形尺寸要比掩膜版上的图形尺寸小。用正胶和暗场掩膜版组合会使光刻胶层上的图形尺寸变大。
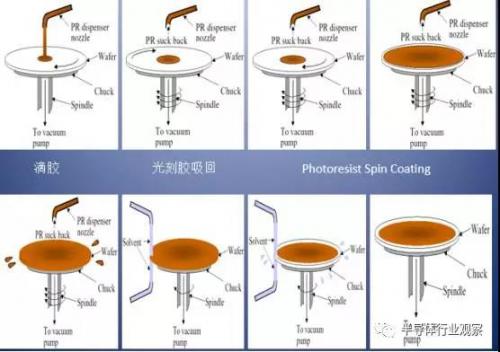
光刻胶涂覆
四、前烘(Soft Bake)
完成光刻胶的涂抹之后,需要进行软烘干操作,这一步骤也被称为前烘。前烘能够蒸发光刻胶中的溶剂溶剂、能使涂覆的光刻胶更薄。
在液态的光刻胶中,溶剂成分占65%-85%。虽然在甩胶之后,液态的光刻胶已经成为固态的薄膜,但仍有10%-30%的溶剂,容易沾污灰尘。通过在较高温度下进行烘培,可以使溶剂从光刻胶中挥发出来(前烘后溶剂含量降至5%左右),从而降低了灰尘的沾污。同时,这一步骤还可以减轻因高速旋转形成的薄膜应力,从而提高光刻胶 衬底上的附着性。
在前烘过程中,由于溶剂挥发,光刻胶厚度也会减薄,一般减薄的幅度为10%-20%左右。
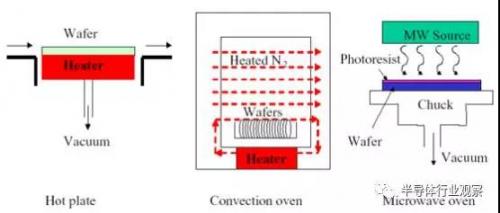
Baking Systems
四、对准(Alignment)
光刻对准技术是曝光前一个重要步骤作为光刻的三大核心技术之一,一般要求对准精度为最细线宽尺寸的 1/7---1/10。随着光刻分辨力的提高 ,对准精度要求也越来越高 ,例如针对 45am线宽尺寸 ,对准精度要求在5am 左右。
受光刻分辨力提高的推动 ,对准技术也经历 迅速而多样的发展 。从对准原理上及标记结 构分类 ,对准技术从早期的投影光刻中的几何成像对准方式 ,包括视频图像对准、双目显微镜对准等,一直到后来的波带片对准方式 、干涉强度对准 、激光外差干涉以及莫尔条纹对准方式 。从对准信号上分 ,主要包括标记的显微图像对准 、基于光强信息的对准和基于相位信息对准。
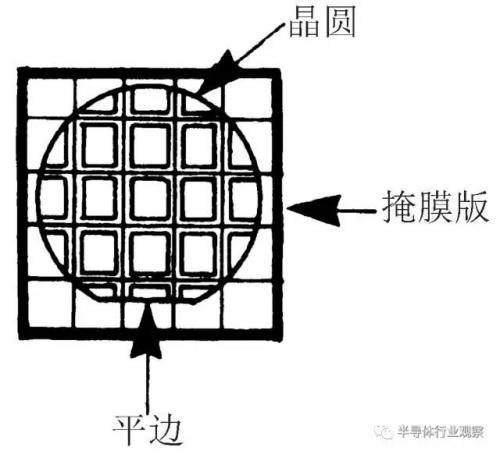
对准法则是第一次光刻只是把掩膜版上的Y轴与晶园上的平边成90º,如图所示。接下来的掩膜版都用对准标记与上一层带有图形的掩膜对准。对准标记是一个特殊的图形(见图),分布在每个芯片图形的边缘。经过光刻工艺对准标记就永远留在芯片表面,同时作为下一次对准使用。
对准方法包括:
a、预对准,通过硅片上的notch或者flat进行激光自动对准
b、通过对准标志,位于切割槽上。另外层间对准,即套刻精度,保证图形与硅片上已经存在的图形之间的对准。
五、曝光(Exposure)
在这一步中,将使用特定波长的光对覆盖衬底的光刻胶进行选择性地照射。光刻胶中的感光剂会发生光化学反应,从而使正光刻胶被照射区域(感光区域)、负光刻胶未被照射的区域(非感光区)化学成分发生变化。这些化学成分发生变化的区域,在下一步的能够溶解于特定的显影液中。
在接受光照后,正性光刻胶中的感光剂DQ会发生光化学反应,变为乙烯酮,并进一步水解为茚并羧酸(Indene-Carboxylic-Acid, CA),羧酸在碱性溶剂中的溶解度比未感光部分的光刻胶高出约100倍,产生的羧酸同时还会促进酚醛树脂的溶解。利用感光与未感光光刻胶对碱性溶剂的不同溶解度,就可以进行掩膜图形的转移。
曝光方法:
a、接触式曝光(Contact Printing)掩膜板直接与光刻胶层接触。
b、接近式曝光(Proximity Printing)掩膜板与光刻胶层的略微分开,大约为10~50μm。
c、投影式曝光(Projection Printing)。在掩膜板与光刻胶之间使用透镜聚集光实现曝光。
d、步进式曝光(Stepper)
这里特别说一下投影式曝光的分类:
曝光中最重要的两个参数是:
1.曝光能量(Energy)
2.焦距(Focus)
如果能量和焦距调整不好,就不能得到要求的分辨率和大小的图形。表现为图形的关键尺寸超出要求的范围。
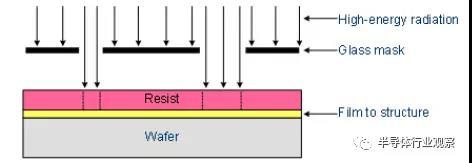












评论