无向量测试是测试高速I/O的最佳方法
大批量半导体芯片制造商必须解决以下这道难题,即如何经济高效地测试嵌入在大型数字系统级芯片设计中的多个多通道高速I/O接口(如PCI Express、HyperTransport和 Infiniband)。虽然结合了闭环操作的片上内置自测试(BIST)被广泛地用来替代昂贵的自动测试设备(ATE),但它仍具有高速模拟部分缺陷覆盖率不高的不足,而这将严重影响整体产品的质量。
本文引用地址:https://www.eepw.com.cn/article/193876.htm现在,出现了一种新兴的被称为“无向量测试”的方法,它同时拥有BIST和ATE两种方法的优势:即片上I/O BIST的经济高效性和基于ATE的信号完整性测量。特别是,该理念将ATE参数测试与片上测试内容生成和比较结合起来,从而形成了硅芯片与ATE设备之 间的良好协同,其结果是产生了一种嵌入在硅芯片中的可用于大批量制造测试的经济型优化解决方案。
传统的ATE架构由提供测试源向量的ATE和处理任务模式测试的线速向量组成。随着速率持续增加到超过每秒千兆位的门限,特别是对于高速I/O接口,在ATE上提供这一能力的成本在大批量制造环境中变得极具挑战性。
为了将对ATE测试的依赖性减到最小,很多芯片制造商正在使用片上BIST结构与闭环模式的组合。由于今天的硅工艺已达到很高的集成度,因此在硅片上适当占用一些面积是完全可以接受的。
不幸的是,BIST方法不能执行任务模式参数测试,而这对于高速I/O接口的集成来说却非常重要。在每秒几千兆位的速率上,不可能再将信号作为纯数字信号来处理。一些信号完整性参数(如时序抖动和噪声电平)都必须加以考虑以保持足够的缺陷覆盖率和满足所要求的质量水平。
融合两种方法的优势
无向量测试是一种利用ATE和BIST两种方法优势的更为协同的测试方法。借助这种方法,ATE可有效地作为BIST/回环中的环路扩展,测试人员无需再提供任务模式向量和线速比较,而只需负责进行信号完整性验证。
由于向量生成和线速比较能力传统上抬高了ATE测试通道的成本,因此这种双测试方法可为大批量制造提供一种更为经济的测试解决方案。
以下介绍其工作原理。片上BIST电路在所需的数据速率上提供测试内容,然后再根据闭环模式下的标准协议来测试这些内容。ATE则负责执行片上电路所难以完成的信号完整性测量。
参数测量的设置并不需要向量,因此这种测试方法被称为无向量参数测试。待测参数取决于应用,其范围可从简单的抖动生成、容限、接收灵敏度、直至像数据对时钟偏斜等更为复杂的参数。

那么这又对设计者产生那些影响呢?设计者现在只需在IC上创建一种机制,这种机制用来为芯片的功能验证和在ATE上进行的参 数测试提供测试内容。设计者必须通过一种给锁相环施加最大压力的“杀手级”图案(pattern)来产生最坏情况下的信号完整性条件。这种方法具有一个明 确的优势:即设计者可以利用与其用来设计SoC测试电路相同的技术,而毋需等待开发新的ATE技术。
闭环通道
对ATE来说,闭环通道可通过ATE中更为经济高效的回环通道卡来扩展,这可允许对所需的信号完整性参数实现独立向量测量, 以及允许对直流测量资源进行随意访问。这种回环通道卡可被配置用来测量像抖动这样的信号完整性参数,并允许测试工程师将这些参数反馈给接收机。这允许利用 同一块卡同时测量发射器信号完整性和接收器容限。
对成本敏感度更高的应用,可以只提供一种通过/失败这样的简单二元测试,以进一步降低ATE卡的成本。
实现低成本参数闭环测试解决方案的方式有多种,其中一些解决方案将抖动插入模块增加到“待测设计”(DUT)板中,但这些方法存在插入的抖动会随数据速率变化这种不利因素。
一种更为灵活的方法包括一个可调“数据眼”调节器,它允许实现独立的抖动及信号电平调整。
由于这不能通过DUT板上的无源器件来实现,因此ATE中的专用回环卡不失为一种合适的选择,它使得用户能对利用ATE软件打开的眼图进行编程。
将片上BIST与ATE辅助的回环测试结合在一起的协同方法,可实现比以往任何一种测试方法都更为有效的高速I/O接口测试解决方案。尽管它确实需要设计者去开发一些用来支持参数及逻辑测试的机制,但现有EDA能力可以很容易支持这些机制的创建。
BIST与ATE的结合可实现一种更为经济高效的大批量制造解决方案,这种方案可提供新型SoC芯片模拟测试所需的高缺陷覆盖率及质量水平。
Bernd Laquai是安捷伦科技公司计算与通信半导体测试研发部测试方法研究顾问。



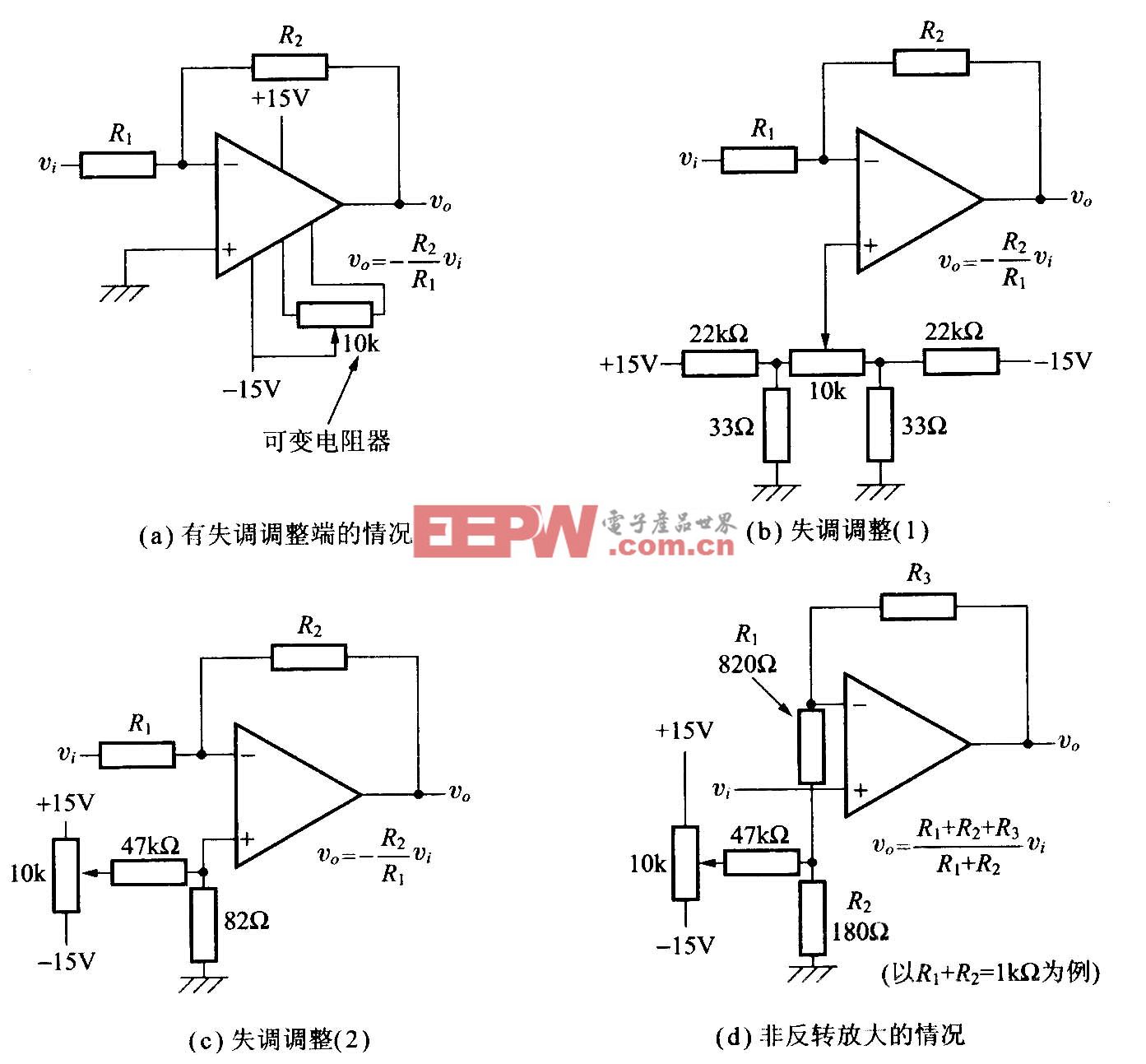




评论