AFM:应对65nm以下测量技术挑战
半导体工业目前已经进入65纳米及以下技术时代,关键特征通常为纳米级,如此小特征的制造工艺要求特殊的测量仪器,以便能够表征出纳米级几何尺寸,从而检验出任何偏离工艺规格中心值的情况,确保与设计规格保持一致。
本文引用地址:https://www.eepw.com.cn/article/193845.htm扫描探针显微镜(SPM)已经应用在纳米技术和纳米科学中,主要包括以结构、机械、磁性、形貌、电学、化学、 生物、工程等为基础的研究和工业应用。原子力显微镜(AFM)是以显微力感应为基础的SPM家族的一个分枝。工业用AFM是一种自动的,由菜单驱动的在线生产测量机台,自动的硅片操作、对准、探针操作、位置寻找、抓图和图像数据分析等测量都被编程在菜单中,最终输出测量数据。值得一提的是,AFM作为130纳米及以下技术结点中表征刻蚀和化学机械抛光(CMP)的尺寸测量的先进几何控制方法已经被广泛应用于半导体制造业,与半导体工业工艺技术类似,光掩膜和薄膜为主的工业也采用了AFM作为工艺测量方法。
AFM可以测量表面形貌、3D尺寸和几何形状,水平表面轮廓和垂直侧壁形状轮廓。测量区域可以在很小(50μm)或很长(10cm)的范围内。采用小比例AFM模式,可测量的变量有高度或深度、线宽、线宽变化、线边缘粗糙度、间距、侧壁角度、侧壁粗糙度、横截面轮廓、和表面粗糙度。在长范围(Profiler模式),AFM用于CMP工艺总体表面形貌轮廓的测量。
AFM测量的优点
除AFM以外,CD SEM、横截面SEM(X-SEM), TEM、Dual Beam、光学散射测量、光学轮廓仪和探针轮廓仪均为已有的表征和监控工艺尺寸的测量方法。通常认为最值得信任的3D尺寸分析方法应该是X-SEM或TEM,但是X-SEM或TEM的主要障碍是样品制备、机台操作、时间以及费用。X-SEM和TEM会破坏硅片,并且只能一次性的切入特征区域。TEM不能在光刻胶上工作。CD SEM会导致光刻胶吸收电荷、收缩、甚至损伤光刻胶, CD SEM几乎无法提供3D形状信息。光学散射测量具有快速和准确的特点,但是只能在特殊设计的结构上工作,并且无法提供LER和LWR数据。为特定的薄膜结构发展一套可靠的散射测量数据库通常是非常困难并且耗时的。空间分辨率和光斑尺寸会限制X射线、光学厚度、或形貌测定仪器的应用。
由于AFM的独特特性,使得它与其它测量技术相比具有更明显的优势。AFM可以在非真空环境中工作。它是一种表面力感应的显微镜,所以它可以提供非破坏性的,直接的3D测量,胜于模拟、 模型、或者推断。AFM可以快速的检查横截面轮廓或表面形貌,以便检测出尺寸是否在规格内,而不需像TEM一样破坏制品。AFM没有光斑尺寸限制,并且在CMP平坦化应用方面,它比光学或探针轮廓仪具有更高的分辨率。
AFM可以在线测量当今纳米电子工业中的任何材料样品,不管其薄膜层结构、光学特性或是组成。AFM对于最新的先进工艺和材料集成中涌现出来的新材料(SiGe、高K、金属栅和低K)并不敏感。电路图案的逼真度和尺寸取决于其附近的环境。然而,AFM测量与特征接近度或图形密度效应之间没有偏差,这些都是ITRS2005测量部分所列出的重要要求。因此,AFM在世界半导体工业赢得了广泛应用,并且其在130纳米及更小尺寸中的应用正在增加。在应用目的方面,AFM可以被用为在线监控深度、CD和轮廓,取代TEM进行横截面轮廓的工程分析,是在线散射测量和CD校准以及追踪的极好的参考。表1为自动AFM测量的典型应用。
操作原理
在一个反馈控制回路中,AFM扫描仪控制一个微小探针在X(或Y)和Z方向进行扫描,在探针和样品表面间保持紧密的接近,从而获得所有XY和Z方向的高分辨率方位数据,如图1所示。

3D形貌的原始数据是由x/y/z空间数据构造而来的。然后,离线的软件分析使探头形状不再环绕AFM图像并且提取出测量目标相关的重要几何参数, 如深度、 特定区域顶部/中间/底部的线宽、 侧壁角度和轮廓形状、 或表面形貌。
STI刻蚀
浅沟槽隔离(STI)是逻辑、 DRAM和Flash等硅器件中的一种普通工艺。STI形成晶体管中的活性硅区域和隔离氧化物区域。AFM在STI刻蚀深度、线宽、CD和侧壁轮廓测量方面有着独特的应用。图2展示了与TEM横截面相比典型的AFM轮廓。从比较中可以说明,AFM在表征窄深的STI沟槽全3D几何形状方面取代了冗长和高耗费的TEM,STI沟槽在活性硅区域顶部通常有一层氮化物作为硬掩膜,CD SEM通常很难准确测量从氮化物到硅转换区域的硅的CD。高分辨率的AFM可以扫描出这个转换点,可以在转换位置编程出图象分析,从而计算氮化物底部CD和硅顶部的CD。AFM可以对整片硅片进行快速非破坏性的描绘,而X-SEM和TEM是无法做到的。沟槽侧壁角度(SWA)的微小变化会引起最终图形特征上线宽的巨大变化,AFM为高深宽比的STI沟槽提供了非破坏性及高精度的SWA表征。

STI CMP
STI模块进行化学机械抛光(CMP)和湿法氮化物去除以后,产生了多样化的表面以及在活性区域及附近场氧化物区域的高度差(图3)。硅片内实际电路区域的局部形貌变化是一个非常关键的参数。晶体管电学失效与较大的或反向的活性硅与场氧化物之间的步高差相关,CMP形貌取决于特征尺寸和图形密度。然而,芯片内不同特征之间的步高相关性很差,这再一次证明了传统的椭偏法和散射测量法在测量划片区域里大块的测试结构以反映芯片内真实的电路形貌时已存在不足。AFM是一种在线测量技术,可以在任何需要的测试点进行快速的和非破坏性的芯片内形貌监控。

AFM可以检测和测量出由于硅片边缘不均匀的抛光速率造成的反向的硅/氧化物步高(图4),图4展示了氮化物去除后活性区域和隔离区域交界处氧化物的转换,以及何种转换会影响晶体管的阈值电压。AFM对转换轮廓非常敏感,并且转换深度可以得到监控。



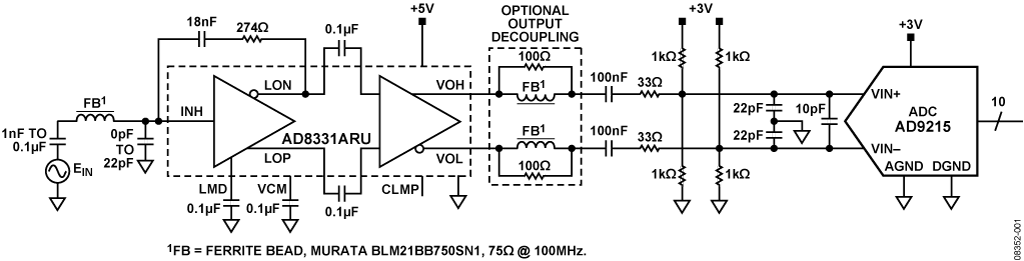




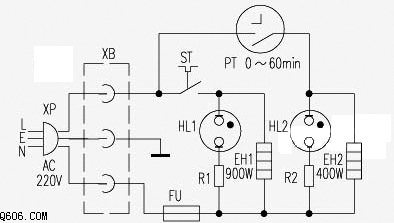

评论