集成电路封装的可靠性提高方法研究
1 前言
本文引用地址:https://www.eepw.com.cn/article/193504.htm随着集成电路的发展,小型化与多功能成了大家共同追求的目标,这不仅加速了IC设计的发展,也促进了IC封装设计的发展。IC封装设计也可以在一定程度上提高产品的集成度,同时也对产品的可靠性起着很重要的影响作用。本文总结和研究了一些封装工艺中提高可靠性的方法。
2 引线框架
引线框架的主要功能是芯片的载体,用于将芯片的I/O引出。在引线框架的设计过程中,需要考虑几个因素。
2.1 与塑封料的粘结性
引线框架与塑封料之间的粘结强度高,产品的气密性更佳,可靠性更高;与塑封料的粘结性不好,会导致分层及其他形式的失效。影响粘结强度的因素除了塑封料的性能之外,引线框架的设计也可以起到增强粘结强度的作用,如在引脚和基岛边缘或背面设计图案,如图1所示。

图1 各种增强型框架
2.2 芯片与引脚之间的连接
引线框架的最重要的功能是芯片与外界之间的载体,因此,引线框架应设计得利于芯片与引脚之间的连接,要考虑线弧的长度以及弧度。
2.3 考虑塑封料在型腔内的流动
对于多芯片类的复杂设计,还应考虑塑封时塑封料在芯片与芯片或芯片与模具之间的流动性。
3 焊线
3.1 增强焊线强度
焊线强度除了焊点处的结合强度外,线弧的形状也会对焊线强度有一定的影响。
增强焊线强度的方法之一是在焊线第二点种球,有BSOB和BBOS两种方式。如图2所示。

图2 BSOB和BBOS的示意图
BSOB的方法是先在焊线的第二点种球,然后再将第二点压在焊球上;BBOS的方法是在焊线的第二点上再压一个焊球。两种方法均能增强焊线强度,经试验,BBOS略强于BSOB。BBOS还应用于die todie(芯片与芯片)之间的焊接,如图3所示。

图3 BBOS用于叠晶及芯片与芯片之间焊接的情况
3.2 降低线弧高度
现在的封装都向更薄更小发展,对芯片厚度、胶水厚度和线弧高度都有严格控制。一般弧度的线弧,弧高(芯片表面至线弧最高点的距离)一般不低于100μm,要形成更低的线弧,有以下两种方法。RB(Reverse BONding反向焊接)和FFB(FoldedForward Bonding折叠焊接 ),如图4和图5所示。

图4 反向焊接(RB)

图5 折叠正向焊接(FFB)
反向焊接虽然可以形成低的线弧,但是种球形成了大的焊球,使得焊线间距受到限制。折叠正向焊接方法是继反向焊接之后开发的用于低线弧的焊接方法,如图5所示。
低线弧不仅能够满足塑封体厚度更薄的要求,还能减少塑封时的冲丝以及线弧的摆动(wiresweep),对增加封装可靠性有一定的帮助。
隔离器相关文章:隔离器原理








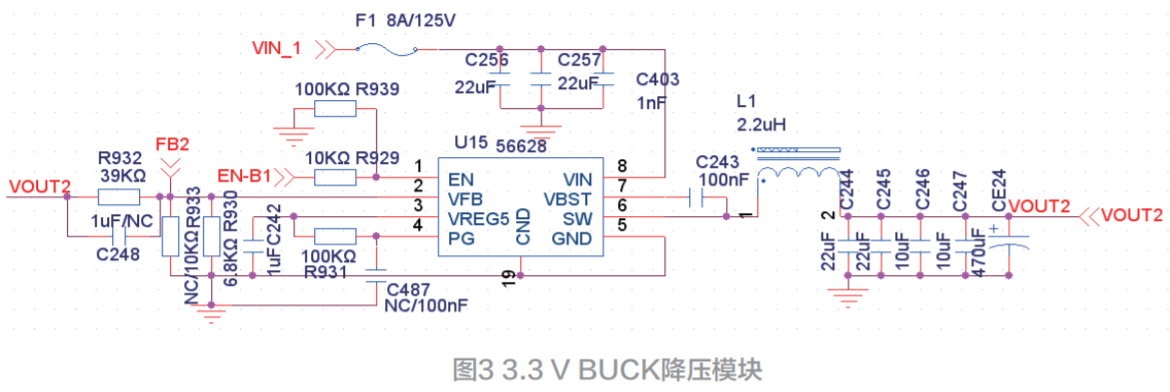

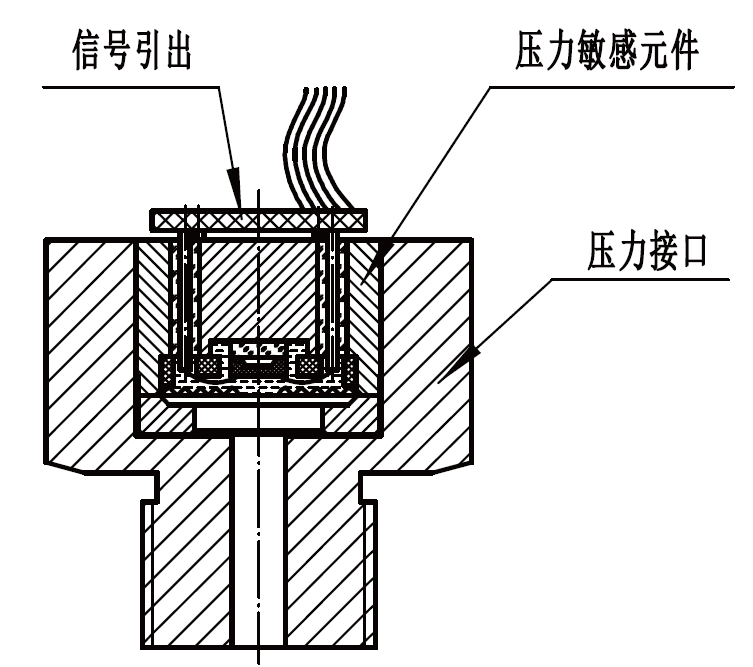

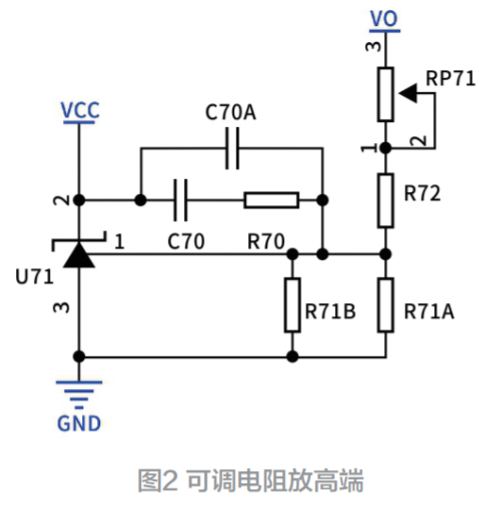
评论