对使用新型测试技术和仪器的几点忠告
随着半导体制造商向65纳米技术转移并展望更小节点,严峻的测试挑战也开始浮出水面。现在,工艺开发工程师们必须放弃由硅、二氧化硅、多晶硅和铝材料构成的良性世界,而将自己置于由硅锗(SiGe)、绝缘体上硅(SOI)、亚硝酸铪(HfNO2)、金属栅、低k和铜材料构成的充满挑战的世界中。这些新材料对工艺和器件特性提出了新的测试要求,其中一些关键的应用包括先进的高k栅测试、晶圆上射频s参数测试、SOI基底的等温直流和射频测试,以及低至千万亿分之一安培(fA)水平的泄漏电流测试。
本文引用地址:https://www.eepw.com.cn/article/192977.htm因此,传统的直流测试方法已经无法再为器件的性能和可靠性提供准确的模型。现在,从建模到制造整个过程都需要进行正确的RF和脉冲测试,包括确定栅介质可靠性、高频电容值、铜过孔可靠性和RF性能等测试。各种测试方法正在改变I-V特性、RF电容-电压测试、s参数、NBTI、TDDB、 HCI、SILC和电荷泵(CP)。
这些新的方法呼唤能够以更快速度完成测试的新型仪器和软件。同时,还必须以某种方式建立测试,以缩短产品上市时间并确保其长期可靠性。
应该采用的方式
* 应该更多地进行晶圆上(on-wa fer)测量,以便在前端线(FEOL光阻去除创新解决方案问世,可缩短工艺流程FEOL)工艺中揭示问题。一个关键的FEOL评估任务就是建立与特定工艺有关的产品可靠性,特别是对那些包含新异材料的工艺。
* 应该寻求面向先进CMOS技术的测试设备和技术。例如,利用更好的方法刻画热应力松弛过程中的过孔应力迁移(VSM),以便在50小时等温测试的3/4时间内都获得良好结果。这种新技术通过在最大蔓延速率范围内的温度循环和跟踪较小阻抗偏移来改进故障统计结果。在FEOL进行的参数测试可能会继金属测试之后完成,从而将工艺控制反馈时间缩短50%或更多。
* 应该进行脉冲型直流应力测试,以便获得更多样的数据,并在频率制约电路中获取更易理解的动态现象和器件性能。特别的是,短脉冲测试可以克服栅极泄漏,并在电荷捕获(CT)测量中提供界面捕获密度的准确图像。
* 应该选择具有短脉冲能力的测试系统和包含较新测试方法的软件。这些系统应该有能力在不使用开关矩阵的情况下,对少量引脚提供直流信号和上升时间在纳秒级的脉冲信号支持。
* 应该选择专为大吞吐量射频测试设计的参数测试系统。它们与老式系统有着天壤之别,后者的设计目的主要是面向直流I-V和C-V测量,之后才重新改进用于 RF。新设计可以快速、准确,并重复地提取RF参数,易操作性直逼直流测试,甚至还可以同时进行精确的直流和射频测试。
应该避免的方式
* 不要将测试方式限定为静态直流测试。为了获得准确的CT测试结果,需要进行交流和脉冲直流测试以便限定高k栅电介质。电荷泵等动态应力测量技术,在描述与NBTI、TDDB、HCI和SILC有关的可靠性问题时也是有价值的。
* 不要回避晶圆级的RF参数测试。晶圆公司现在不得不承认,在构建先进IC的过程中,射频s参数的测量至关重要。随着行业转向65纳米或更精密节点,在1到40GHz频率下提取正确的RF参数已经成为RF紧凑模型(compact model)验证的关键。
* 不要过于依赖线端(end-of-line)可靠性测试。测试已封装的器件会对揭示可靠性问题带来障碍,还会造成成本大幅增加以及出货时间高达三周的延迟(与封装有关)。
* 不要墨守陈规,只进行老测试、使用老方法、利用陈旧的测试系统设计。例如,从铝到铜的金属材料改变,在过孔应力迁移和参数化晶圆探测原型等领域,为新测试需要和新测试可能性开启了大门。
* 不要对参数测试和功能测试使用相同的组织和报告结构,因为从经济角度而言两者大不相同。参数测试使用了一种采样策略进行工艺控制和良品率改进,但需要分别进行评价。例如,在一个参数测试单元中的设备通常可以广泛复用,在5个或更多的工艺节点上达到高达85%的复用率。

图1:静态直流测量已无法满足高k电介质要求,需要采用交流和脉冲直流测试来描述电荷捕获效应。
1. 在信号上升之前执行“去捕获(detrap)”,清除界面电荷
2. 上跟踪(up-trace)捕获
3. 在晶体管导通状态下的电荷捕获
4. 下跟踪(down-trace)捕获
5. 资料来源: 美国吉时利仪器公司




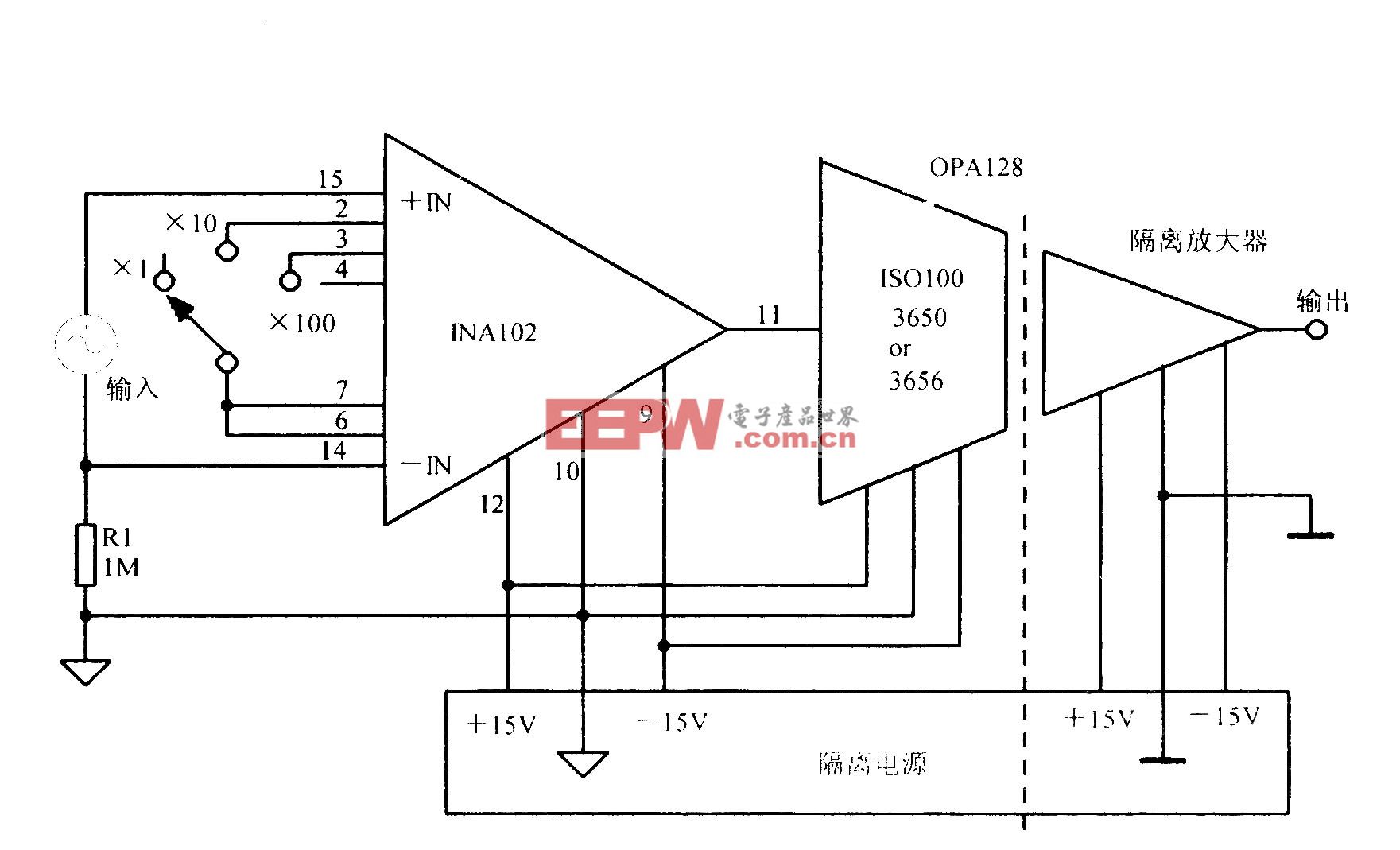


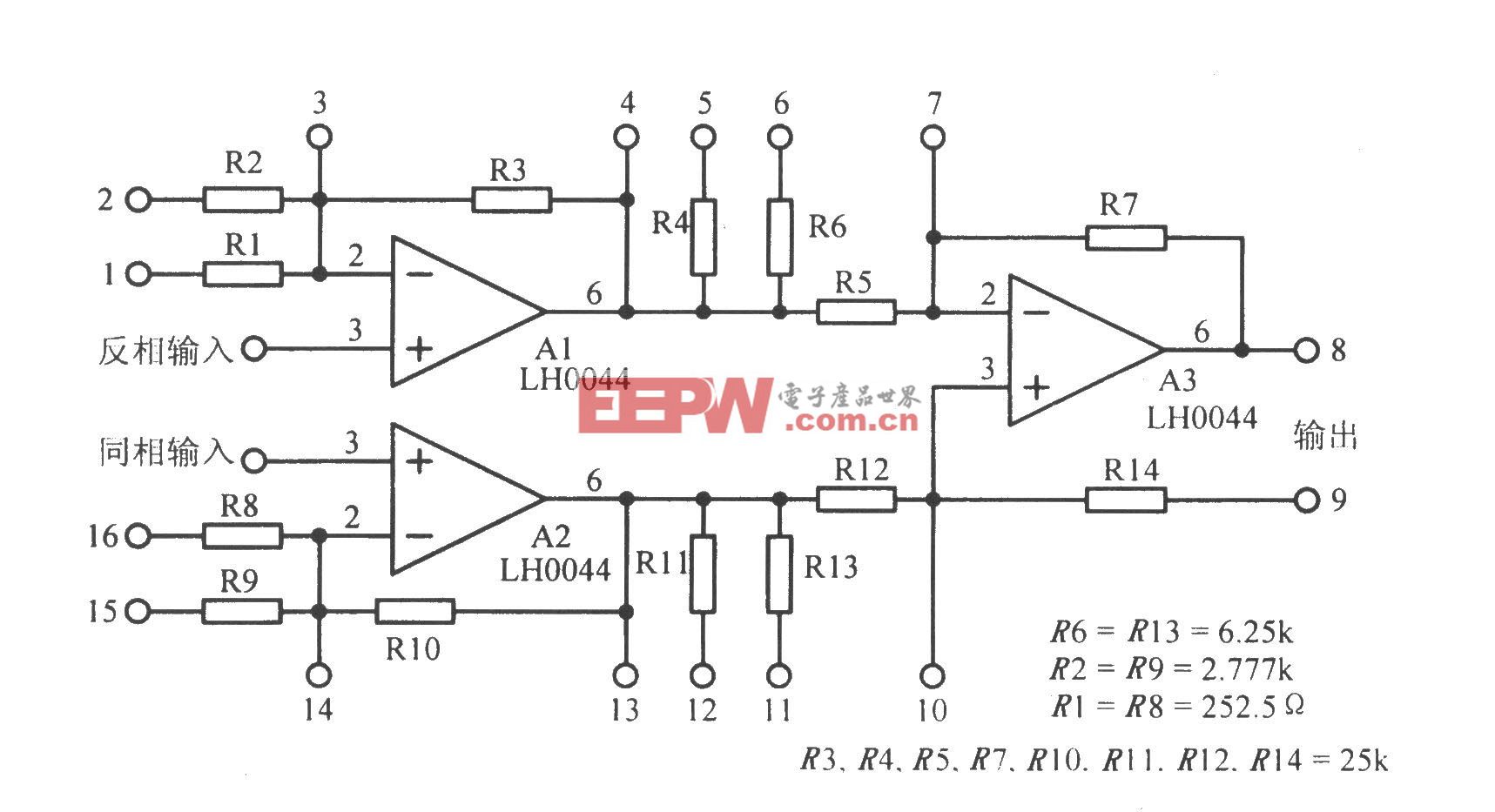
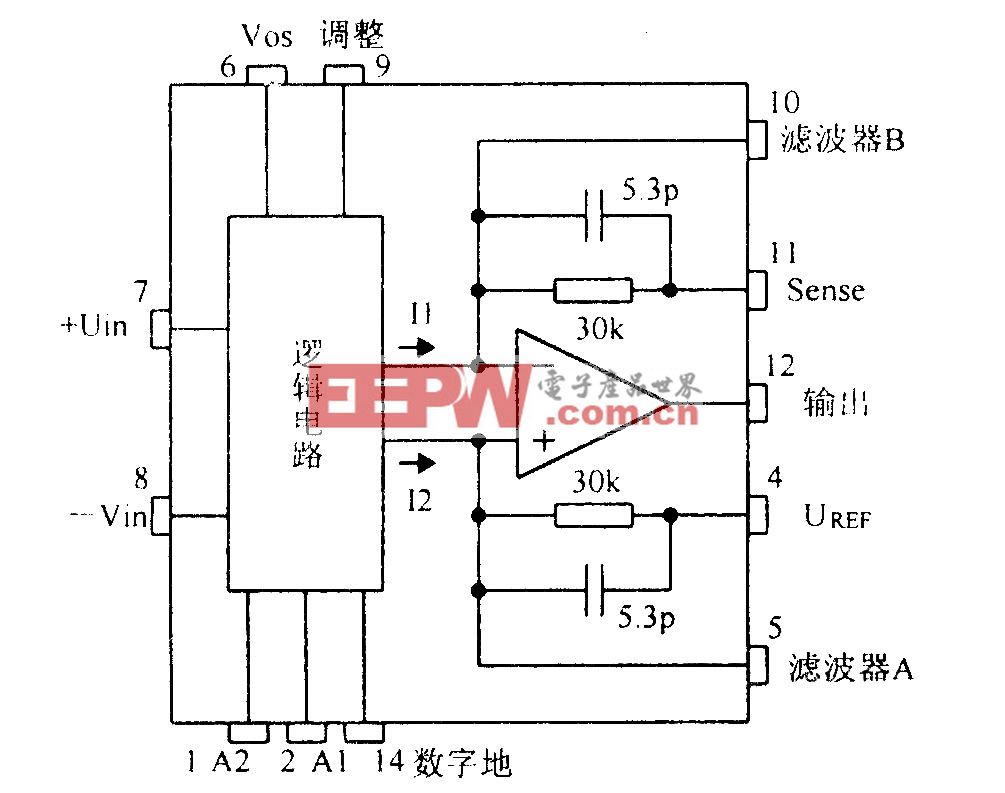
评论