SiP封装技术简介
电子工程的发展方向,是由一个「组件」(如IC)的开发,进入到集结「多个组件」(如多个IC组合成系统)的阶段,再随着产品效能与轻薄短小的需求带动下,迈向「整合」的阶段。在此发展方向的引导下,便形成了现今电子产业上相关的两大主流:系统单芯片(System on Chip;SoC)与系统化封装(System in a Package;SiP)。
由发展的精神来看,SoC与SiP是极为相似的;两者均希望将一个包含逻辑组件、内存组件,甚至包含被动组件的「系统」,整合在一个单位中。然而就发展的方向来说,两者却是大大的不同:SoC是站在设计的角度出发,目的在将一个系统所需的组件,整合于一芯片上;而SiP则是由封装的立场发展,将不同功能的芯片整合于一电子构装中。
在未来电子产品在体积、处理速度或电性特性各方面的需求考量下,SoC确为未来电子产品设计的关键与发展方向。但SoC发展至今,除了面临诸如技术瓶颈高、CMOS、DRAM、GaAs、SiGe等不同制程整合不易、生产良率低等技术挑战尚待克服外,现阶段SoC生产成本高,以及其所需研发时间过长等因素,都造成SoC的发展面临瓶颈,也造就SiP的发展方向再次受到广泛地讨论与看好。
SiP封装并无一定型态,就芯片的排列方式而言,SiP可为多芯片模块(Multi-chip Module;MCM)的平面式2D封装,也可再利用3D封装的结构,以有效缩减封装面积;而其内部接合技术可以是单纯的打线接合(Wire Bonding),亦可使用覆晶接合(Flip Chip),但也可二者混用(参见图一)。 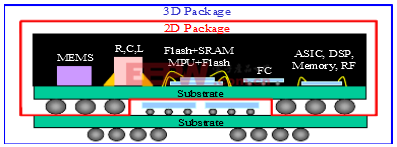
资料来源:钜景科技;工研院IEK-ITIS计画(2003/06)
图一 SiP封装架构图
除了2D与3D的封装结构外,另一种以多功能性基板整合组件的方式,也可纳入SiP的涵盖范围。图二说明了由三洋电机所发展的ISB(Integrated System in Board)的概念,此技术主要是将不同组件内藏于多功能基板中,亦可视为是SiP的概念,达到功能整合的目的。

资料来源:三洋电机;工研院IEK-ITIS计画(2003/06)
图二 多功能基板—ISB架构图
不同的芯片排列方式,与不同的内部接合技术搭配,使SiP的封装型态产生多样化的组合,并可依照客户或产品的需求加以客制化或弹性生产。
SiP封装可将其它如被动组件,以及天线等系统所需的组件整合于单一构装中,使其更具完整的系统功能。由应用产品的观点来看,SiP更适用于低成本、小面积、高频高速,以及生产周期短的电子产品上,尤其如功率放大器(PA)、全球定位系统、蓝芽模块(Bluetooth)、影像感测模块、记忆卡等可携式产品市场。以长远的发展规划而言,SoC的发展将能有效改善未来电子产品的效能要求,而其所适用之封装型态,也将以能提供更好效能之覆晶技术为发展主轴;相较于SoC的发展,SiP则将更适用于成本敏感性高的通讯用及消费性产品市场。
pa相关文章:pa是什么








评论