MEMS压力传感器结构及其工作原理
目前的MEMS压力传感器有硅压阻式压力传感器和硅电容式压力传感器,两者都是在硅片上生成的微机械电子传感器。
本文引用地址:https://www.eepw.com.cn/article/160127.htm硅压阻式压力传感器是采用高精密半导体电阻应变片组成惠斯顿电桥作为力电变换测量电路的,具有较高的测量精度、较低的功耗和极低的成本。惠斯顿电桥的压阻式传感器,如无压力变化,其输出为零,几乎不耗电。
MEMS硅压阻式压力传感器采用周边固定的圆形应力杯硅薄膜内壁,采用MEMS技术直接将四个高精密半导体应变片刻制在其表面应力最大处,组成惠斯顿测量电桥,作为力电变换测量电路,将压力这个物理量直接变换成电量,其测量精度能达0.01-0.03%FS。硅压阻式压力传感器上下二层是玻璃体,中间是硅片,硅片中部做成一应力杯,其应力硅薄膜上部有一真空腔,使之成为一个典型的绝压压力传感器。应力硅薄膜与真空腔接触这一面经光刻生成电阻应变片电桥电路。当外面的压力经引压腔进入传感器应力杯中,应力硅薄膜会因受外力作用而微微向上鼓起,发生弹性变形,四个电阻应变片因此而发生电阻变化,破坏原先的惠斯顿电桥电路平衡,电桥输出与压力成正比的电压信号。
电容式压力传感器利用MEMS技术在硅片上制造出横隔栅状,上下二根横隔栅成为一组电容式压力传感器,上横隔栅受压力作用向下位移,改变了上下二根横隔栅的间距,也就改变了板间电容量的大小,即△压力=△电容量。




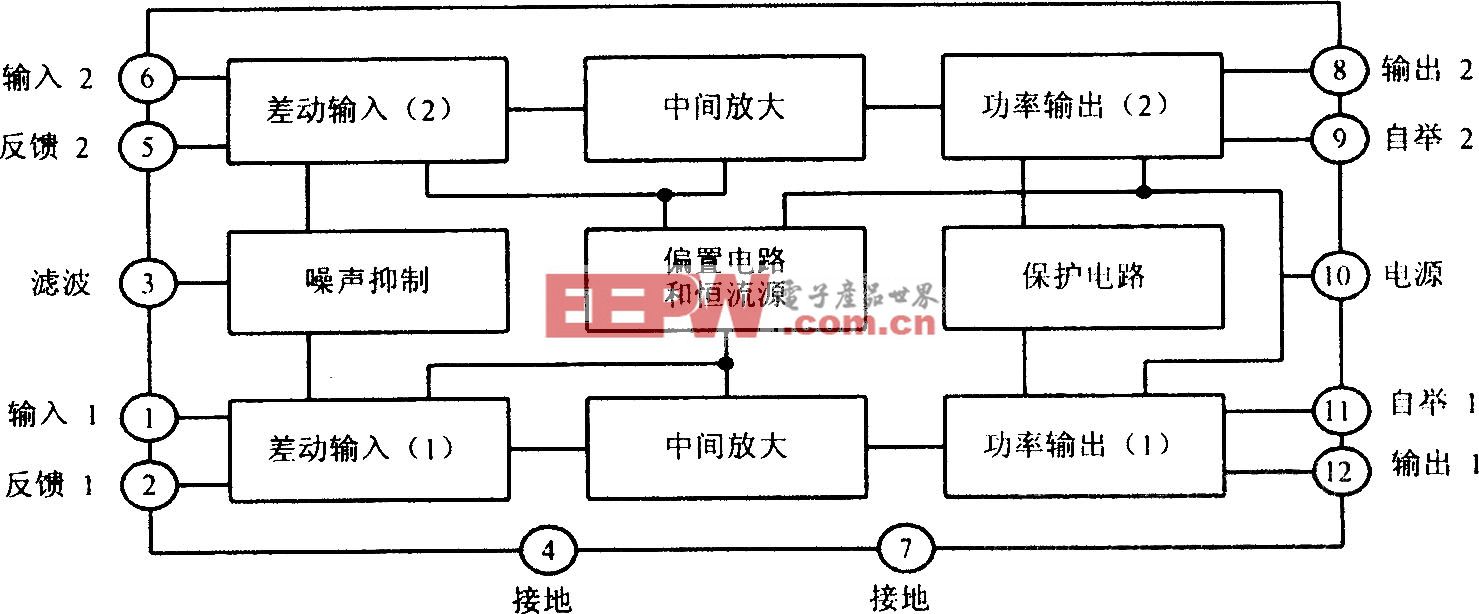


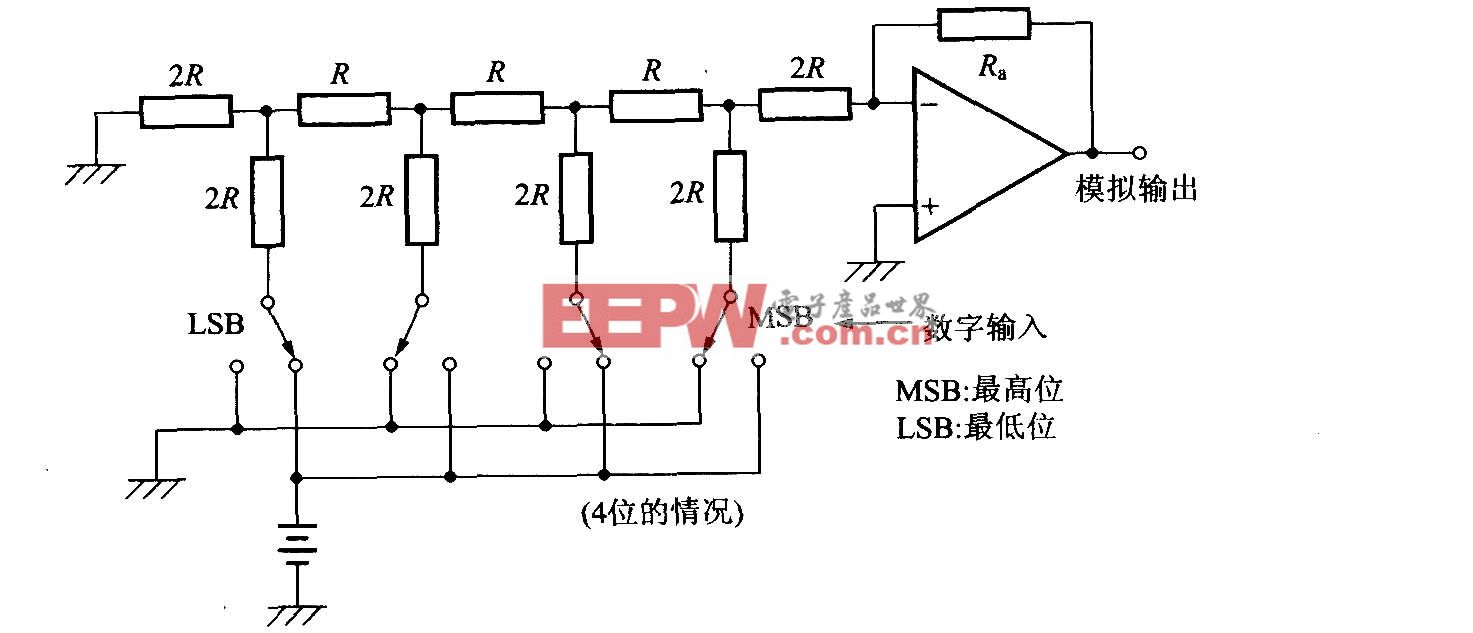



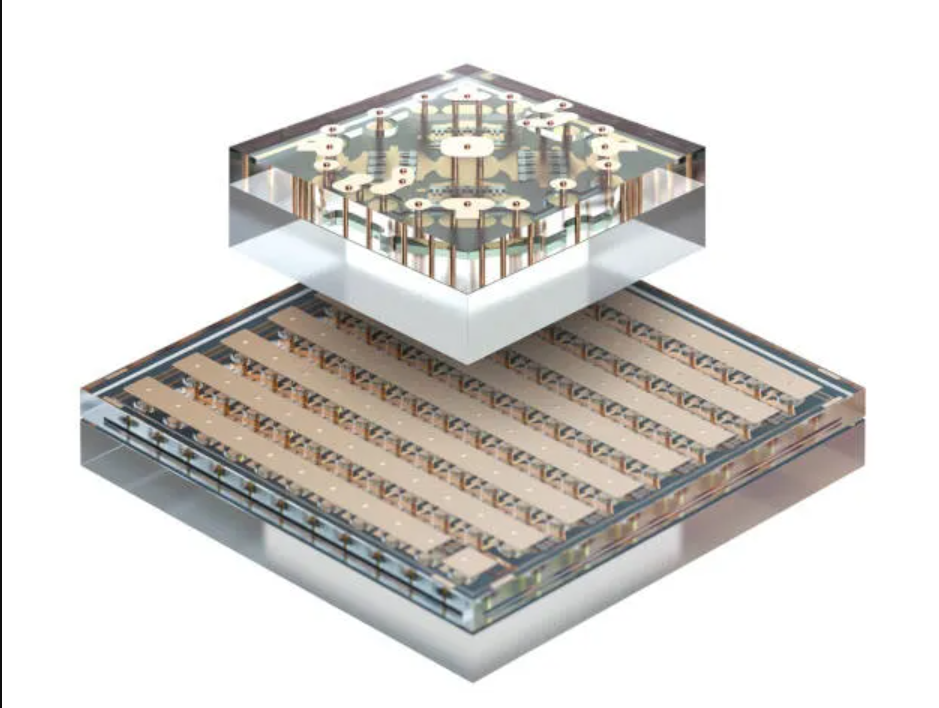



评论