IC智能卡失效机理分析
IC智能卡作为信息时代的新型高技术存储产品,具有容量大、保密性强以及携带方便等优点,被广泛应用于社会生活的各个领域。通常所说的IC卡,是把含有非挥发存储单元NVM或集成有微控制器MCU等的IC芯片嵌装于塑料基片而成,主要包括塑料基片(有或没有磁条)、接触面、IC芯片3个部分。传统的IC卡制作工序为:对测试、信息写入后的硅晶圆片进行减薄、划片,分离成小芯片,再经装片、引线键合、包封等工序制成IC卡模块,最后嵌入IC卡塑料基板。
随着IC产品制造工艺的提高以及高性能LSI的涌现,IC智能卡不断向功能多样化、智能化的方向发展,以满足人们对方便、迅捷的追求。然而使用过程中出现的密码校验错误、数据丢失、数据写入出错、乱码、全“0”全“F”等诸多失效问题,严重影响了IC卡的广泛应用。因此,有必要结合IC卡的制作工艺及使用环境对失效的IC卡进行分析,深入研究其失效模式及失效机理,探索引起失效的根本原因,以便采取相应的措施,改进IC卡的质量和性能1。
由IC卡失效样品的分析实例发现,芯片碎裂、内连引线脱落(脱焊、虚焊等)、芯片电路击穿等现象是引起IC卡失效的主要原因,本文着重对IC卡芯片碎裂、键合失效模式及机理进行研究和讨论,并简略介绍其他失效模式。
1 芯片碎裂引起的失效
由于IC卡使用薄/超薄芯片,芯片碎裂是导致其失效的主要原因,约占失效总数的一半以上,主要表现为IC卡数据写入错、乱码、全“0”全“F”。
对不同公司提供的1739张失效IC卡进行电学测试,选取其中失效模式为全“0”全“F”的100个样品进行IC卡的正、背面腐蚀开封,光学显微镜(OM)观察发现裂纹形状多为“十”字、“T”字型,亦有部分为贯穿芯片的单条裂纹,并在顶针作用点处略有弯折,如图1。碎裂芯片中的裂纹50%以上,位于芯片中央附近并垂直于边缘;其余芯片的裂纹靠近芯片边缘或集中于芯片。
图2 芯片背面研磨损伤的OM照片
1.1 硅片减薄
标准的硅片背面减薄工艺包括贴片、磨片(粗磨、细磨)、腐蚀三道工序。常用的机械磨削法不可避免地会造成硅片表面和亚表面的损伤(图2),表面损伤分为3层:有微裂纹分布的非晶层;较深的晶格位错层;弹性变形层。粗磨、细磨后,硅片背面仍留有深度为15~20μm、存在微损伤及微裂纹的薄层,极大影响了硅片的强度。因此,需要用腐蚀法来去除硅片背面残留的晶格损伤层,避免硅片因残余应力而发生碎裂。实验发现原始厚度为725μm的硅片,经磨片后,腐蚀深度约为25μm时可得到最大的强度值3;同时,分析表明,芯片在键合与测试时发生碎裂,往往是由于磨片时造成的损伤在随后的腐蚀或化学机械抛光中没有被完全去除而引起的。
磨片过程不仅会造成硅片背面的微裂纹,且表面的残余应力还会引起硅片翘曲。硅片的背面减薄工芯对芯片碎裂有着直接的影响,因此需要开发新技术,实现背面减薄工艺集成,以提高硅片减薄的效率,减少芯片的碎裂。
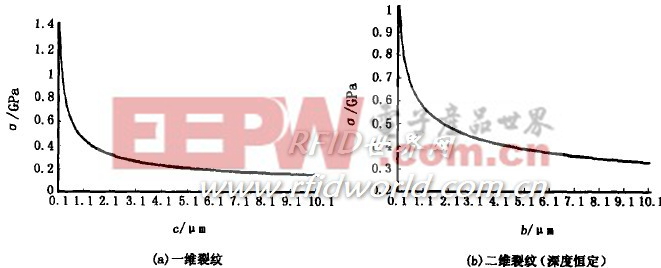

1.3 模块工艺
模块工艺包括装片、包封等工序)的装片过程中,装片机顶针从贴片膜上顶起芯片,由真空吸头吸起芯片,将其粘结到芯片卡的引线框上。若装片机工艺参数调整不当,亦会造成芯片背面损伤,严重影响芯片强度:如顶针顶力不均或过大,导致顶针刺穿蓝膜而直接作用于芯片,在芯片背面留有圆型损伤坑;或顶针在芯片背面有一定量的平等滑移过程,留下较大面积的划痕,此现象在碎裂芯片中占了相当比例。







评论