BGA开路检测:面向测试的设计方法
球栅列阵封装的日益发展和流行给制造商和设备供应商不断带来了新的挑战。由于隐藏焊点数量高,通过视觉检测或者电气检测无法检测缺陷,因此需要使用其它检测技术。
特别是BGA开路正在成为当前复杂的PCBA检测中最关键的缺陷类型之一。开路是视觉检测系统的一个常见问题。尽管X光可以“看到”焊点的直径差异,但通常很难检测出这些差异是否明显,即确定什么时候这些差异是真正的开路,什么时候属于制造流程正常变化。
欧洲一家大型电子签约制造商Selcom集团,十年前率先使用3D自动X光检测,在复杂电路板制造上改进流程控制和缺陷检测能力。BGA的日益流行给Selcom带来了新的挑战。他们决定在一个独特的研究中,把焊盘设计中面向测试设计方法与使用Open Outlier专利的自动X光检测技术相结合以解决这个问题。
Selcom面向测试的设计理念是改变焊盘形状,以便在回流焊过程中当与焊盘发生接触时,焊点形成一个形状,而当没有发生接触时,又会出现另一个明显不同的形状。在椭圆形焊盘中,焊锡在发生接触时会产生一个椭圆形状,而在没有发生接触时会保持圆形。维修人员便可以简便地区分良好的(椭圆形)焊点和开路(圆形)
焊点,并由此可以从X光系统中迅速检测出缺陷焊点(见图)。
图中,焊接良好时焊盘会形成椭圆形。若不发生接触,焊盘仍将保持圆形。通过采用Open Outlier专利技术的3D自动X光检测技术,维修人员只需在一系列椭圆中查找圆形,就可以简单地确定开路。
但是,在设计测试焊盘时需要考虑几个细节。一是焊点的强度和耐用性。焊点的强度取决于焊盘的尺寸。如果焊盘太小,那么会损害绝对强度,并且降低焊点的完整性。二是电路板空间影响着适应电路板上的通孔、铜箔和测试点的能力。如果焊盘太大,那么会影响电路板设计。最后,如果椭圆度太小,那么椭圆焊盘将更难与圆形开路焊点区分开来,由此损害系统精度,同时可能会提高测试误报率。
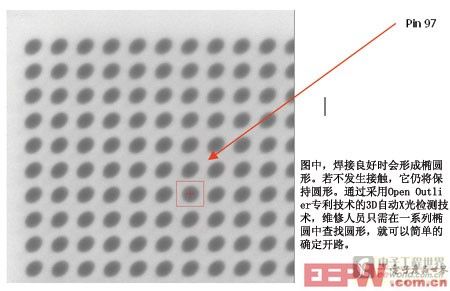
Selcom在使用椭圆焊盘和非椭圆焊盘的情况下测试了各种器件类型。研究结果表明,椭圆焊盘进一步扩大了自动X光检测的精度,特别是当3D自动X光和BGA Open Outlier专利技术结合使用时。圆形BGA焊盘缺陷检测率对于各种BGA达到了79%~90%。当对相同BGA设计了椭圆焊盘之后,缺陷检测率提高到93%~100%!
这是面向测试的设计研究工作,目的是在受控的环境下比较不同解决方案,并评估其在生产环境中的潜在应用。在测试效果、X光缺陷检测功能和维修效果方面的结果,预示了极具前景的BGA开路检测的新方法。您也可以考虑进行类似研究,以查看面向测试的设计和检测是如何影响及明显改善BGA开路缺陷检测功能。





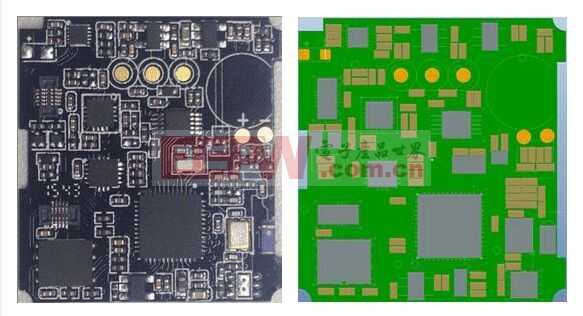
评论