斥资 2.75 亿美元,Disco将建造芯片制造工具工厂
芯片制造设备制造商 Disco 将在广岛县建造一家工厂,生产用于加工晶圆的组件,希望抓住客户加紧生产的需求。位于吴市的新工厂将生产用于切割、研磨和抛光工艺的切割轮,到 2035 年,该公司的产能将提高 14 倍。
Disco 预计投资略高于 400 亿日元(2.76 亿美元),计划最早于 2025 年开始建设。首席执行官 Kazuma Sekiya 表示:「我们将采取先发制人的措施,以实现预期的需求增长。」
Disco 在切割、研磨和抛光机器方面拥有全球最大的市场份额。安装在机器中的切割轮高速旋转以处理形成电路的基板。该装置由钻石制成,磨损后需要更换。Disco 在广岛县和长野县拥有两家生产切割轮的工厂。
Disco 去年在吴市购买了其现有工厂旁边的一块相邻地块,计划到 2035 年左右建造 3 个设施。现有工厂的设备将搬到新建筑中。
据贸易组织 SEMI 称,在人工智能和 5G 通信格式相关需求的推动下,全球半导体市场预计到 2030 年将翻一番,达到 1 万亿美元,是 2023 年的两倍。
对于设备制造商来说,替换零件可以带来高利润并带来稳定的收入。Disco 报告称,截至 2023 年 3 月的财年销售额达到创纪录的 2841 亿日元,其中切割轮等替换零件占 20%。过去 10 年,替换零件的销量增长了两倍。
半导体市场每三到四年就会经历一次所谓的市场起起落落的硅周期。即使芯片制造商在经济低迷时期控制投资,他们也会继续购买替换零件。
台积电 3D 封装缺他不可
日本半导体制造设备制造商迪思科 (Disco) 已是全球首屈一指的电子零件研磨、切割、抛光大厂,这家二战前就成立的老牌公司表示,手中握有台积电制程不可或缺的「3D 封装」技术关键,目前设备进入实际应用阶段,将活跃于下个世代手机与尖端电脑中。
迪思科成立于 1937 年,已有超过 80 年历史,原本生产机械用砂轮机,如今在半导体电子零件研磨、切割、抛光领域排名世界第一。该公司生产的设备现在可以把矽晶圆研磨到近乎透明的薄度,或是能把发尖切割成 35 等分。
迪思科的技术可以让晶片制造商堆叠 IC,这种技术称为 3D 封装,号称可以减少耗能和晶片生产碳足迹,并增加不同零件间的频宽。社长关夫一马受访时说:「想像把你要干净俐落地把一块可颂面包对切切开,这需要使用特殊刀具,由精湛的工艺打造而成。」
麦格理集团分析师 Damian Thong 说:「迪思科的成长速度是半导体产佑的两倍,因为业界对精密和切割设备的需求很大。」过去 40 年来,迪思科开发出各种切割工具,站在 3D 封装商机的前端。
目前,DISCO 在晶圆切割和研磨机领域市场份额高达 70-80%,公司市值在 2023 年增长三倍,并且研发支出创下了 250 亿日元(约合 1.75 亿美元)的新高。SiC 晶圆切割设备已成为 DISCO 当前重点业务之一。
2023 年 4 月据日媒报道,因功率半导体需求扩大、已有产能持续满载,DISCO 当时将已有工厂产能持续全开,并计划在未来十年内将产能扩大到当时的 3 倍。
DISCO 计划在今后 10 年内将切割/研磨芯片、电子零件材料的制造设备产能一口气提高至现行的约 3 倍,将对预计兴建于广岛县吴市的新工厂投资 800 亿日元(约合人民币 40.9 亿元),视需求动向将分 3 期工程依序扩增产能。
DISCO 于 2023 年 12 月推出全新的 SiC(碳化硅)切割设备,可将碳化硅晶圆的切割速度提高 10 倍,首批产品已交付客户。由于碳化硅的硬度仅次于金刚石和碳化硼,硬度是硅的 1.8 倍,因此切割难度较大。
2023 年 7 月,DISCO 宣布在日本熊本县建立一个「中间工艺研发中心」,按照 DISCO 的定义,中段制程包括对成品晶圆进行切割,这一过程对良率和生产效率十分重要,因此加工过程中必须小心谨慎。
尽管美国和日本加强了半导体设备对中国出口管制,但 DISCO 在中国市场的收入暂时未受到影响。截至 2022 年 3 月,该公司约 31% 的收入来自中国,2023 年 7~9 月增加至 34%。
此外,近日据日本芯片制造设备供应商 Disco 公司的一位高管透露,该公司希望在印度建立一个中心,为客户提供支持,并作为面向印度新兴半导体产业的营销基地。




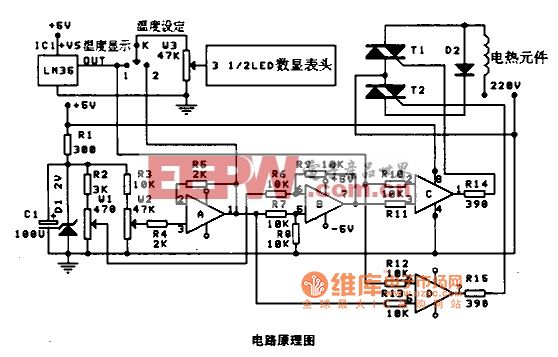






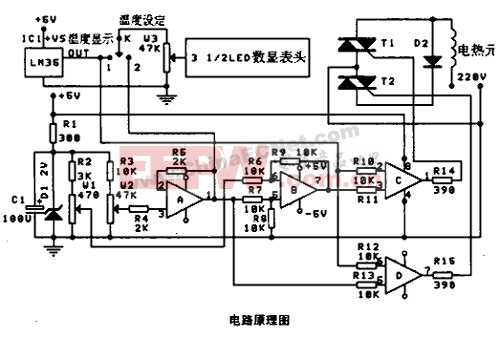

评论