揭秘先进封装技术:引领半导体行业革新的幕后英雄!
半导体行业正站在技术创新的风口浪尖,彻底改变了人工智能(AI)、5G通信和高性能计算(HPC)等各种应用。随着生成式人工智能时代的到来,对更强大、更紧凑、更高效的电子设备的需求不断增长。在这一追求中,先进封装已成为关键的推动者,尤其在摩尔定律时代的终结之际,它至关重要。

重新定义半导体技术
先进封装(AP)指的是一系列创新技术,用于封装集成电路(IC),以提高性能。这些技术主要分为两大类:一种是基于XY平面延伸的先进封装技术,主要通过RDL(封装线路)进行信号的延伸和互连;第二种则是基于Z轴延伸的先进封装技术,主要通过TSV(硅通孔)进行信号延伸和互连。前者代表2D先进封装,如FOWLP和FOPLP等,而后者则代表3D封装,如SoIC和Foveros等。目前,还有一种兼具两种封装特点的2.5D封装,如CoWoS和EMIB等。
半导体器件的封装形式经历了多次重大革新:
第一次:20世纪80年代,从引脚插入式封装过渡到表面贴片封装,极大地提高了印刷电路板上的组装密度。
第二次:20世纪90年代,随着球型矩阵封装的兴起,满足了市场对高引脚的需求,改善了半导体器件的性能。
现在,我们正处于第三次重大革新的时代,其中包括芯片级封装和系统封装等技术,旨在将封装面积减小到最小。
进入四个封装阶段:

裸片贴装: 代表的连接方式是引线键合。
倒片封装: 代表的连接方式是焊球或凸点。(如上图)
晶圆级封装: 代表的连接方式是RDL(重布线层)技术。
2.5D/3D封装: 代表的连接方式是TSV(硅通孔)技术和Chiplet封装技术。
先进封装的优势
先进封装 vs. 传统封装具有哪些优势?
先进封装的优势体现在提高加工效率、降低设计成本,以及实现更高密度的集成。这些技术不仅缩短了生产周期,还减小了对面积的浪费,从而提高了性能和效率。它们标志着半导体封装的新时代,为未来的技术革新提供了新的动力。在半导体行业的演进中,先进封装已成为关键的推动者,有望塑造未来更强大、更紧凑、更高效的电子设备。
先进封装,代表着一系列创新技术,这些技术重塑了半导体封装的面貌。最近几年,先进封装技术呈现爆炸性增长,每个相关技术公司都在注册商标,如台积电的InFO、CoWoS,日月光的FoCoS,Amkor的SLIM、SWIFT等。尽管这些技术之间可能只有微小的差异,但它们满足了客制化产品的需求,使半导体封装领域充满多样性。
新产品
在半导体行业的不断演进中,先进封装技术已成为关键的推动者,不仅改善了电子设备性能,还减少了生产成本。在这个领域,让我们引入艾斯达克团队改造升级的新产品——i-Stock semi magazine stocker,这是一款具有前瞻性的解决方案,专门为存放die芯片与Lead Frame引线框架而设计。

产品参数

产品优势

在半导体行业的竞争日益激烈的背景下,
i-Stock semi magazine stocker的推出,将为半导体制造商提供更多竞争力,有助于实现更高效、更创新的半导体封装过程。这款产品代表了半导体行业在技术和生产方面的巨大飞跃,预示着一个更加充满活力和机遇的未来!













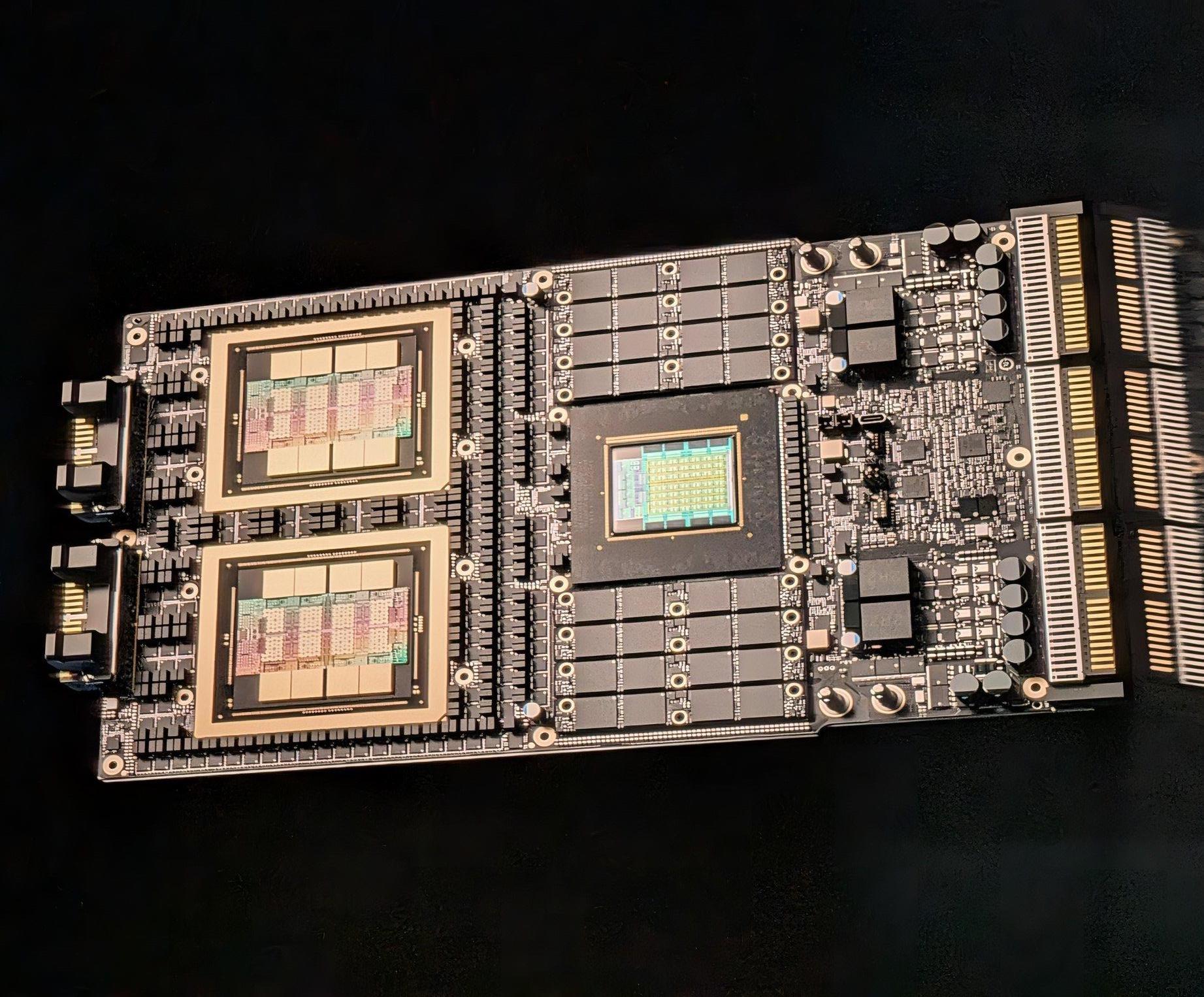




评论