如何使用氮化镓:增强型氮化镓晶体管的电学特性
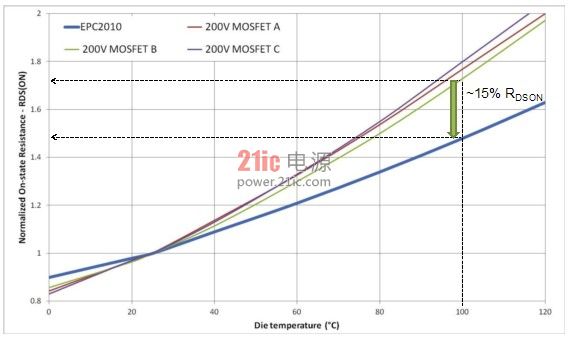
图2:EPC2010 器件与额定电压为200V的硅MOSFET相比,归一化RDS(ON))电阻值与温度的关系的比较。
反向二极体
与功率MOSFET器件相同,增强型氮化镓晶体管可在反方向导通。不过后者的物理机理不同。一个硅功率MOSFET的p-n二极体与场效应晶体管融合,通过把少数载流子注入漏极区域而得以导通。这个电荷被储存于漏极区域(QRR)达数十纳秒(tRR)后将在二极体关闭时变为热损耗。如果要求快速开关, 这是一个重大缺点。当栅极与漏极之间的电极具正向电压,增强型氮化镓场效应晶体管的电子通道会因开启而出现反向传导。当除去电压,没有储存电荷损耗(tRR=0, QRR=0)时,通道会立即关闭。坏处是器件在源极与漏极之间的压降会比一个等效功率MOSFET器件为大(见图3)。要把这个比较更高的压降VSD降至最低,以及要发挥氮化镓场效应晶体管的最优性能,必需保持最短促死区时间,以避免交叉传导。
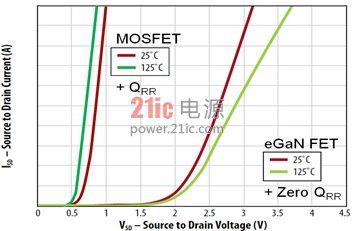
图3: eGaN FET与功率MOSFET器件的体二极管正向压降, 与源极至漏极电流和温度的关系的比较。
极大优势:非常低电容及电荷
一个场效应晶体管的电容是决定器件从开启至关闭或者从关闭至开启的状态下,在电源转换过程中能量损失的最大因素。在施加电压范围内积分两个端子之间的电容,可以取得电荷值(Q),这是给电容充电
所消耗的电量。
由于电流乘以时间等于电荷,因此查看改变氮化镓场效应晶体管各个端子间的电压所需的电荷量, 很多时候会比较方便。图4显示了栅极电荷量(QG)来提供栅极至源极的电压,以达至所需的电压值。从这个图表可以看出,具100 V、5.6 m典型值的eGaN FET与具80 V、4.7 m 典型值的功率MOSFET的比较。只需1/4电荷可以把eGaN FET增强。这可以演绎为更快速开关及更低开关功耗。

图4: EPC2001 器件与英飞凌公司BSC057N08NS器件的栅极电荷与栅极电压的关系的比较。








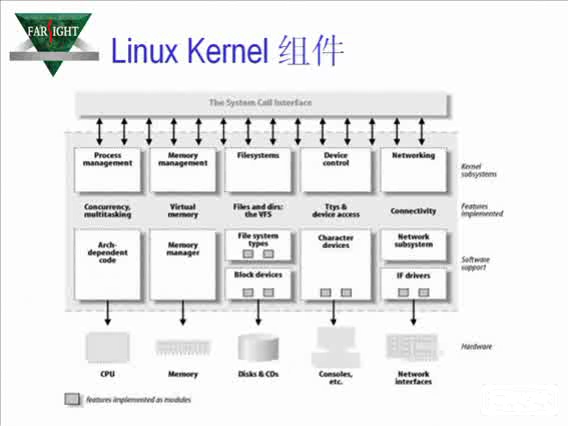




评论