技术 | SiC衬底和外延材料对MOSFET器件特性的影响
参考文献:白志强,4H-SiC功率MOSFETs的可靠性研究【D】,西安电子科技大学,2023
三角形缺陷
三角形缺陷是SiC外延层中最为致命的一类形貌缺陷,已有大量的文献报道表明三角形缺陷的形成与3C晶型有关。然而由于生长机制的不同,许多三角形缺陷在外延层表面的形貌存在不小差异。大致可以分为以下几种类型:
(1)顶端存在大颗粒的三角形缺陷
该类三角形缺陷在顶端存在一个大尺寸的球形颗粒,这可能是由于生长过程中的跌落物所造成的。沿着该顶点向下的方向可以观察到一个表面粗糙的小三角形区域。这是由于在外延过程中,在三角形区域内先后形成了两个不同的3C-SiC层,其中第一层在界面处成核并通过4H-SiC台阶流生长。随着外延层厚度的增长,第二层3C多型在较小的三角形凹坑中成核和生长,但4H生长台阶并未完全覆盖3C多型区域,使得3C-SiC的V形凹槽区域依然清晰可见

(2)顶端存在小颗粒,表面粗糙的三角形缺陷
该类三角形缺陷其顶点处的颗粒要小得多,如图4.2所示。并且大部分三角形区域都被4H-SiC的台阶流所覆盖,即整个3C-SiC层完全嵌入在4H-SiC层之下。三角形缺陷表面只能看到4H-SiC的生长台阶,但这些台阶比常规的4H晶型生长台阶大得多。
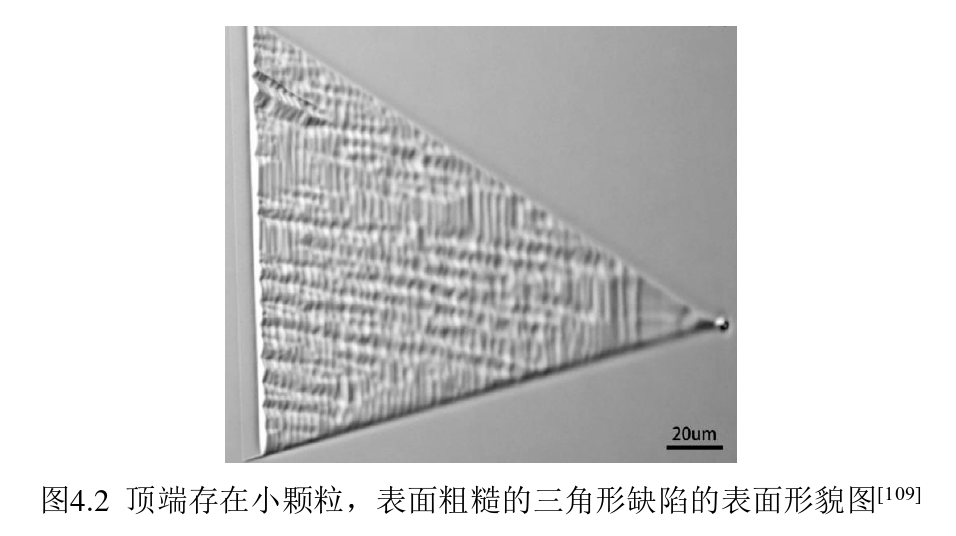
(3)表面光滑的三角形缺陷
该类三角形缺陷具有光滑的表面形态,如图4.3所示。对于此类三角形缺陷,3C-SiC层都被4H-SiC的台阶流所覆盖,并且表面的4H晶型生长得加精细,平滑。

外延坑缺陷
外延坑(Pits)作为最常见的表面形貌缺陷之一,其典型的表面形貌和结构轮廓如图4.4所示。通过对器件背面进行KOH腐蚀后观察到的螺纹位错(Threading Dislocation, TD )腐蚀坑的位置与器件制备前外延坑的位置有明显对应关系,表明外延坑缺陷的形成与螺纹位错有关。
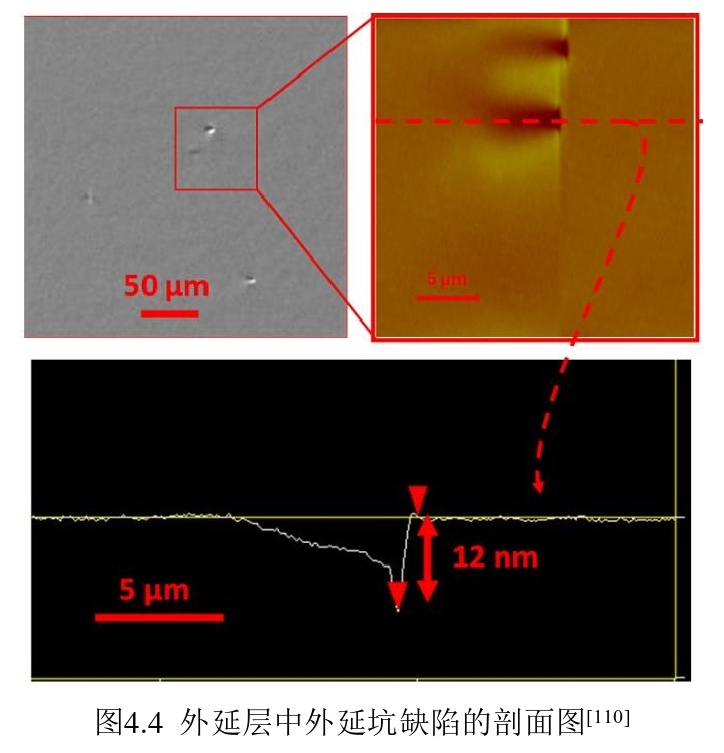
胡萝卜缺陷
胡萝卜缺陷是4H-SiC外延层中一类常见的表面缺陷,其典型的形貌图如图4.5所示。据报道胡萝卜缺陷是由阶梯状位错连接的位于基面上的弗兰科层错和棱柱层错相交形成的。也有报道称胡萝卜缺陷的形成与衬底中的TSD有关。Tsuchida H.等人发现外延层中胡萝卜缺陷的密度与衬底中TSD的密度成正比。并且通过比较外延生长前后的表面形貌图像,所有观察到的胡萝卜缺陷都可以与衬底中的TSD找到对应关系。 Wu H.等人利用拉曼散射测试表征发现胡萝卜缺陷中不含有3C晶型,只有4H-SiC多型体。

三角形缺陷对MOSFET器件特性的影响
图4.7为含有三角形缺陷的器件的五种特性统计分布直方图,其中蓝色虚线为器件特性退化的分割线,红色虚线为器件失效的分割线。对于器件失效而言,三角形缺陷的影响极大,失效比例大于93%。这主要归因于三角形缺陷对器件反向漏电特性的影响,含三角形缺陷的器件中高达93%的器件都出现了反向漏电明显增大的现象。此外,三角形缺陷对栅漏电特性的影响也十分严重,退化比例为60%。如表4.2所示,对于阂值电压退化和体二极管特性退化,三角形缺陷的影响较小,退化比例分别为26%和33%。对引起导通电阻增大而言,三角形缺陷的影响较弱,退化比例约为33%。


外延坑缺陷对MOSFET器件特性的影响
图4.8为含有外延坑缺陷的器件的五种特性统计分布直方图,其中蓝色虚线为器件特性退化的分割线,红色虚线为器件失效的分割线。从中可知,SiC MOSFET样品中含外延坑缺陷的器件数量与含三角形缺陷的数量相当。外延坑缺陷对器件特性的影响情况与三角形缺陷的有所不同。就器件失效而言,含有外延坑缺陷的器件失效率仅为47%。与三角形缺陷相比,外延坑缺陷对器件反向漏电特性和栅漏电特性的影响明显减弱,退化比例分别为53%和38%,如表4.3所示。另一方面,外延坑缺陷对阂值电压特性,体二极管导通特性和导通电阻的影响比三角形缺陷的大,退化比例均达到了38%。
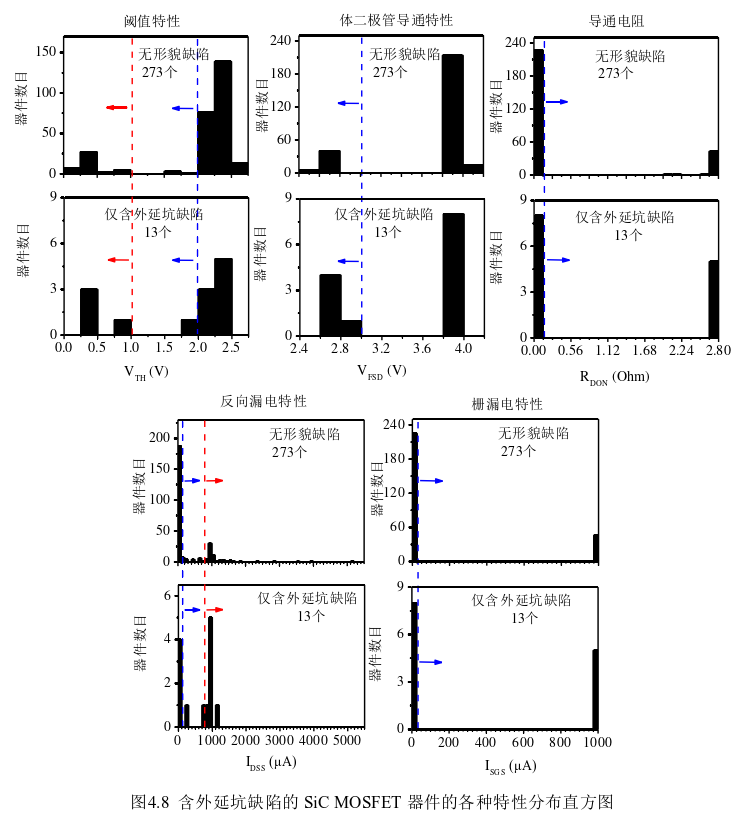

总体而言,三角形和外延坑这两种形貌缺陷对SiC MOSFET器件的失效及特性退化均具有明显影响。三角形缺陷的存在最为致命,失效率高达93%,主要表现为器件反向漏电的显著增加。含有外延坑缺陷的器件失效率较低,为47%。但是外延坑缺陷对器件的阈值电压,体二极管导通特性和导通电阻的影响比三角形缺陷的大。
来源:第三代半导体产业技术战略联盟
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。













