大功率照明级LED的封装技术
从实际应用的角度来看,安装使用简单、体积相对较小的大功率LED器件在大部分的照明应用中必将取代传统的小功率LED器件。由小功率LED组成的照明灯具为了满足照明的需要,必须集中许多个LED的光能才能达到设计要求,但带来的缺点是线路异常复杂、散热不畅,为了平衡各个LED之间的电流、电压关系,必须设计复杂的供电电路。相比之下,大功率单体LED的功率远大于若干个小功率LED的功率总和,供电线路相对简单,散热结构完善,物理特性稳定。所以说,大功率LED器件的封装方法和封装材料并不能简单地套用传统的小功率LED器件的封装方法与封装材料。大的耗散功率、大的发热量以及高的出光效率,给 LED封装工艺、封装设备和封装材料提出了新的更高的要求。
1、 大功率LED芯片
要想得到大功率LED器件,就必须制备合适的大功率LED芯片。国际上通常的制造大功率LED芯片的方法有如下几种:
① 加大尺寸法。通过增大单体LED的有效发光面积和尺寸,促使流经TCL层的电流均匀分布,以达到预期的光通量。但是,简单地增大发光面积无法解决散热问题和出光问题,并不能达到预期的光通量和实际应用效果。
② 硅底板倒装法。首先制备出适合共晶焊接的大尺寸LED芯片,同时制备出相应尺寸的硅底板,并在硅底板上制作出供共晶焊接用的金导电层及引出导电层(超声金丝球焊点),再利用共晶焊接设备将大尺寸LED芯片与硅底板焊接在一起。这样的结构较为合理,既考虑了出光问题又考虑到了散热问题,这是目前主流的大功率 LED的生产方式。
美国Lumileds公司于2001年研制出了AlGaInN功率型倒装芯片(FCLED)结构,其制造流程是:首先在外延片顶部的P型GaN上淀积厚度大于500A的NiAu层,用于欧姆接触和背反射;再采用掩模选择刻蚀掉P型层和多量子阱有源层,露出N型层;经淀积、刻蚀形成N型欧姆接触层,芯片尺寸为1mm










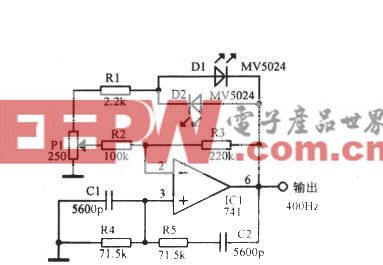



评论