应用材料公司推出亮场硅片检测工具UVision3系统
——
近日,应用材料公司推出具有业界最高生产力的DUV(深紫外)亮场硅片检测工具UVision® 3系统,它能满足45纳米前端制程和浸没式光刻对于关键缺陷检测灵敏度的要求。这个新一代的系统为应用材料公司突破性的UVision技术带来了重要的进步,它将扫描硅片的激光束数量提升至3倍,使其生产速度比任何竞争对手的系统快40%。两个新的成像模式将灵敏度扩展至20纳米,全新灵活的自动缺陷分类引擎能够迅速标定出有害缺陷从而达到更快的成品率学习进程。
应用材料公司副总裁,工艺诊断控制事业部总经理Gilad Almogy博士表示:“UVision 3系统的多光束DUV(深紫外)激光结构能够突破传统光学检测的精度限制。领先的存储器和浸没式光刻制造商可以使用这个增强的系统以工程灵敏度进行量产,在更短的周期内得到有意义的数据。多套UVision 3系统已经运送给一些领先的客户,该系统出众的的灵敏度和突破性的DUV(深紫外)亮场检测生产速度已经得到了验证。”
在结合独特的激光DUV(深紫外)结构,灵敏的光电倍增器(PMT)和可变偏振的情况下,UVision 3系统也能够应对32纳米存储器发展的挑战。在照射和收集光路下新的亮场成像模式满足了浸没式光刻对于多种对比度的要求。此外,该系统创新的高准确度缺陷检测算法和(stitch-to-stitch)逐祯检测提高了周边逻辑区域的灵敏度,这是任何其他亮场系统都不具备的关键优势。




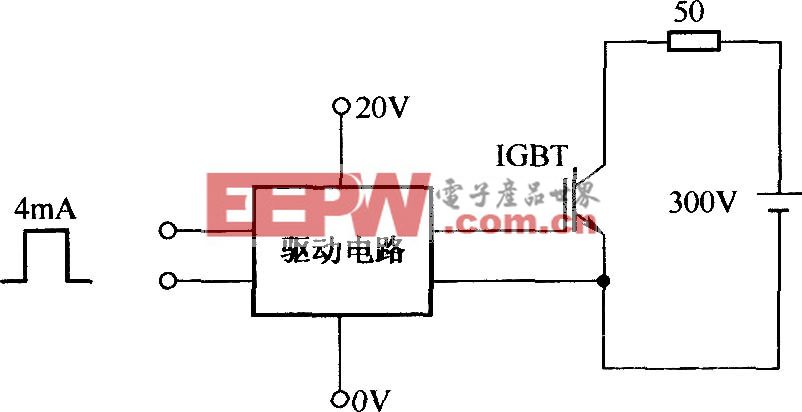


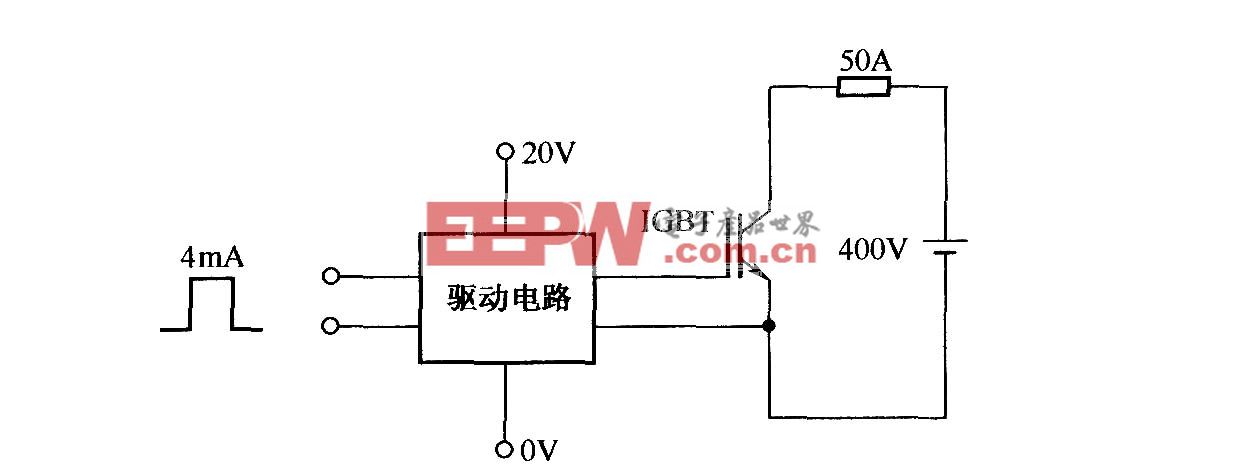



评论