非侵入式光学探测技术加快硅片调试
在尖端设计中,先进的工艺技术采用了无法完全用仿真模型描述的复杂时序问题模式,从而促使半导体厂商越来越依赖事后的硅设计验证方法和物理调试方法。在处理多个金属层互连工艺和先进的封装技术时,早期的物理调试方法遇到的挑战越来越多。然而,利用新的光学探测技术,设计工程师们可以高效率地查找时序错误,甚至尖端集成电路中的制造缺陷。先进的硅片调试系统集成了EDA工具,可以迅速向设备设计人员反馈缩短设计周期和加快批量生产所需的扫描、调试及特征描述结果。
随着高密度工艺技术的运用,半导体厂商们发现,仅用现行的设计仿真方法已不足以确保硅片的早期成功。短信道效应、电容耦合、电迁移以及其他电学现象和物理现象,引发了传统的线性仿真模型捕捉不到的效应。硅绝缘体(SOI)、低k电介质、铜和应变硅等新材料的引进,是令这个问题恶化的另一个因素。结果,工程师们面对的是仿真得到的预期时序性能和硅片里的实际结果之间差异越来越大。制造厂商发现,能通过时序验证签发的设计,在硅片中却不行。其结果是被迫延长的设计周期和损失惨重的重复制造,致使设计成本和掩膜成本在普通IC开发项目的非经常性开支中成为主要部分。
与此同时,对延期进入市场的惩罚却越来越严厉。前不久,制造商们还确信,由于延期推出新产品而损失的收入基本上可以在持续多年的整个产品生命周期中收回。可是最近,新产品只需数月就可以实现有效的市场渗透,这就需要尽早取得硅片成功和迅速进入市场,才能保证市场份额和实际利润。在这种环境中,工程师们需要具备在节点级迅速跟踪信号的能力,发现实测结果与预期性能之间的巨大时序差异。
传统的错误隔离技术
随着设计复杂性的提高,要获得电路性能的节点级可视性所面临的难题也急剧增加。在传统的错误隔离法(见图1)中,工程师们运用一个使用测试系统的电路,比较仿真结果后再按需要重新设计该电路。原则上说,只需使用一系列更加专业化的测试程序,就可以提高用这种方法解决问题的可能,可以用它来查找错误的具体位置。然而,在实际中,可能永远找不到某个错误的明确位置。
从引脚得到的错误隔离信息,其使用从根本上要受一台设备的可用输入 / 输出引脚的数量限制,而这个数量本身是有限的。因此,调试尖端设备的传统技术已经达到它们的极限—对于高度集成的设计,比如SoC集成电路,尤其如此。当前的设计已在每个引脚上用了约11000个晶体管,到2006年,这个比率还会翻倍—从而大大降低仿真和监视单个电路节点活动的能力。
使用扫描结构或内置自测试(BIST)结构,已经成为许多设计单位的标准设计原则。这两种方法虽然能提高SoC设计中嵌入式芯核的可观察性和可控制性,但它们的设计用途并不是节点级调试辅助工具,而是在生产测试过程中帮助迅速做出可以继续 / 不继续决定(go/no-go determination)的技术。尽管可以通过分析扫描结果来帮助确定错误的位置,但实际的扫描仪不是为了提供详尽的节点级可视性而设计的,因而不能满足进行时序错误分析的要求。结果,工程师们发现,扫描只能显示错误所在的区域,但不能提供最终确定有错误的具体电路元件所需的详细信息。如果无法确定错误的具体位置,下一次,工程师们遇到错误的危险性更大。
用于错误诊断与调试的节点级探测技术
长期以来,节点级电路探测技术一直是工程设计的支柱,在错误诊断与调试中发挥过重要作用。同基于检测器的传统方法一样,节点级探测技术也从衰减中的测试图形开始。不过,借助这种探测技术,工程师们可以达到单个节点级(见图2),可以利用网表和CAD数据来确定需探测的部位。然后,使用一种二进制检索法或其他检索程序来跟踪延迟传播,并测量选定网络中的待研究节点的关键时序信号。
机械探测法使用这种方法有很多年了。传统的机械探测法测试的是电路,可如今的电路设计已经发展到了0.25mm以下的几何结构,并且用4层以上的金属层进行处理,因此,传统的探测法已经不实用了。电子束法为电路诊断提供了一种手段,但是,由于多层金属造成的进入困难和使用这种技术需要做大量准备工作,每一次测量都要经过很长的周期时间。为了在复杂的电路中创建电子束接入点(access point),工程师们需要在测试点中进行设计,或者在真空下用聚焦离子束(FIB)系统—这个系统本身就是一件昂贵的仪器—在模具中钻孔。工程设计小组通常需要长达一周的时间—用FIB在模具中钻一个接入点,用电子束或探针完成一次测量—才能确定一个探测点。
在这么长的周期时间里,各种新技术已将这种方法淘汰了。晶体管部件的尺寸越来越小,而电子束本身的光点直径却比较大,这样电子束法的实用性就降低了。此外,金属层的增加实际上是为进入纵深试探点制造了一道屏障。除金属层增多外,高密度倒装芯片封装的出现,也使得从前方进入活动区几乎不可能。
光学探测技术
光学探测技术,包括激光电压探测(LVP)和TRE的出现,为从后方分析高金属层,倒装芯片封装集成电路提供了希望。LVP虽然对振动非常敏感,但它不需要真空环境,而且提供直径较小的光束,使工程师们能探测更精细的几何结构。使用这种方法时,工程师们把激光打到模具上的某个特定点上,以此来监视开关期间发生的电压调制。
日益先进的工艺技术使LVP法的效用越来越低。由于芯片上的电压随着工艺技术的进步而降低,用这种方法测量电压也变得越来越难了。在90nm工艺下,晶体管特征尺寸很小以致LVP光束会淹没开关过程中可能检测到的少量能量。即使是较大的几何结构,激光本身的密度也可能引起电效应,甚至可能损坏电路。另外,由于这种测量是以电压调制为基础的,LVP法对设备的电性质不稳定的硅绝缘体(SOI)设备不起作用。
皮秒成像电路分析(PICA)技术引入了测量基于TRE技术的信号时序和位置的能力。不过,PICA使用的检测技术的量子效率仍然非常低,因此需要数小时的收集时间,它要求测量循环远远低于10ms,这难以解决最常见的调试问题。硅衬底会过滤掉PICA工作范围内的某些波长,从而降低了它在倒装芯片应用中的效用。
光子辐射测量
使用TRE技术的非侵入式光学检测方法,利用与开关事件相关的光子辐射,以此提供完全无源的非侵入式解决方案。探测技术的新进展,使测量时间比以前的各类方法都缩短了很多。在一个开关事件期间,夹断区的电场会加快电荷载流子的运行速度,可以用一台近红外探测器(见图3)通过硅检测到辐射光子。
在实际中,这种方法在几分钟之内就可以收集到时间精度小于10皮秒的数据(见图4)。这种测量与抖动的相关性极高,但最新的技术可以部署非常低的抖动系统,可以测量的带宽超过6GHz。
测量装置
TRE法依赖于一种常见的测试装置,使用的是生产测试期间使用的定位装置和加载硬件。通常情况下,待测设备(DUT)直接与测试系统的测试头对接,与一个电气装置(与生产测试中使用的电气装置相似)一道快速运行(见图5)。用一个机械级(mechanical stage)为红外线显微镜平台提供导航和定位。该平台既为导航提供可视成像,也为捕捉信号提供光子探测。
为了激励DUT,用一个工程技术验证测试系统来支持这个极具交互性的调试过程。该系统通过一条50W的同轴电缆为时序测量提供一个高速基准触发信号。加上灵活的配制能力,该工程技术验证测试系统可提供迅速有效地检修工程技术实验室里的复杂调试问题所必需的系列工具。
在调试过程中,调试小组—通常包括故障分析专家和设备设计人员—用实时成像技术和来自CAD数据库的层叠布局尺寸数据(overlaid layout geometry data)来引导到研究中的特定节点(见图6)。在工程测试系统用适当的图形集来激励DUT的时候,设计小组就以非侵入方式测量特定节点上的时序信号。
先进的系统与EDA工具集成后,提高了设计人员识别和隔离错误的能力。在现有的工作站环境中,设计人员可以使用来自有错误的硅片的测试数据来激励EDA环境里的错误仿真。以错误仿真结果为基础,设计人员可以查明需探测的可疑节点,并收集来自错误硅片的信号波形。
得到仿真结果后,设计人员再把实测结果与仿真期间获得的预期时序数据进行比较。如果必需,设计小组还可以追踪意料之外的结果,进而到不同节点去跟踪信号。如果这样的话,在获取这类交互性数据的过程中,设计工程师通常会同时进行特别仿真测试,目的是澄清数据解释或者设计一组新的待探测节点。
错误隔离
通过探测内部节点,工程师们可以更容易地隔离信号网里的错误,包括芯片级测试结构和扫描链。由于芯片级测试结构通常充当引出数据的导管,如果采用传统方法来调试测试结构的缺陷,可能会特别困难。举例来说,如果某个扫描链中存在竞态条件,使用引出信息的工程师们可能无法区分扫描链里的错误和原信号网里的错误。但是,有了光子辐射法,工程师们就可以利用电路网表实时跟踪从节点到节点的信号(见图7)。通过监视时钟和扫描链上的信号时序,最后工程师们可以识别并隔离扫描链里的竞态条件。在本例中,C1_CLK滞后了,跃迁速度太慢,结果把错误数据载进了该扫描链里—本例中的这个问题很容易解决,加快C1_CLK的低速跃迁就是了。
虽然这种方法原本是为查找时序错误而设计的,但它也能帮助识别连通性问题。在这里,除检查光子辐射的时机性外,工程师们还会观察通过跃迁时以及在开关前和开关后处于稳定状态时测得的波形本身的形态。在门电路A、B和C之间有正常连接的抽样电路(见图8a)中,光子辐射结果显示对应于门电路A、B和C的正常波形(见图8b)。不过,在这种情况下,在门电路D测得的结果是因不稳定的噪音背景发射而失真的波形。某个门电路的输出不足,会引起非常微弱的发射,但某个门电路的输入不足,会呈现在门电路D测得的那种波形。在本例中,实际上是门电路C和门电路D之间的电阻故障造成了这样的实测结果。
物理调试趋势
现在的调试趋势是几何结构更精细,设备的速度更快,灵敏的时序错误模式仍会给致力于硅片错误隔离与识别的工程师们提出更大的挑战。由纳米效应引起的频率相关故障,会要求增强物理调试功能—既能提供更高的带宽诊断,又不损害时间分辨能力。同时,竞争日益激烈的市场也会促使人们使用速度更快,效果更好的调试技术,隔离错误的速度越快越好。
在新近涌现的各类技术中,非侵入性TRE技术能提供降低调试的复杂性所需要的那种简单、迅速和稳定的结果。加入工程技术测试系统后,光子辐射测量系统会提供一种最大限度地利用故障分析工程师和设计工程师的努力成果的快速交互环境。利用这种方法,工程设计小组可以执行各种更有效地把仿真结果与实测数据相结合的调试方法,还有助于获取硅片成功,缩短进入市场的时间,增加盈利的可能。■











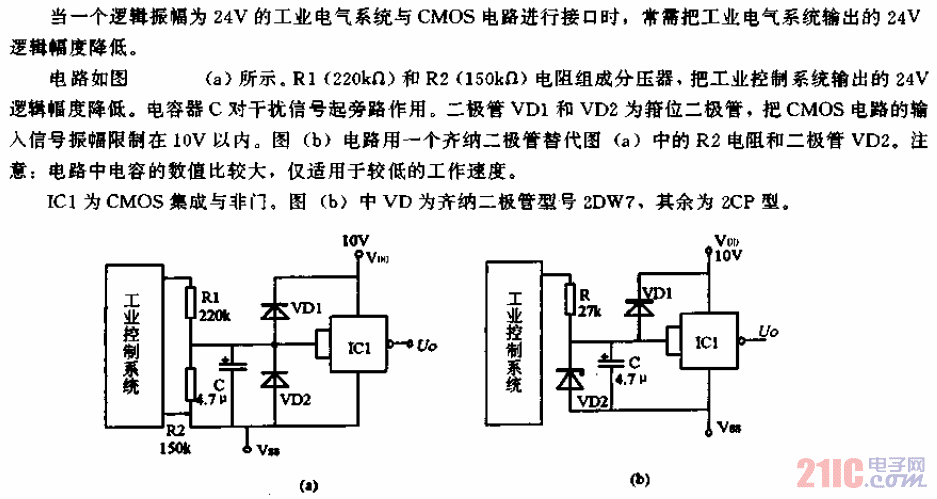

评论