大功率LED封装技术及发展趋势
大功率LED封装由于结构和工艺复杂,并直接影响到LED的使用性能和寿命,一直是近年来的研究热点,特别是大功率白光LED封装更是研究热点中的热点。LED封装的功能主要包括:1.机械保护,以提高可靠性;2.加强散热,以降低芯片结温,提高LED性能;3.光学控制,提高出光效率,优化光束分布;4.供电管理,包括交流/直流转变,以及电源控制等。
LED封装方法、材料、结构和工艺的选择主要由芯片结构、光电/机械特性、具体应用和成本等因素决定。经过40多年的发展,LED封装先后经历了支架式(LampLED)、贴片式(SMDLED)、功率型LED(PowerLED)等发展阶段。随着芯片功率的增大,特别是固态照明技术发展的需求,对LED封装的光学、热学、电学和机械结构等提出了新的、更高的要求。为了有效地降低封装热阻,提高出光效率,必须采用全新的技术思路来进行封装设计。
二、大功率LED封装关键技术
大功率LED封装主要涉及光、热、电、结构与工艺等方面,如图1所示。这些因素彼此既相互独立,又相互影响。其中,光是LED封装的目的,热是关键,电、结构与工艺是手段,而性能是封装水平的具体体现。从工艺兼容性及降低生产成本而言,LED封装设计应与芯片设计同时进行,即芯片设计时就应该考虑到封装结构和工艺。否则,等芯片制造完成后,可能由于封装的需要对芯片结构进行调整,从而延长了产品研发周期和工艺成本,有时甚至不可能。
3-5mm封装结构。一般用于电流较小(20-30mA),功率较低(小于0.1W)的LED封装。主要用于仪表显示或指示,大规模集成时也可作为显示屏。其缺点在于封装热阻较大(一般高于100K/W),寿命较短。
2、表面组装(贴片)式(SMT-LED)封装
表面组装技术(SMT)是一种可以直接将封装好的器件贴、焊到PCB表面指定位置上的一种封装技术。具体而言,就是用特定的工具或设备将芯片引脚对准预先涂覆了粘接剂和焊膏的焊盘图形上,然后直接贴装到未钻安装孔的PCB 表面上,经过波峰焊或再流焊后,使器件和电路之间建立可靠的机械和电气连接。SMT技术具有可靠性高、高频特性好、易于实现自动化等优点,是电子行业最流行的一种封装技术和工艺。
3、板上芯片直装式(COB)LED封装
COB是Chip On Board(板上芯片直装)的英文缩写,是一种通过粘胶剂或焊料将LED芯片直接粘贴到PCB板上,再通过引线键合实现芯片与PCB板间电互连的封装技术。PCB板可以是低成本的FR-4材料(玻璃纤维增强的环氧树脂),也可以是高热导的金属基或陶瓷基复合材料(如铝基板或覆铜陶瓷基板等)。而引线键合可采用高温下的热超声键合(金丝球焊)和常温下的超声波键合(铝劈刀焊接)。COB技术主要用于大功率多芯片阵列的LED封装,同SMT相比,不仅大大提高了封装功率密度,而且降低了封装热阻(一般为6-12W/m.K)。
4、系统封装式(SiP)LED封装
SiP(System inPackage)是近几年来为适应整机的便携式发展和系统小型化的要求,在系统芯片SystemonChip(SOC)基础上发展起来的一种新型封装集成方式。对SiP-LED而言,不仅可以在一个封装内组装多个发光芯片,还可以将各种不同类型的器件(如电源、控制电路、光学微结构、传感器等)集成在一起,构建成一个更为复杂的、完整的系统。同其他封装结构相比,SiP具有工艺兼容性好(可利用已有的电子封装材料和工艺),集成度高,成本低,可提供更多新功能,易于分块测试,开发周期短等优点。按照技术类型不同,SiP可分为四种:芯片层叠型,模组型,MCM型和三维(3D)封装型。
目前,高亮度LED器件要代替白炽灯以及高压汞灯,必须提高总的光通量,或者说可以利用的光通量。而光通量的增加可以通过提高集成度、加大电流密度、使用大尺寸芯片等措施来实现。而这些都会增加LED的功率密度,如散热不良,将导致LED芯片的结温升高,从而直接影响LED器件的性能(如发光效率降低、出射光发生红移,寿命降低等)。多芯片阵列封装是目前获得高光通量的一个最可行的方案,但是LED阵列封装的密度受限于价格、可用的空间、电气连接,特别是散热等问题。由于发光芯片的高密度集成,散热基板上的温度很高,必须采用有效的热沉结构和合适的封装工艺。常用的热沉结构分为被动和主动散热。被动散热一般选用具有高肋化系数的翅片,通过翅片和空气间的自然对流将热量耗散到环境中。该方案结构简单,可靠性高,但由于自然对流换热系数较低,只适合于功率密度较低,集成度不高的情况。对于大功率LED封装,则必须采用主动散热,如翅片+风扇、热管、液体强迫对流、微通道致冷、相变致冷等。
在系统集成方面,台湾新强光电公司采用系统封装技术(SiP), 并通过翅片+热管的方式搭配高效能散热模块,研制出了72W、80W的高亮度白光LED光源,如图5(a)。由于封装热阻较低(4.38℃/W),当环境温度为25℃时,LED结温控制在60℃以下,从而确保了LED的使用寿命和良好的发光性能。而华中科技大学则采用COB封装和微喷主动散热技术,封装出了220W和1500W的超大功率LED白光光源,如图5(b)。
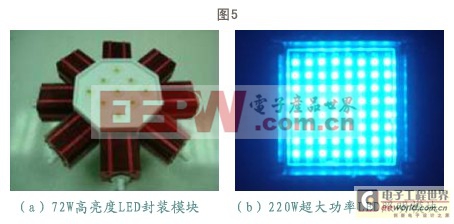
(四)封装大生产技术
晶片键合(Wafer bonding)技术是指芯片结构和电路的制作、封装都在晶片(Wafer)上进行,封装完成后再进行切割,形成单个的芯片(Chip);与之相对应的芯片键合(Die bonding)是指芯片结构和电路在晶片上完成后,即进行切割形成芯片(Die),然后对单个芯片进行封装(类似现在的LED封装工艺),如图6所示。很明显,晶片键合封装的效率和质量更高。由于封装费用在LED器件制造成本中占了很大比例,因此,改变现有的LED封装形式(从芯片键合到晶片键合),将大大降低封装制造成本。此外,晶片键合封装还可以提高LED器件生产的洁净度,防止键合前的划片、分片工艺对器件结构的破坏,提高封装成品率和可靠性,因而是一种降低封装成本的有效手段。
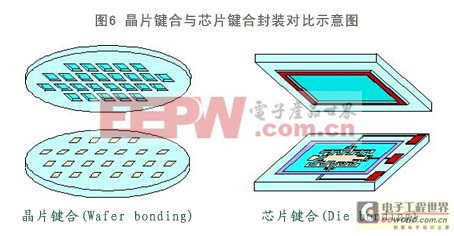
此外,对于大功率LED封装,必须在芯片设计和封装设计过程中,尽可能采用工艺较少的封装形式(Package-less Packaging),同时简化封装结构,尽可能减少热学和光学界面数,以降低封装热阻,提高出光效率。
(五)封装可靠性测试与评估
LED器件的失效模式主要包括电失效(如短路或断路)、光失效(如高温导致的灌封胶黄化、光学性能劣化等)和机械失效(如引线断裂,脱焊等),而这些因素都与封装结构和工艺有关。LED的使用寿命以平均失效时间(MTTF)来定义,对于照明用途,一般指LED的输出光通量衰减为初始的70%(对显示用途一般定义为初始值的50%)的使用时间。由于LED寿命长,通常采取加速环境试验的方法进行可靠性测试与评估。测试内容主要包括高温储存(100℃,1000h)、低温储存(-55℃,1000h)、高温高湿(85℃/85%,1000h)、高低温循环(85℃~-55℃)、热冲击、耐腐蚀性、抗溶性、机械冲击等。然而,加速环境试验只是问题的一个方面,对LED寿命的预测机理和方法的研究仍是有待研究的难题。
三、固态照明对大功率LED封装的要求
与传统照明灯具相比,LED灯具不需要使用滤光镜或滤光片来产生有色光,不仅效率高、光色纯,而且可以实现动态或渐变的色彩变化。在改变色温的同时保持具有高的显色指数,满足不同的应用需要。但对其封装也提出了新的要求,具体体现在:
(一)模块化
通过多个LED灯(或模块)的相互连接可实现良好的流明输出叠加,满足高亮度照明的要求。通过模块化技术,可以将多个点光源或LED模块按照随意形状进行组合,满足不同领域的照明要求。
(二)系统效率最大化
为提高LED灯具的出光效率,除了需要合适的LED电源外,还必须采用高效的散热结构和工艺,以及优化内/外光学设计,以提高整个系统效率。
(三)低成本
LED灯具要走向市场,必须在成本上具备竞争优势(主要指初期安装成本),而封装在整个LED灯具生产成本中占了很大部分,因此,采用新型封装结构和技术,提高光效/成本比,是实现LED灯具商品化的关键。
(四)易于替换和维护
由于LED光源寿命长,维护成本低,因此对LED灯具的封装可靠性提出了较高的要求。要求LED灯具设计易于改进以适应未来效率更高的LED芯片封装要求,并且要求LED芯片的互换性要好,以便于灯具厂商自己选择采用何种芯片。
LED灯具光源可由多个分布式点光源组成,由于芯片尺寸小,从而使封装出的灯具重量轻,结构精巧,并可满足各种形状和不同集成度的需求。唯一的不足在于没有现成的设计标准,但同时给设计提供了充分的想象空间。此外,LED照明控制的首要目标是供电。由于一般市电电源是高压交流电(220V,AC),而LED需要恒流或限流电源,因此必须使用转换电路或嵌入式控制电路(ASICs),以实现先进的校准和闭环反馈控制系统。此外,通过数字照明控制技术,对固态光源的使用和控制主要依靠智能控制和管理软件来实现,从而在用户、信息与光源间建立了新的关联,并且可以充分发挥设计者和消费者的想象力。
四、结束语
LED封装是一个涉及到多学科(如光学、热学、机械、电学、力学、材料、半导体等)的研究课题。从某种角度而言,LED封装不仅是一门制造技术(Technology),而且也是一门基础科学(Science),良好的封装需要对热学、光学、材料和工艺力学等物理本质的理解和应用。LED封装设计应与芯片设计同时进行,并且需要对光、热、电、结构等性能统一考虑。在封装过程中,虽然材料(散热基板、荧光粉、灌封胶)选择很重要,但封装结构(如热学界面、光学界面)对LED光效和可靠性影响也很大,大功率白光LED封装必须采用新材料,新工艺,新思路。对于LED灯具而言,更是需要将光源、散热、供电和灯具等集成考虑。
波峰焊相关文章:波峰焊原理




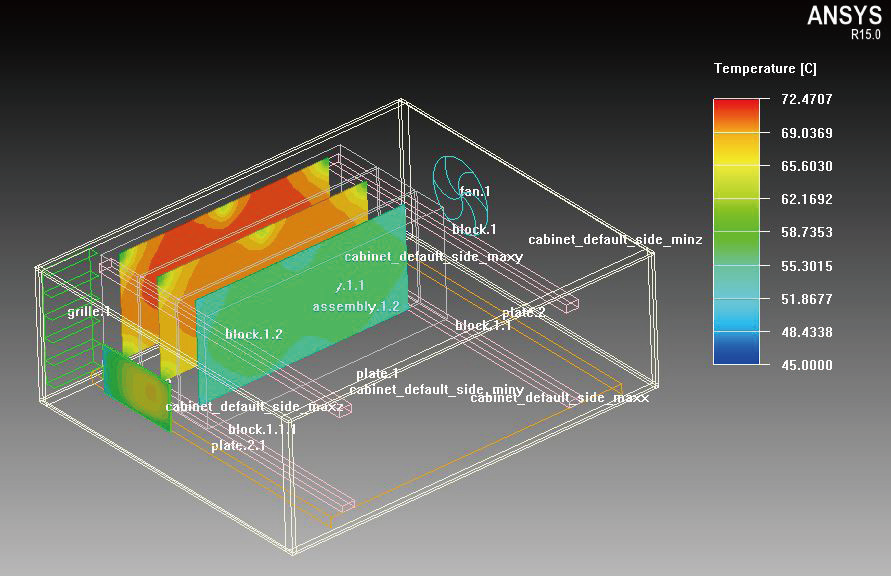





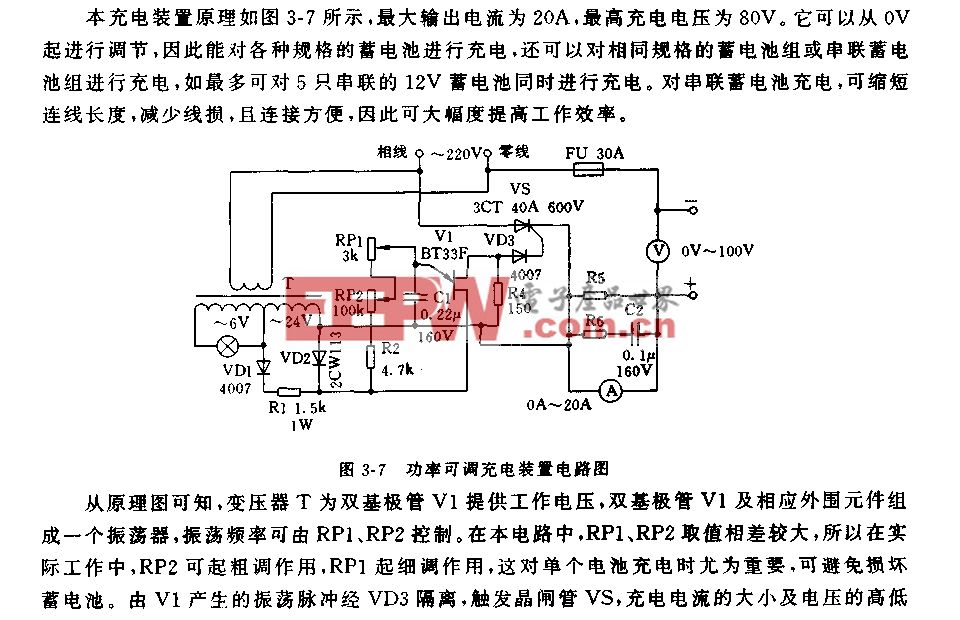
评论